Основний процесКарбід кремніюРіст кристалів поділяється на сублімацію та розкладання сировини за високої температури, транспортування речовин у газовій фазі під дією градієнта температури та рекристалізаційний ріст речовин у газовій фазі на зародковому кристалі. Виходячи з цього, внутрішня частина тигля поділена на три частини: зона сировини, камера росту та зародковий кристал. Чисельна модель була побудована на основі фактичного резистивного опору.Карбід кремніюобладнання для вирощування монокристалів (див. рисунок 1). У розрахунку: нижня частинатигельзнаходиться на відстані 90 мм від дна бічного нагрівача, верхня температура тигля становить 2100 ℃, діаметр частинок сировини становить 1000 мкм, пористість – 0,6, тиск росту – 300 Па, а час росту – 100 год. Товщина PG становить 5 мм, діаметр дорівнює внутрішньому діаметру тигля, і він розташований на 30 мм вище сировини. У розрахунку враховуються процеси сублімації, карбонізації та перекристалізації зони сировини, а реакція між PG та речовинами в газофазі не враховується. Параметри фізичних властивостей, пов'язані з розрахунком, наведено в таблиці 1.
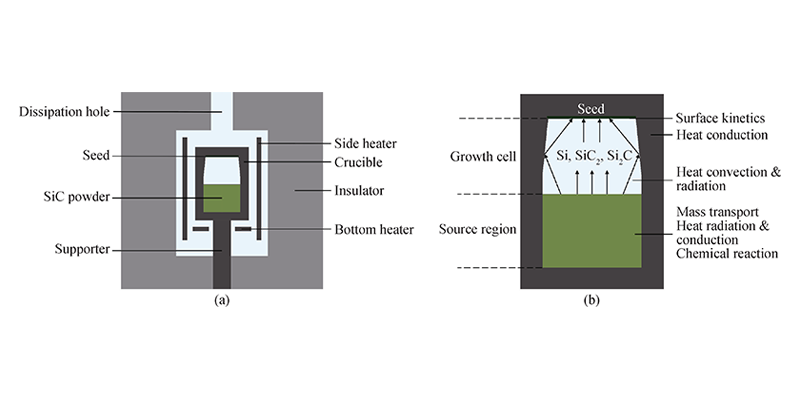
Рисунок 1. Модель симуляційного розрахунку. (a) Модель теплового поля для симуляції росту кристалів; (b) Поділ внутрішньої площі тигля та пов'язані з ним фізичні проблеми
Таблиця 1 Деякі фізичні параметри, що використовуються в розрахунку

На рисунку 2(a) видно, що температура структури, що містить PG (позначеної як структура 1), вища, ніж температура структури без PG (позначеної як структура 0) нижче PG, і нижча, ніж температура структури 0 вище PG. Загальний градієнт температури збільшується, і PG діє як теплоізоляційний агент. Згідно з рисунками 2(b) та 2(c), осьові та радіальні градієнти температури структури 1 у зоні сировини менші, розподіл температури більш рівномірний, а сублімація матеріалу більш повна. На відміну від зони сировини, на рисунку 2(c) видно, що радіальний градієнт температури у зародковому кристалі структури 1 більший, що може бути спричинено різними пропорціями різних режимів теплопередачі, що сприяє росту кристала з опуклою поверхнею розділу. На рисунку 2(d) температура в різних положеннях тигля демонструє тенденцію до зростання в міру зростання, але різниця температур між структурою 0 та структурою 1 поступово зменшується в зоні сировини та поступово збільшується в камері росту.
 Рисунок 2. Розподіл температури та зміни в тиглі. (a) Розподіл температури всередині тигля структури 0 (ліворуч) та структури 1 (праворуч) о 0 год, одиниця вимірювання: ℃; (b) Розподіл температури на центральній лінії тигля структури 0 та структури 1 від дна сировини до затравки о 0 год; (c) Розподіл температури від центру до краю тигля на поверхні затравки (A) та поверхні сировини (B), середній (C) та нижній (D) частині о 0 год, горизонтальна вісь r – це радіус затравки для A, а радіус площі сировини для B~D; (d) Зміни температури в центрі верхньої частини (A), поверхні сировини (B) та середній (C) частині камери росту структури 0 та структури 1 о 0, 30, 60 та 100 год.
Рисунок 2. Розподіл температури та зміни в тиглі. (a) Розподіл температури всередині тигля структури 0 (ліворуч) та структури 1 (праворуч) о 0 год, одиниця вимірювання: ℃; (b) Розподіл температури на центральній лінії тигля структури 0 та структури 1 від дна сировини до затравки о 0 год; (c) Розподіл температури від центру до краю тигля на поверхні затравки (A) та поверхні сировини (B), середній (C) та нижній (D) частині о 0 год, горизонтальна вісь r – це радіус затравки для A, а радіус площі сировини для B~D; (d) Зміни температури в центрі верхньої частини (A), поверхні сировини (B) та середній (C) частині камери росту структури 0 та структури 1 о 0, 30, 60 та 100 год.
На рисунку 3 показано транспортування матеріалу в різні моменти часу в тиглі структури 0 та структури 1. Швидкість потоку матеріалу в газовій фазі в зоні сировини та камері росту збільшується зі збільшенням положення, а транспортування матеріалу послаблюється в міру прогресування росту. На рисунку 3 також показано, що в умовах моделювання сировина спочатку графітизується на бічній стінці тигля, а потім на дні тигля. Крім того, відбувається перекристалізація на поверхні сировини, яка поступово потовщується в міру прогресування росту. Рисунки 4(a) та 4(b) показують, що швидкість потоку матеріалу всередині сировини зменшується в міру прогресування росту, і швидкість потоку матеріалу через 100 год становить приблизно 50% від початкового моменту; однак, швидкість потоку на краю відносно велика через графітизацію сировини, і швидкість потоку на краю більш ніж у 10 разів перевищує швидкість потоку в середній зоні через 100 год; Крім того, вплив PG у структурі 1 робить швидкість потоку матеріалу в зоні сировини структури 1 нижчою, ніж у структурі 0. На рисунку 4(c) потік матеріалу як у зоні сировини, так і в камері росту поступово послаблюється в міру прогресування росту, а потік матеріалу в зоні сировини продовжує зменшуватися, що спричинено відкриттям каналу повітряного потоку на краю тигля та перешкодою для рекристалізації зверху; у камері росту швидкість потоку матеріалу структури 0 швидко зменшується протягом перших 30 годин до 16% і зменшується лише на 3% у наступний час, тоді як структура 1 залишається відносно стабільною протягом усього процесу росту. Таким чином, PG допомагає стабілізувати швидкість потоку матеріалу в камері росту. На рисунку 4(d) порівнюється швидкість потоку матеріалу на фронті росту кристалів. У початковий момент та через 100 годин перенесення матеріалу в зоні росту структури 0 сильніше, ніж у структурі 1, але на краю структури 0 завжди є область з високою швидкістю потоку, що призводить до надмірного росту на краю. Присутність PG у структурі 1 ефективно пригнічує це явище.

Рисунок 3. Потік матеріалу в тиглі. Лінії струму (ліворуч) та вектори швидкості (праворуч) перенесення газоматеріалу в структурах 0 та 1 у різні моменти часу, одиниця вимірювання вектора швидкості: м/с
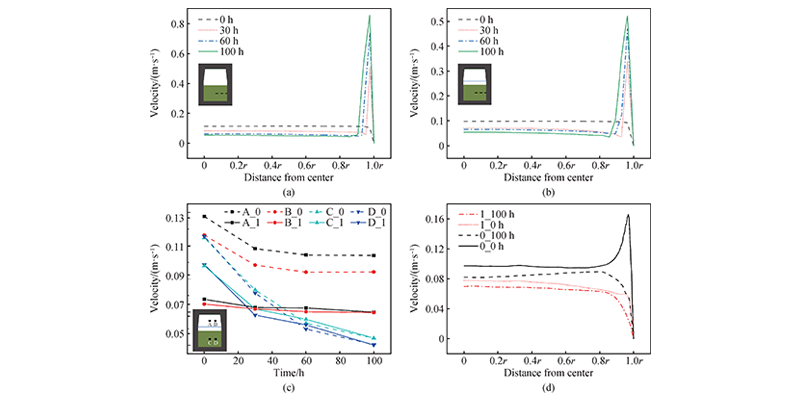
Рисунок 4. Зміни швидкості потоку матеріалу. (a) Зміни розподілу швидкості потоку матеріалу посередині сировини структури 0 о 0, 30, 60 та 100 год, r – радіус області сировини; (b) Зміни розподілу швидкості потоку матеріалу посередині сировини структури 1 о 0, 30, 60 та 100 год, r – радіус області сировини; (c) Зміни швидкості потоку матеріалу всередині камери росту (A, B) та всередині сировини (C, D) структур 0 та 1 з часом; (d) Розподіл швидкості потоку матеріалу поблизу поверхні зародкового кристала структур 0 та 1 о 0 та 100 год, r – радіус зародкового кристала
C/Si впливає на кристалічну стабільність та щільність дефектів росту кристалів SiC. На рисунку 5(a) порівнюється розподіл співвідношення C/Si двох структур у початковий момент. Співвідношення C/Si поступово зменшується від дна до верху тигля, і співвідношення C/Si структури 1 завжди вище, ніж у структури 0 у різних положеннях. На рисунках 5(b) та 5(c) показано, що співвідношення C/Si поступово збільшується зі зростанням, що пов'язано зі збільшенням внутрішньої температури на пізнішій стадії росту, посиленням графітизації сировини та реакцією компонентів Si в газовій фазі з графітовим тиглем. На рисунку 5(d) співвідношення C/Si структури 0 та структури 1 суттєво відрізняються нижче PG (0, 25 мм), але дещо відрізняються вище PG (50 мм), і різниця поступово збільшується по мірі наближення до кристала. Загалом, співвідношення C/Si структури 1 вище, що допомагає стабілізувати кристалічну форму та зменшити ймовірність фазового переходу.

Рисунок 5. Розподіл та зміни співвідношення C/Si. (a) Розподіл співвідношення C/Si у тиглях структури 0 (ліворуч) та структури 1 (праворуч) о 0 год; (b) Співвідношення C/Si на різних відстанях від центральної лінії тигля структури 0 у різний час (0, 30, 60, 100 год); (c) Співвідношення C/Si на різних відстанях від центральної лінії тигля структури 1 у різний час (0, 30, 60, 100 год); (d) Порівняння співвідношення C/Si на різних відстанях (0, 25, 50, 75, 100 мм) від центральної лінії тигля структури 0 (суцільна лінія) та структури 1 (пунктирна лінія) у різний час (0, 30, 60, 100 год).
На рисунку 6 показано зміни діаметра частинок та пористості областей сировини двох структур. З рисунка видно, що діаметр сировини зменшується, а пористість збільшується поблизу стінки тигля, при цьому пористість країв продовжує збільшуватися, а діаметр частинок продовжує зменшуватися в міру зростання. Максимальна пористість країв становить близько 0,99 через 100 годин, а мінімальний діаметр частинок – близько 300 мкм. Діаметр частинок збільшується, а пористість зменшується на верхній поверхні сировини, що відповідає рекристалізації. Товщина області рекристалізації збільшується в міру зростання, а розмір частинок та пористість продовжують змінюватися. Максимальний діаметр частинок досягає понад 1500 мкм, а мінімальна пористість – 0,13. Крім того, оскільки PG підвищує температуру області сировини, а пересичення газом невелике, товщина рекристалізації верхньої частини сировини структури 1 невелика, що покращує коефіцієнт використання сировини.
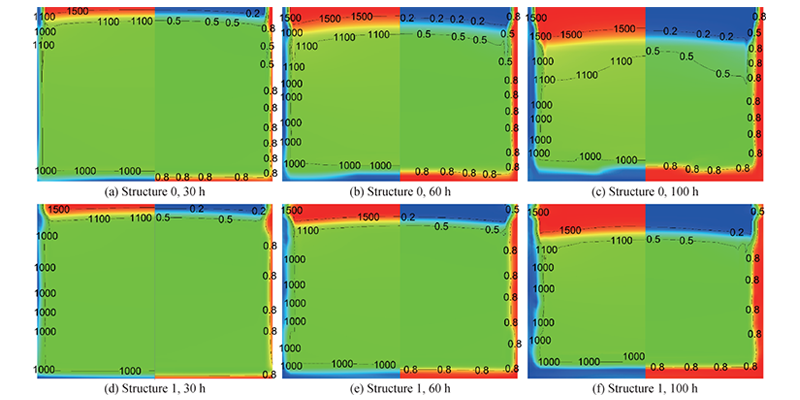 Рисунок 6. Зміни діаметра частинок (ліворуч) та пористості (праворуч) області сировини структури 0 та структури 1 у різні моменти часу, одиниця вимірювання діаметра частинок: мкм
Рисунок 6. Зміни діаметра частинок (ліворуч) та пористості (праворуч) області сировини структури 0 та структури 1 у різні моменти часу, одиниця вимірювання діаметра частинок: мкм
На рисунку 7 показано, що структура 0 деформується на початку росту, що може бути пов'язано з надмірною швидкістю потоку матеріалу, спричиненою графітизацією краю сировини. Ступінь деформації послаблюється під час подальшого процесу росту, що відповідає зміні швидкості потоку матеріалу на фронті росту кристалів структури 0 на рисунку 4 (d). У структурі 1, через вплив PG, кристалічний інтерфейс не демонструє деформації. Крім того, PG також робить швидкість росту структури 1 значно нижчою, ніж у структури 0. Центральна товщина кристала структури 1 після 100 годин становить лише 68% від товщини структури 0.
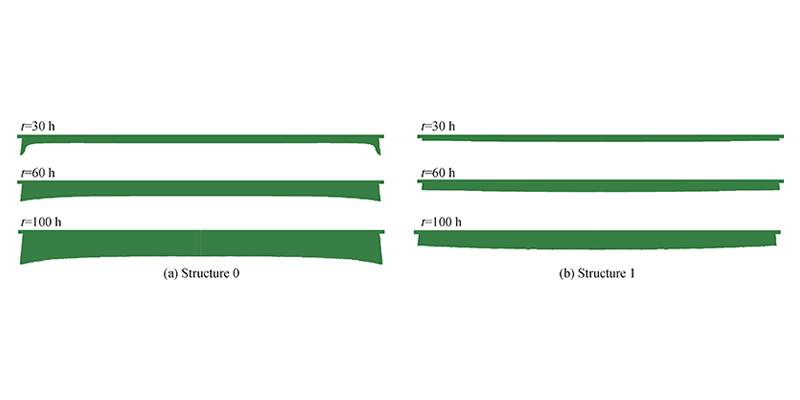
Рисунок 7. Зміни межі розділу кристалів структури 0 та структури 1 через 30, 60 та 100 годин
Вирощування кристалів проводилося в умовах числового моделювання. Кристали, вирощені за допомогою структури 0 та структури 1, показані на рисунку 8(a) та рисунку 8(b) відповідно. Кристал структури 0 має увігнуту поверхню розділу з хвилястою поверхнею в центральній області та фазовим переходом на краю. Опуклість поверхні свідчить про певний ступінь неоднорідності в транспортуванні газофазних матеріалів, а виникнення фазового переходу відповідає низькому співвідношенню C/Si. Поверхня розділу кристала, вирощеного за допомогою структури 1, злегка опукла, фазового переходу не виявлено, а товщина становить 65% від товщини кристала без PG. Загалом, результати вирощування кристалів відповідають результатам моделювання, з більшою радіальною різницею температур на кристалічній поверхні структури 1, швидке зростання на краю пригнічене, а загальна швидкість потоку матеріалу повільніша. Загальна тенденція узгоджується з результатами числового моделювання.
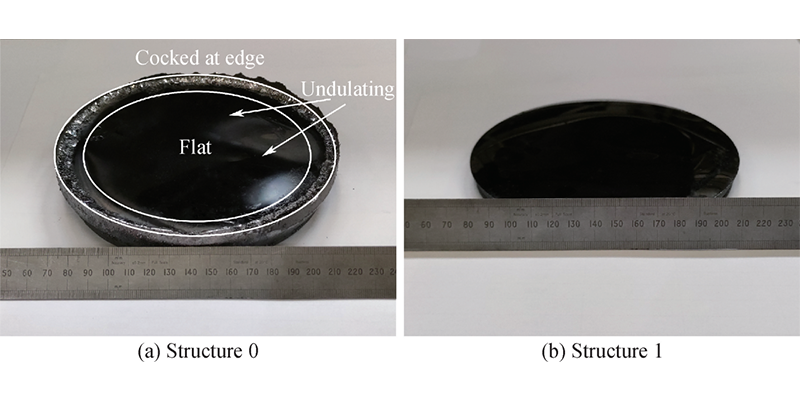
Рисунок 8. Кристали SiC, вирощені за структурою 0 та структурою 1
Висновок
PG сприяє підвищенню загальної температури зони сировини та покращенню осьової та радіальної рівномірності температури, що сприяє повній сублімації та використанню сировини; збільшується різниця температур зверху та знизу, а також збільшується радіальний градієнт поверхні зародкового кристала, що допомагає підтримувати ріст опуклої межі розділу. З точки зору масообміну, введення PG знижує загальну швидкість масообміну, швидкість потоку матеріалу в камері росту, що містить PG, менше змінюється з часом, і весь процес росту є більш стабільним. Водночас PG також ефективно запобігає виникненню надмірного крайового масообміну. Крім того, PG також збільшує співвідношення C/Si у середовищі росту, особливо на передньому краю межі розділу зародкового кристала, що допомагає зменшити виникнення фазових переходів під час процесу росту. Водночас теплоізоляційний ефект PG певною мірою зменшує виникнення рекристалізації у верхній частині сировини. Для росту кристалів PG уповільнює швидкість росту кристалів, але межа росту є більш опуклою. Таким чином, PG є ефективним засобом для покращення середовища росту кристалів SiC та оптимізації якості кристалів.
Час публікації: 18 червня 2024 р.
