Temel süreçSiCKristal büyümesi, yüksek sıcaklıkta ham maddelerin süblimleşmesi ve ayrışması, sıcaklık gradyanının etkisi altında gaz fazı maddelerinin taşınması ve tohum kristalinde gaz fazı maddelerinin yeniden kristalleşme büyümesi olarak ayrılır. Buna dayanarak, potanın iç kısmı üç bölüme ayrılır: ham madde alanı, büyüme odası ve tohum kristali. Gerçek dirençliliğe dayalı olarak sayısal bir simülasyon modeli çizildiSiCtek kristal büyüme ekipmanı (bkz. Şekil 1). Hesaplamada: tabanınpotaYan ısıtıcının tabanından 90 mm uzakta, potanın üst sıcaklığı 2100 ℃, hammadde parçacık çapı 1000 μm, gözeneklilik 0,6, büyüme basıncı 300 Pa ve büyüme süresi 100 saattir. PG kalınlığı 5 mm, çapı potanın iç çapına eşittir ve hammaddenin 30 mm üzerinde yer almaktadır. Hammadde bölgesinin süblimleşme, karbonizasyon ve yeniden kristalleşme süreçleri hesaplamada dikkate alınır ve PG ile gaz fazı maddeleri arasındaki reaksiyon dikkate alınmaz. Hesaplamayla ilgili fiziksel özellik parametreleri Tablo 1'de gösterilmiştir.
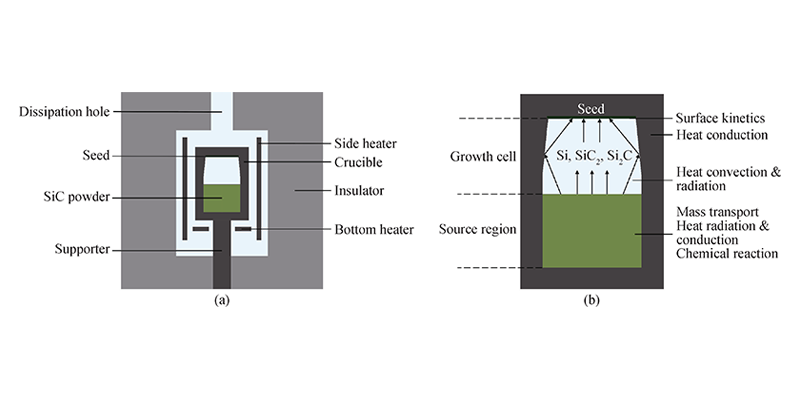
Şekil 1 Simülasyon hesaplama modeli. (a) Kristal büyüme simülasyonu için termal alan modeli; (b) Pota iç alanının bölünmesi ve ilgili fiziksel problemler
Tablo 1 Hesaplamada kullanılan bazı fiziksel parametreler

Şekil 2(a), PG içeren yapının (yapı 1 olarak gösterilir) sıcaklığının, PG'nin altındaki PG içermeyen yapının (yapı 0 olarak gösterilir) sıcaklığından daha yüksek ve PG'nin üstündeki yapı 0'ın sıcaklığından daha düşük olduğunu gösterir. Genel sıcaklık gradyanı artar ve PG bir ısı yalıtım maddesi olarak etki eder. Şekil 2(b) ve 2(c)'ye göre, ham madde bölgesindeki yapı 1'in eksenel ve radyal sıcaklık gradyanları daha küçüktür, sıcaklık dağılımı daha düzgündür ve malzemenin süblimleşmesi daha eksiksizdir. Ham madde bölgesinin aksine, Şekil 2(c), yapı 1'in tohum kristalindeki radyal sıcaklık gradyanının daha büyük olduğunu gösterir; bu, kristalin dışbükey bir arayüzle büyümesine yardımcı olan farklı ısı transfer modlarının farklı oranlarından kaynaklanıyor olabilir. Şekil 2(d)’de, pota içindeki farklı pozisyonlardaki sıcaklık, büyüme ilerledikçe artan bir eğilim göstermektedir, ancak yapı 0 ile yapı 1 arasındaki sıcaklık farkı, hammadde bölgesinde giderek azalmakta ve büyüme odasında giderek artmaktadır.
 Şekil 2 Sıcaklık dağılımı ve pota içindeki değişimler. (a) 0 saatte yapı 0 (sol) ve yapı 1'in (sağ) pota içindeki sıcaklık dağılımı, birim: ℃; (b) 0 saatte yapı 0 ve yapı 1'in pota merkez hattından ham maddenin tabanından tohum kristaline kadar sıcaklık dağılımı; (c) 0 saatte tohum kristal yüzeyi (A) ve ham madde yüzeyi (B), ortası (C) ve altı (D) üzerinde pota merkezinden kenarına doğru sıcaklık dağılımı, yatay eksen r A için tohum kristal yarıçapı ve B~D için ham madde alan yarıçapıdır; (d) 0, 30, 60 ve 100 saatte yapı 0 ve yapı 1'in büyüme odasının üst kısmının (A), ham madde yüzeyinin (B) ve ortasının (C) merkezindeki sıcaklık değişimleri.
Şekil 2 Sıcaklık dağılımı ve pota içindeki değişimler. (a) 0 saatte yapı 0 (sol) ve yapı 1'in (sağ) pota içindeki sıcaklık dağılımı, birim: ℃; (b) 0 saatte yapı 0 ve yapı 1'in pota merkez hattından ham maddenin tabanından tohum kristaline kadar sıcaklık dağılımı; (c) 0 saatte tohum kristal yüzeyi (A) ve ham madde yüzeyi (B), ortası (C) ve altı (D) üzerinde pota merkezinden kenarına doğru sıcaklık dağılımı, yatay eksen r A için tohum kristal yarıçapı ve B~D için ham madde alan yarıçapıdır; (d) 0, 30, 60 ve 100 saatte yapı 0 ve yapı 1'in büyüme odasının üst kısmının (A), ham madde yüzeyinin (B) ve ortasının (C) merkezindeki sıcaklık değişimleri.
Şekil 3, yapı 0 ve yapı 1'in pota içindeki farklı zamanlardaki malzeme taşınımını göstermektedir. Hammadde alanındaki ve büyüme odasındaki gaz fazı malzeme akış hızı, konumun artmasıyla artmakta ve büyüme ilerledikçe malzeme taşınımı zayıflamaktadır. Şekil 3 ayrıca simülasyon koşulları altında ham maddenin önce potanın yan duvarında ve sonra potanın tabanında grafitleştiğini göstermektedir. Ayrıca ham maddenin yüzeyinde yeniden kristalleşme vardır ve büyüme ilerledikçe kademeli olarak kalınlaşmaktadır. Şekil 4(a) ve 4(b), ham maddenin içindeki malzeme akış hızının büyüme ilerledikçe azaldığını ve 100 saatteki malzeme akış hızının başlangıç anının yaklaşık %50'si olduğunu göstermektedir; ancak, ham maddenin grafitlenmesi nedeniyle akış hızı kenarda nispeten büyüktür ve kenardaki akış hızı, 100 saatteki orta alandaki akış hızının 10 katından fazladır; Ek olarak, yapı 1'deki PG'nin etkisi, yapı 1'in ham madde alanındaki malzeme akış hızını yapı 0'ınkinden daha düşük hale getirir. Şekil 4(c)'de, hem ham madde alanındaki hem de büyüme odasındaki malzeme akışı, büyüme ilerledikçe kademeli olarak zayıflar ve ham madde alanındaki malzeme akışı, pota kenarındaki hava akış kanalının açılması ve tepedeki yeniden kristalleşmenin engellenmesi nedeniyle azalmaya devam eder; büyüme odasında, yapı 0'ın malzeme akış hızı ilk 30 saatte hızla %16'ya düşer ve sonraki sürede yalnızca %3 azalırken, yapı 1 büyüme süreci boyunca nispeten sabit kalır. Bu nedenle, PG büyüme odasındaki malzeme akış hızının sabitlenmesine yardımcı olur. Şekil 4(d), kristal büyüme cephesindeki malzeme akış hızını karşılaştırır. Başlangıç anında ve 100 saatte, yapı 0'ın büyüme bölgesindeki malzeme taşınımı yapı 1'dekinden daha güçlüdür, ancak yapı 0'ın kenarında her zaman yüksek akış hızı alanı vardır ve bu da kenarda aşırı büyümeye yol açar. Yapı 1'deki PG'nin varlığı bu olguyu etkili bir şekilde bastırır.

Şekil 3 Potadaki malzeme akışı. Yapılar 0 ve 1'de farklı zamanlarda gaz malzeme taşınmasının akım çizgileri (sol) ve hız vektörleri (sağ), hız vektörü birimi: m/s
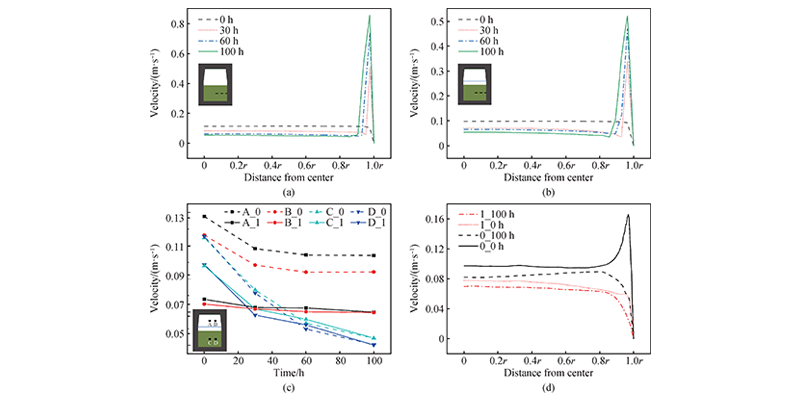
Şekil 4 Malzeme akış hızındaki değişimler. (a) 0, 30, 60 ve 100 saatte yapı 0'ın hammaddesinin ortasındaki malzeme akış hızı dağılımındaki değişimler, r hammadde alanının yarıçapıdır; (b) 0, 30, 60 ve 100 saatte yapı 1'in hammaddesinin ortasındaki malzeme akış hızı dağılımındaki değişimler, r hammadde alanının yarıçapıdır; (c) 0 ve 1 yapılarının büyüme odası (A, B) içindeki ve hammaddesi (C, D) içindeki malzeme akış hızındaki zaman içindeki değişimler; (d) 0 ve 1 yapılarının tohum kristal yüzeyine yakın malzeme akış hızı dağılımı, r tohum kristalinin yarıçapıdır
C/Si, SiC kristal büyümesinin kristal kararlılığını ve kusur yoğunluğunu etkiler. Şekil 5(a), iki yapının başlangıç anındaki C/Si oranı dağılımını karşılaştırır. C/Si oranı, potanın altından üstüne doğru kademeli olarak azalır ve yapı 1'in C/Si oranı, farklı pozisyonlarda her zaman yapı 0'ınkinden daha yüksektir. Şekil 5(b) ve 5(c), C/Si oranının büyümeyle kademeli olarak arttığını, bunun da büyümenin sonraki aşamasında iç sıcaklıktaki artış, ham madde grafitleşmesinin artması ve gaz fazındaki Si bileşenlerinin grafit pota ile reaksiyonu ile ilişkili olduğunu gösterir. Şekil 5(d)'de, yapı 0 ve yapı 1'in C/Si oranları, PG'nin (0, 25 mm) altında oldukça farklıdır, ancak PG'nin (50 mm) üzerinde biraz farklıdır ve fark, kristale yaklaştıkça kademeli olarak artar. Genel olarak, yapı 1'in C/Si oranı daha yüksektir, bu da kristal formunu stabilize etmeye ve faz geçişi olasılığını azaltmaya yardımcı olur.

Şekil 5 C/Si oranının dağılımı ve değişimleri. (a) 0. saatte yapı 0 (sol) ve yapı 1 (sağ) pota içindeki C/Si oranı dağılımı; (b) 0. saatte yapı 0'ın pota merkez hattından farklı mesafelerdeki C/Si oranı (0, 30, 60, 100 saat); (c) 1. saatte yapı 1'in pota merkez hattından farklı mesafelerdeki C/Si oranı (0, 30, 60, 100 saat); (d) 0. saatte yapı 1'in (kesik çizgi) ve 25, 50, 75, 100 mm'lik farklı mesafelerdeki C/Si oranının karşılaştırılması (kesik çizgi) farklı zamanlarda yapı 1'in (kesik çizgi) pota merkez hattından farklı mesafelerde.
Şekil 6, iki yapının hammadde bölgelerindeki parçacık çapı ve gözeneklilikteki değişimleri göstermektedir. Şekil, hammadde çapının azaldığını ve pora duvarına yakın gözenekliliğin arttığını, kenar gözenekliliğinin artmaya devam ettiğini ve büyüme ilerledikçe parçacık çapının azalmaya devam ettiğini göstermektedir. Maksimum kenar gözenekliliği 100 saatte yaklaşık 0,99'dur ve minimum parçacık çapı yaklaşık 300 μm'dir. Parçacık çapı artarken, gözeneklilik hammaddenin üst yüzeyinde yeniden kristalleşmeye karşılık gelecek şekilde azalır. Yeniden kristalleşme alanının kalınlığı büyüme ilerledikçe artar ve parçacık boyutu ve gözeneklilik değişmeye devam eder. Maksimum parçacık çapı 1500 μm'nin üzerine ulaşır ve minimum gözeneklilik 0,13'tür. Ayrıca PG hammadde alanının sıcaklığını artırdığı ve gaz aşırı doygunluğu küçük olduğu için yapı 1'deki hammaddenin üst kısmının yeniden kristalleşme kalınlığı küçük olduğundan hammadde kullanım oranı iyileşmektedir.
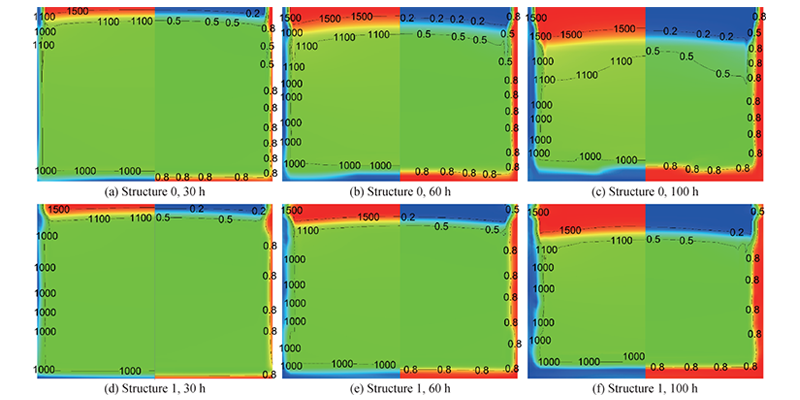 Şekil 6 Yapı 0 ve yapı 1'in ham madde alanının farklı zamanlardaki parçacık çapı (sol) ve gözenekliliğindeki (sağ) değişimler, parçacık çapı birimi: μm
Şekil 6 Yapı 0 ve yapı 1'in ham madde alanının farklı zamanlardaki parçacık çapı (sol) ve gözenekliliğindeki (sağ) değişimler, parçacık çapı birimi: μm
Şekil 7, yapı 0'ın büyümenin başlangıcında eğrildiğini göstermektedir; bu, ham madde kenarının grafitlenmesinden kaynaklanan aşırı malzeme akış hızıyla ilgili olabilir. Eğrilme derecesi, sonraki büyüme süreci sırasında zayıflar; bu, Şekil 4 (d)'deki yapı 0'ın kristal büyümesinin önündeki malzeme akış hızındaki değişime karşılık gelir. Yapı 1'de, PG'nin etkisi nedeniyle kristal arayüzü eğrilme göstermez. Ek olarak, PG ayrıca yapı 1'in büyüme hızını yapı 0'ınkinden önemli ölçüde düşürür. Yapı 1'in kristalinin 100 saat sonraki merkez kalınlığı, yapı 0'ınkinin yalnızca %68'idir.
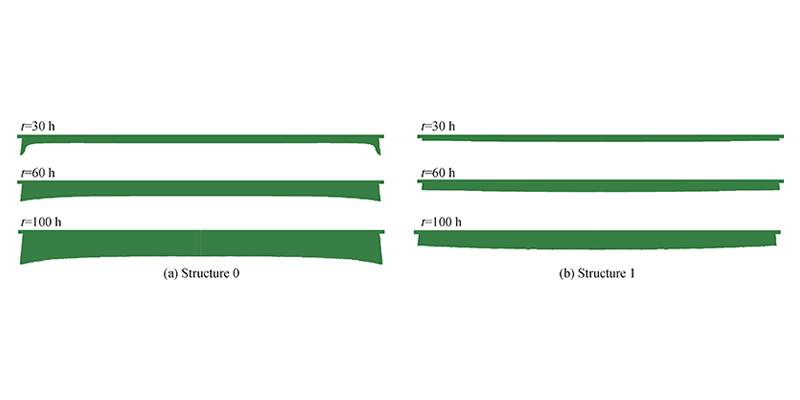
Şekil 7 Yapı 0 ve yapı 1 kristallerinin 30, 60 ve 100 saatteki arayüz değişimleri
Kristal büyümesi sayısal simülasyonun işlem koşulları altında gerçekleştirildi. Yapı 0 ve yapı 1 tarafından büyütülen kristaller sırasıyla Şekil 8(a) ve Şekil 8(b)'de gösterilmiştir. Yapı 0'ın kristali, merkezi alanda dalgalanmalar ve kenarda bir faz geçişi ile içbükey bir arayüz gösterir. Yüzey dışbükeyliği, gaz fazı malzemelerin taşınmasında belirli bir derecede homojensizliği temsil eder ve faz geçişinin meydana gelmesi düşük C/Si oranına karşılık gelir. Yapı 1 tarafından büyütülen kristalin arayüzü hafif dışbükeydir, faz geçişi bulunmaz ve kalınlık PG'siz kristalin %65'idir. Genel olarak, kristal büyüme sonuçları simülasyon sonuçlarına karşılık gelir, yapı 1'in kristal arayüzünde daha büyük bir radyal sıcaklık farkı vardır, kenardaki hızlı büyüme bastırılır ve genel malzeme akış hızı daha yavaştır. Genel eğilim sayısal simülasyon sonuçlarıyla tutarlıdır.
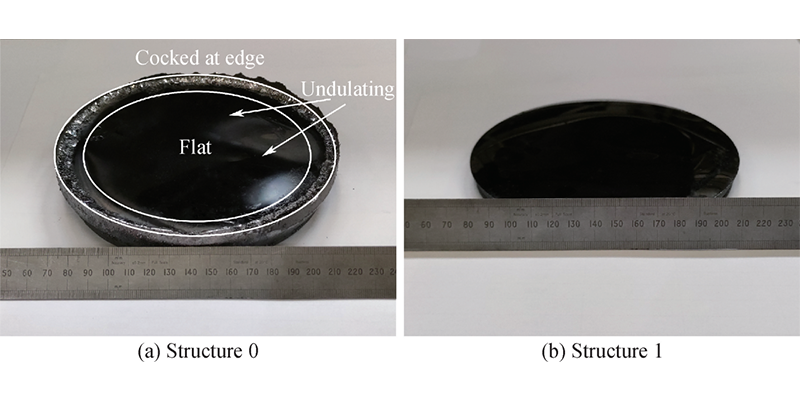
Şekil 8 Yapı 0 ve yapı 1 altında büyütülen SiC kristalleri
Çözüm
PG, ham madde alanının genel sıcaklığının iyileştirilmesine ve eksenel ve radyal sıcaklık düzgünlüğünün iyileştirilmesine elverişlidir, ham maddenin tam süblimleşmesini ve kullanımını teşvik eder; üst ve alt sıcaklık farkı artar ve tohum kristal yüzeyinin radyal gradyanı artar, bu da dışbükey arayüz büyümesinin korunmasına yardımcı olur. Kütle transferi açısından, PG'nin tanıtımı genel kütle transfer oranını azaltır, PG içeren büyüme odasındaki malzeme akış hızı zamanla daha az değişir ve tüm büyüme süreci daha kararlıdır. Aynı zamanda, PG ayrıca aşırı kenar kütle transferinin oluşumunu etkili bir şekilde engeller. Ek olarak, PG ayrıca büyüme ortamının C/Si oranını, özellikle tohum kristal arayüzünün ön kenarında artırır, bu da büyüme süreci sırasında faz değişiminin oluşumunu azaltmaya yardımcı olur. Aynı zamanda, PG'nin termal yalıtım etkisi, ham maddenin üst kısmında yeniden kristalleşmenin oluşumunu bir dereceye kadar azaltır. Kristal büyümesi için, PG kristal büyüme oranını yavaşlatır, ancak büyüme arayüzü daha dışbükeydir. Bu nedenle PG, SiC kristallerinin büyüme ortamını iyileştirmek ve kristal kalitesini optimize etmek için etkili bir araçtır.
Gönderi zamanı: 18-Haz-2024
