Základný procesSiCRast kryštálov sa delí na sublimáciu a rozklad surovín pri vysokej teplote, transport látok v plynnej fáze pôsobením teplotného gradientu a rekryštalizačný rast látok v plynnej fáze na zárodočnom kryštáli. Na základe toho je vnútro téglika rozdelené na tri časti: oblasť surovín, rastovú komoru a zárodočný kryštál. Na základe skutočného odporu bol vytvorený numerický simulačný model.SiCzariadenie na rast monokryštálov (pozri obrázok 1). Vo výpočte: spodná časťtéglikje 90 mm od spodnej časti bočného ohrievača, horná teplota téglika je 2100 ℃, priemer častíc suroviny je 1000 μm, pórovitosť je 0,6, rastový tlak je 300 Pa a čas rastu je 100 h. Hrúbka PG je 5 mm, priemer sa rovná vnútornému priemeru téglika a nachádza sa 30 mm nad surovinou. Pri výpočte sa zohľadňujú procesy sublimácie, karbonizácie a rekryštalizácie zóny suroviny a reakcia medzi PG a látkami v plynnej fáze sa nezohľadňuje. Parametre fyzikálnych vlastností súvisiace s výpočtom sú uvedené v tabuľke 1.
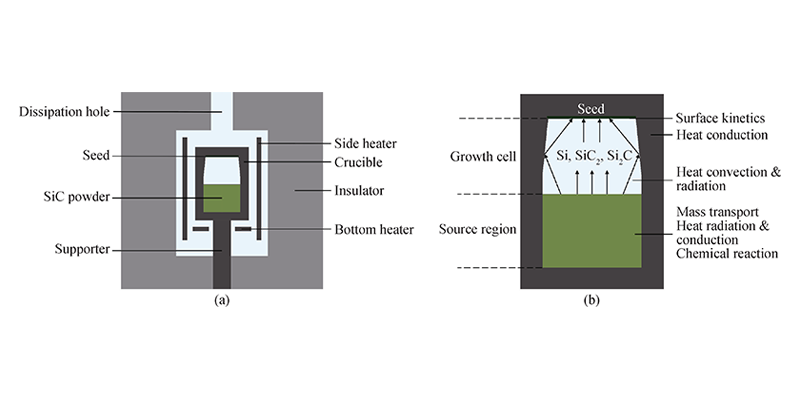
Obrázok 1 Simulačný výpočtový model. (a) Model tepelného poľa pre simuláciu rastu kryštálov; (b) Rozdelenie vnútorného priestoru téglika a súvisiace fyzikálne problémy
Tabuľka 1 Niektoré fyzikálne parametre použité pri výpočte

Obrázok 2(a) ukazuje, že teplota štruktúry obsahujúcej PG (označená ako štruktúra 1) je vyššia ako teplota štruktúry bez PG (označená ako štruktúra 0) pod PG a nižšia ako teplota štruktúry 0 nad PG. Celkový teplotný gradient sa zvyšuje a PG pôsobí ako tepelnoizolačné činidlo. Podľa obrázkov 2(b) a 2(c) sú axiálne a radiálne teplotné gradienty štruktúry 1 v zóne surového materiálu menšie, rozloženie teploty je rovnomernejšie a sublimácia materiálu je úplnejšia. Na rozdiel od zóny surového materiálu, obrázok 2(c) ukazuje, že radiálny teplotný gradient v zárodočnom kryštáli štruktúry 1 je väčší, čo môže byť spôsobené rôznymi pomermi rôznych režimov prenosu tepla, čo pomáha kryštálu rásť s konvexným rozhraním. Na obrázku 2(d) teplota v rôznych polohách téglika vykazuje rastúci trend s postupujúcim rastom, ale teplotný rozdiel medzi štruktúrou 0 a štruktúrou 1 sa postupne znižuje v zóne surového materiálu a postupne sa zvyšuje v rastovej komore.
 Obrázok 2 Rozloženie teploty a zmeny v tégliku. (a) Rozloženie teploty vo vnútri téglika štruktúry 0 (vľavo) a štruktúry 1 (vpravo) v čase 0 h, jednotka: ℃; (b) Rozloženie teploty na stredovej čiare téglika štruktúry 0 a štruktúry 1 od dna suroviny k zárodočnému kryštálu v čase 0 h; (c) Rozloženie teploty od stredu k okraju téglika na povrchu zárodočného kryštálu (A) a povrchu suroviny (B), strede (C) a spodku (D) v čase 0 h, horizontálna os r je polomer zárodočného kryštálu pre A a polomer plochy suroviny pre B~D; (d) Zmeny teploty v strede hornej časti (A), na povrchu suroviny (B) a v strede (C) rastovej komory štruktúry 0 a štruktúry 1 v čase 0, 30, 60 a 100 h.
Obrázok 2 Rozloženie teploty a zmeny v tégliku. (a) Rozloženie teploty vo vnútri téglika štruktúry 0 (vľavo) a štruktúry 1 (vpravo) v čase 0 h, jednotka: ℃; (b) Rozloženie teploty na stredovej čiare téglika štruktúry 0 a štruktúry 1 od dna suroviny k zárodočnému kryštálu v čase 0 h; (c) Rozloženie teploty od stredu k okraju téglika na povrchu zárodočného kryštálu (A) a povrchu suroviny (B), strede (C) a spodku (D) v čase 0 h, horizontálna os r je polomer zárodočného kryštálu pre A a polomer plochy suroviny pre B~D; (d) Zmeny teploty v strede hornej časti (A), na povrchu suroviny (B) a v strede (C) rastovej komory štruktúry 0 a štruktúry 1 v čase 0, 30, 60 a 100 h.
Obrázok 3 znázorňuje transport materiálu v rôznych časoch v tégliku štruktúry 0 a štruktúry 1. Prietok materiálu v plynnej fáze v oblasti suroviny a rastovej komore sa zvyšuje so zvyšujúcou sa polohou a transport materiálu sa s postupom rastu oslabuje. Obrázok 3 tiež ukazuje, že za simulačných podmienok surovina najprv grafitizuje na bočnej stene téglika a potom na dne téglika. Okrem toho dochádza k rekryštalizácii na povrchu suroviny a postupne sa s postupom rastu zahusťuje. Obrázky 4(a) a 4(b) ukazujú, že prietok materiálu vo vnútri suroviny sa s postupom rastu znižuje a prietok materiálu po 100 hodinách je približne 50 % počiatočného okamihu; prietok je však na okraji relatívne veľký v dôsledku grafitizácie suroviny a prietok na okraji je viac ako 10-násobok prietoku v strednej oblasti po 100 hodinách; Okrem toho vplyv PG v štruktúre 1 znižuje rýchlosť toku materiálu v oblasti surovín štruktúry 1 ako v štruktúre 0. Na obrázku 4(c) sa tok materiálu v oblasti surovín aj v rastovej komore postupne znižuje s postupujúcim rastom a tok materiálu v oblasti surovín naďalej klesá, čo je spôsobené otvorením kanála prúdenia vzduchu na okraji téglika a prekážkou rekryštalizácie v hornej časti; v rastovej komore rýchlosť toku materiálu štruktúry 0 v prvých 30 hodinách rýchlo klesá na 16 % a v nasledujúcom čase klesá iba o 3 %, zatiaľ čo štruktúra 1 zostáva počas celého procesu rastu relatívne stabilná. Preto PG pomáha stabilizovať rýchlosť toku materiálu v rastovej komore. Obrázok 4(d) porovnáva rýchlosť toku materiálu na fronte rastu kryštálov. V počiatočnom okamihu a po 100 hodinách je transport materiálu v rastovej zóne štruktúry 0 silnejší ako v štruktúre 1, ale na okraji štruktúry 0 je vždy oblasť s vysokou rýchlosťou prúdenia, čo vedie k nadmernému rastu na okraji. Prítomnosť PG v štruktúre 1 tento jav účinne potláča.

Obrázok 3 Tok materiálu v tégliku. Prúdové čiary (vľavo) a vektory rýchlosti (vpravo) transportu plynného materiálu v štruktúrach 0 a 1 v rôznych časoch, jednotka vektora rýchlosti: m/s
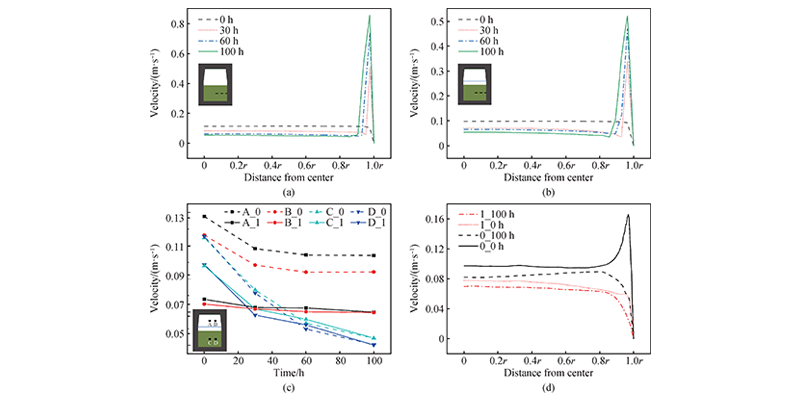
Obrázok 4 Zmeny v prietoku materiálu. (a) Zmeny v rozložení prietoku materiálu v strede suroviny štruktúry 0 v čase 0, 30, 60 a 100 h, r je polomer oblasti suroviny; (b) Zmeny v rozložení prietoku materiálu v strede suroviny štruktúry 1 v čase 0, 30, 60 a 100 h, r je polomer oblasti suroviny; (c) Zmeny v prietoku materiálu vo vnútri rastovej komory (A, B) a vo vnútri suroviny (C, D) štruktúr 0 a 1 v priebehu času; (d) Rozloženie prietoku materiálu v blízkosti povrchu zárodočného kryštálu štruktúr 0 a 1 v čase 0 a 100 h, r je polomer zárodočného kryštálu
C/Si ovplyvňuje kryštalickú stabilitu a hustotu defektov rastu kryštálov SiC. Obrázok 5(a) porovnáva rozloženie pomeru C/Si oboch štruktúr v počiatočnom momente. Pomer C/Si postupne klesá od dna k vrchu téglika a pomer C/Si štruktúry 1 je vždy vyšší ako pomer štruktúry 0 v rôznych polohách. Obrázky 5(b) a 5(c) ukazujú, že pomer C/Si postupne rastie s rastom, čo súvisí so zvýšením vnútornej teploty v neskoršom štádiu rastu, zvýšením grafitizácie suroviny a reakciou zložiek Si v plynnej fáze s grafitovým téglikom. Na obrázku 5(d) sú pomery C/Si štruktúry 0 a štruktúry 1 dosť odlišné pod PG (0, 25 mm), ale mierne odlišné nad PG (50 mm) a rozdiel sa postupne zvyšuje s približovaním sa ku kryštálu. Vo všeobecnosti je pomer C/Si štruktúry 1 vyšší, čo pomáha stabilizovať kryštálovú formu a znižovať pravdepodobnosť fázového prechodu.

Obrázok 5 Rozloženie a zmeny pomeru C/Si. (a) Rozloženie pomeru C/Si v téglikoch štruktúry 0 (vľavo) a štruktúry 1 (vpravo) v čase 0 h; (b) pomer C/Si v rôznych vzdialenostiach od stredovej čiary téglika štruktúry 0 v rôznych časoch (0, 30, 60, 100 h); (c) pomer C/Si v rôznych vzdialenostiach od stredovej čiary téglika štruktúry 1 v rôznych časoch (0, 30, 60, 100 h); (d) Porovnanie pomeru C/Si v rôznych vzdialenostiach (0, 25, 50, 75, 100 mm) od stredovej čiary téglika štruktúry 0 (plná čiara) a štruktúry 1 (prerušovaná čiara) v rôznych časoch (0, 30, 60, 100 h).
Obrázok 6 znázorňuje zmeny priemeru častíc a pórovitosti oblastí surového materiálu oboch štruktúr. Obrázok ukazuje, že priemer surového materiálu sa zmenšuje a pórovitosť sa zvyšuje v blízkosti steny téglika, pričom pórovitosť okrajov sa naďalej zvyšuje a priemer častíc sa s postupujúcim rastom znižuje. Maximálna pórovitosť okrajov je po 100 hodinách približne 0,99 a minimálny priemer častíc je približne 300 μm. Priemer častíc sa zväčšuje a pórovitosť sa znižuje na hornom povrchu surového materiálu, čo zodpovedá rekryštalizácii. Hrúbka oblasti rekryštalizácie sa s postupujúcim rastom zväčšuje a veľkosť a pórovitosť častíc sa naďalej menia. Maximálny priemer častíc dosahuje viac ako 1500 μm a minimálna pórovitosť je 0,13. Okrem toho, keďže PG zvyšuje teplotu oblasti surového materiálu a presýtenie plynom je malé, hrúbka rekryštalizácie hornej časti surového materiálu štruktúry 1 je malá, čo zlepšuje mieru využitia suroviny.
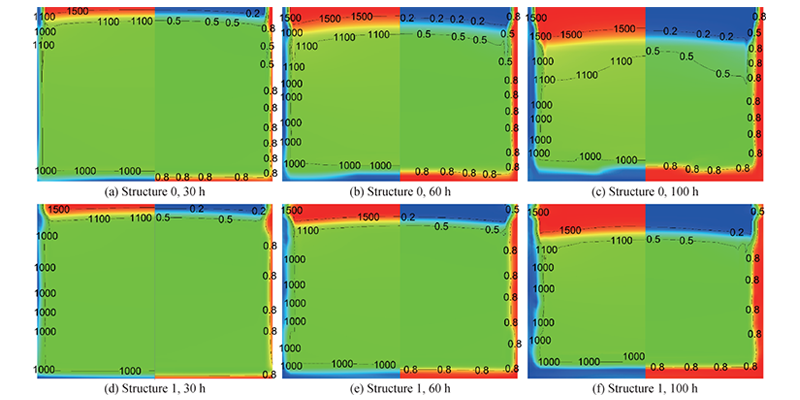 Obrázok 6 Zmeny priemeru častíc (vľavo) a pórovitosti (vpravo) oblasti surového materiálu štruktúry 0 a štruktúry 1 v rôznych časoch, jednotka priemeru častíc: μm
Obrázok 6 Zmeny priemeru častíc (vľavo) a pórovitosti (vpravo) oblasti surového materiálu štruktúry 0 a štruktúry 1 v rôznych časoch, jednotka priemeru častíc: μm
Obrázok 7 ukazuje, že štruktúra 0 sa na začiatku rastu deformuje, čo môže súvisieť s nadmerným prietokom materiálu spôsobeným grafitizáciou okraja surového materiálu. Stupeň deformácie sa počas následného procesu rastu oslabuje, čo zodpovedá zmene prietoku materiálu na čele rastu kryštálov štruktúry 0 na obrázku 4 (d). V štruktúre 1 sa v dôsledku vplyvu PG na kryštalickom rozhraní deformácia nevykazuje. Okrem toho PG tiež výrazne znižuje rýchlosť rastu štruktúry 1 v porovnaní so štruktúrou 0. Hrúbka kryštálu štruktúry 1 v strede po 100 hodinách je iba 68 % hrúbky štruktúry 0.
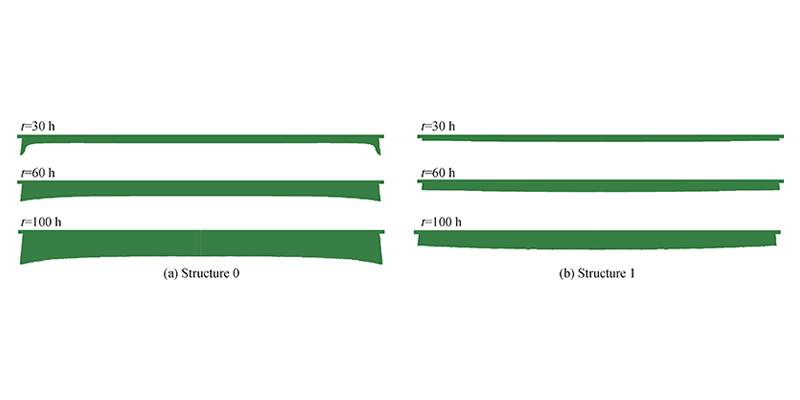
Obrázok 7 Zmeny rozhrania kryštálov so štruktúrou 0 a štruktúrou 1 po 30, 60 a 100 hodinách
Rast kryštálov sa uskutočnil za procesných podmienok numerickej simulácie. Kryštály vypestované štruktúrou 0 a štruktúrou 1 sú znázornené na obrázku 8(a) a obrázku 8(b). Kryštál štruktúry 0 vykazuje konkávne rozhranie s vlnením v centrálnej oblasti a fázovým prechodom na okraji. Povrchová konvexnosť predstavuje určitý stupeň nehomogenity v transporte materiálov v plynnej fáze a výskyt fázového prechodu zodpovedá nízkemu pomeru C/Si. Rozhranie kryštálu vypestovaného štruktúrou 1 je mierne konvexné, nie je zistený žiadny fázový prechod a hrúbka je 65 % hrúbky kryštálu bez PG. Vo všeobecnosti výsledky rastu kryštálov zodpovedajú výsledkom simulácie, s väčším radiálnym teplotným rozdielom na kryštalickom rozhraní štruktúry 1 je rýchly rast na okraji potlačený a celková rýchlosť toku materiálu je pomalšia. Celkový trend je v súlade s výsledkami numerickej simulácie.
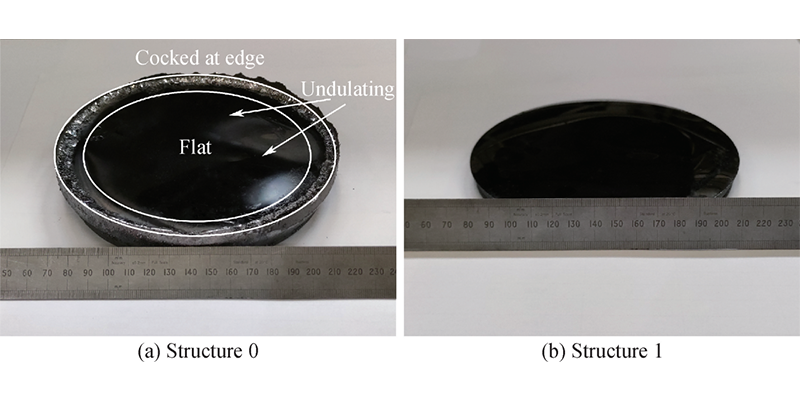
Obrázok 8 Kryštály SiC vypestované v štruktúre 0 a štruktúre 1
Záver
PG prispieva k zlepšeniu celkovej teploty v oblasti surového materiálu a k zlepšeniu axiálnej a radiálnej teplotnej rovnomernosti, čo podporuje úplnú sublimáciu a využitie suroviny; zvyšuje sa rozdiel teplôt medzi hornou a dolnou časťou a zvyšuje sa radiálny gradient povrchu zárodočného kryštálu, čo pomáha udržiavať rast konvexného rozhrania. Pokiaľ ide o prenos hmoty, zavedenie PG znižuje celkovú rýchlosť prenosu hmoty, prietok materiálu v rastovej komore obsahujúcej PG sa s časom mení menej a celý rastový proces je stabilnejší. Zároveň PG účinne inhibuje výskyt nadmerného prenosu hmoty na okrajoch. Okrem toho PG tiež zvyšuje pomer C/Si v rastovom prostredí, najmä na prednom okraji rozhrania zárodočného kryštálu, čo pomáha znižovať výskyt fázových zmien počas procesu rastu. Zároveň tepelnoizolačný účinok PG do určitej miery znižuje výskyt rekryštalizácie v hornej časti suroviny. Pri raste kryštálov PG spomaľuje rýchlosť rastu kryštálov, ale rastové rozhranie je konvexnejšie. Preto je PG účinným prostriedkom na zlepšenie rastového prostredia kryštálov SiC a optimalizáciu kvality kryštálov.
Čas uverejnenia: 18. júna 2024
