Основной процессSiCРост кристаллов делится на сублимацию и разложение исходных материалов при высокой температуре, транспортировку газофазных веществ под действием градиента температуры и рекристаллизационный рост газофазных веществ на затравочном кристалле. Исходя из этого, внутреннее пространство тигля разделено на три части: область исходного материала, камеру роста и затравочный кристалл. Была составлена численная имитационная модель на основе фактического резистивногоSiCОборудование для выращивания монокристаллов (см. Рисунок 1). В расчете: днотигельнаходится на расстоянии 90 мм от дна бокового нагревателя, верхняя температура тигля составляет 2100 ℃, диаметр частиц сырья составляет 1000 мкм, пористость составляет 0,6, давление роста составляет 300 Па, а время роста составляет 100 ч. Толщина PG составляет 5 мм, диаметр равен внутреннему диаметру тигля, и он расположен на 30 мм выше сырья. Процессы сублимации, карбонизации и рекристаллизации зоны сырья учитываются в расчете, а реакция между PG и веществами газовой фазы не учитывается. Параметры физических свойств, связанные с расчетом, приведены в таблице 1.
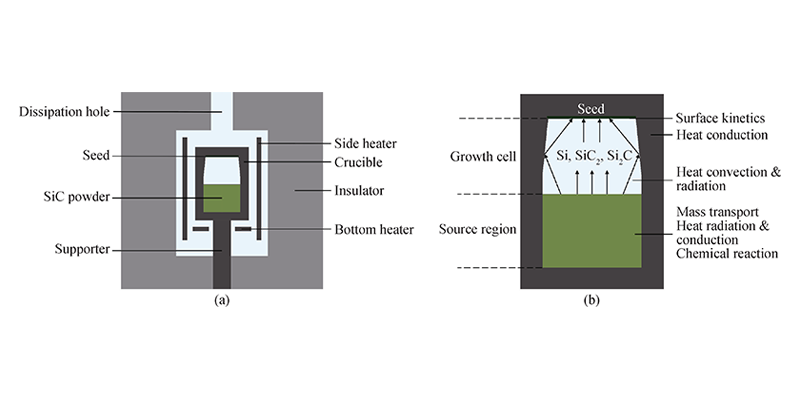
Рисунок 1. Модель расчета имитации. (а) Модель теплового поля для моделирования роста кристаллов; (б) Разделение внутренней области тигля и связанные с этим физические проблемы
Таблица 1 Некоторые физические параметры, используемые в расчетах

Рисунок 2(a) показывает, что температура структуры, содержащей PG (обозначенной как структура 1), выше, чем у структуры без PG (обозначенной как структура 0) ниже PG, и ниже, чем у структуры 0 выше PG. Общий градиент температуры увеличивается, и PG действует как теплоизолирующий агент. Согласно рисункам 2(b) и 2(c), аксиальный и радиальный градиенты температуры структуры 1 в зоне сырья меньше, распределение температуры более равномерное, а сублимация материала более полная. В отличие от зоны сырья, рисунок 2(c) показывает, что радиальный градиент температуры на затравочном кристалле структуры 1 больше, что может быть вызвано различными пропорциями различных режимов теплопередачи, что помогает кристаллу расти с выпуклым интерфейсом. На рисунке 2(d) температура в разных положениях в тигле показывает тенденцию к увеличению по мере роста, но разница температур между структурой 0 и структурой 1 постепенно уменьшается в зоне сырья и постепенно увеличивается в камере роста.
 Рисунок 2 Распределение температуры и изменения в тигле. (a) Распределение температуры внутри тигля структуры 0 (слева) и структуры 1 (справа) в момент времени 0 ч, единица измерения: ℃; (b) Распределение температуры на центральной линии тигля структуры 0 и структуры 1 от дна сырья до затравочного кристалла в момент времени 0 ч; (c) Распределение температуры от центра к краю тигля на поверхности затравочного кристалла (A) и поверхности сырья (B), середине (C) и дне (D) в момент времени 0 ч, горизонтальная ось r - радиус затравочного кристалла для A и радиус области сырья для B~D; (d) Изменения температуры в центре верхней части (A), поверхности сырья (B) и середине (C) камеры роста структуры 0 и структуры 1 в моменты времени 0, 30, 60 и 100 ч.
Рисунок 2 Распределение температуры и изменения в тигле. (a) Распределение температуры внутри тигля структуры 0 (слева) и структуры 1 (справа) в момент времени 0 ч, единица измерения: ℃; (b) Распределение температуры на центральной линии тигля структуры 0 и структуры 1 от дна сырья до затравочного кристалла в момент времени 0 ч; (c) Распределение температуры от центра к краю тигля на поверхности затравочного кристалла (A) и поверхности сырья (B), середине (C) и дне (D) в момент времени 0 ч, горизонтальная ось r - радиус затравочного кристалла для A и радиус области сырья для B~D; (d) Изменения температуры в центре верхней части (A), поверхности сырья (B) и середине (C) камеры роста структуры 0 и структуры 1 в моменты времени 0, 30, 60 и 100 ч.
На рисунке 3 показан перенос материала в разное время в тигле структуры 0 и структуры 1. Расход материала газовой фазы в зоне сырья и камере роста увеличивается с увеличением положения, а транспорт материала ослабевает по мере продвижения роста. На рисунке 3 также показано, что в условиях моделирования сырье сначала графитизируется на боковой стенке тигля, а затем на дне тигля. Кроме того, на поверхности сырья происходит рекристаллизация, и оно постепенно утолщается по мере продвижения роста. На рисунках 4(a) и 4(b) показано, что расход материала внутри сырья уменьшается по мере продвижения роста, а расход материала через 100 ч составляет около 50% от начального момента; однако расход относительно велик на краю из-за графитизации сырья, а расход на краю более чем в 10 раз превышает расход в средней области через 100 ч; Кроме того, влияние PG в структуре 1 делает скорость потока материала в зоне сырья структуры 1 ниже, чем у структуры 0. На рисунке 4(c) поток материала как в зоне сырья, так и в камере роста постепенно ослабевает по мере продвижения роста, а поток материала в зоне сырья продолжает уменьшаться, что вызвано открытием канала потока воздуха на краю тигля и препятствием рекристаллизации в верхней части; в камере роста скорость потока материала структуры 0 быстро уменьшается в первые 30 ч до 16% и уменьшается только на 3% в последующее время, в то время как структура 1 остается относительно стабильной на протяжении всего процесса роста. Таким образом, PG помогает стабилизировать скорость потока материала в камере роста. На рисунке 4(d) сравнивается скорость потока материала на фронте роста кристалла. В начальный момент и 100 ч транспорт материала в зоне роста структуры 0 сильнее, чем в структуре 1, но на краю структуры 0 всегда имеется область с высокой скоростью потока, что приводит к избыточному росту на краю. Наличие ПГ в структуре 1 эффективно подавляет это явление.

Рисунок 3. Поток материала в тигле. Линии тока (слева) и векторы скорости (справа) переноса газа и материала в структурах 0 и 1 в разное время, единица вектора скорости: м/с
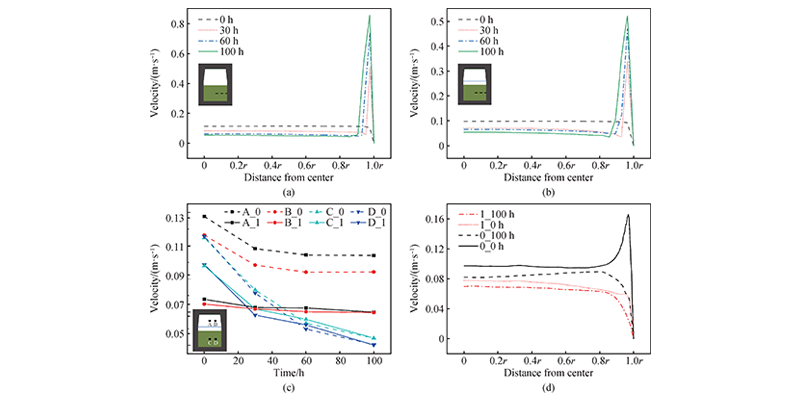
Рисунок 4. Изменение расхода материала. (a) Изменение распределения расхода материала в середине сырья структуры 0 в моменты времени 0, 30, 60 и 100 ч, r — радиус области сырья; (b) Изменение распределения расхода материала в середине сырья структуры 1 в моменты времени 0, 30, 60 и 100 ч, r — радиус области сырья; (c) Изменение расхода материала внутри камеры роста (A, B) и внутри сырья (C, D) структур 0 и 1 с течением времени; (d) Распределение расхода материала вблизи поверхности затравочного кристалла структур 0 и 1 в моменты времени 0 и 100 ч, r — радиус затравочного кристалла
C/Si влияет на кристаллическую стабильность и плотность дефектов роста кристаллов SiC. На рисунке 5(a) сравнивается распределение соотношения C/Si двух структур в начальный момент. Соотношение C/Si постепенно уменьшается от дна к верху тигля, а соотношение C/Si структуры 1 всегда выше, чем у структуры 0 в разных положениях. На рисунках 5(b) и 5(c) показано, что соотношение C/Si постепенно увеличивается с ростом, что связано с повышением внутренней температуры на поздней стадии роста, усилением графитизации сырья и реакцией компонентов Si в газовой фазе с графитовым тиглем. На рисунке 5(d) соотношения C/Si структуры 0 и структуры 1 существенно различаются ниже PG (0, 25 мм), но немного различаются выше PG (50 мм), и разница постепенно увеличивается по мере приближения к кристаллу. В целом соотношение C/Si структуры 1 выше, что помогает стабилизировать форму кристалла и снизить вероятность фазового перехода.

Рисунок 5 Распределение и изменение соотношения C/Si. (a) Распределение соотношения C/Si в тиглях структуры 0 (слева) и структуры 1 (справа) в момент времени 0 ч; (b) Соотношение C/Si на разных расстояниях от центральной линии тигля структуры 0 в разное время (0, 30, 60, 100 ч); (c) Соотношение C/Si на разных расстояниях от центральной линии тигля структуры 1 в разное время (0, 30, 60, 100 ч); (d) Сравнение соотношения C/Si на разных расстояниях (0, 25, 50, 75, 100 мм) от центральной линии тигля структуры 0 (сплошная линия) и структуры 1 (пунктирная линия) в разное время (0, 30, 60, 100 ч).
На рисунке 6 показаны изменения диаметра частиц и пористости областей сырья двух структур. На рисунке показано, что диаметр сырья уменьшается, а пористость увеличивается вблизи стенки тигля, а пористость кромки продолжает увеличиваться, а диаметр частиц продолжает уменьшаться по мере роста. Максимальная пористость кромки составляет около 0,99 при 100 ч, а минимальный диаметр частиц составляет около 300 мкм. Диаметр частиц увеличивается, а пористость уменьшается на верхней поверхности сырья, что соответствует рекристаллизации. Толщина области рекристаллизации увеличивается по мере роста, а размер частиц и пористость продолжают изменяться. Максимальный диаметр частиц достигает более 1500 мкм, а минимальная пористость составляет 0,13. Кроме того, поскольку ПГ повышает температуру зоны сырья, а пересыщение газа невелико, толщина перекристаллизации верхней части сырья структуры 1 невелика, что повышает коэффициент использования сырья.
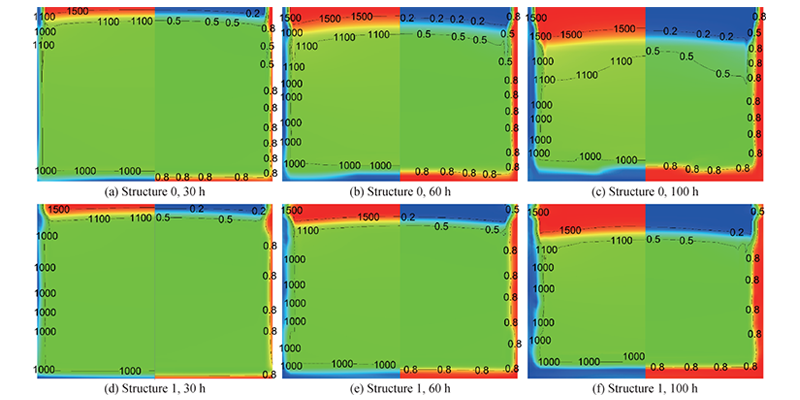 Рисунок 6. Изменение диаметра частиц (слева) и пористости (справа) площади сырья структуры 0 и структуры 1 в разное время, единица измерения диаметра частиц: мкм
Рисунок 6. Изменение диаметра частиц (слева) и пористости (справа) площади сырья структуры 0 и структуры 1 в разное время, единица измерения диаметра частиц: мкм
На рисунке 7 показано, что структура 0 деформируется в начале роста, что может быть связано с избыточной скоростью потока материала, вызванной графитизацией края исходного материала. Степень деформации ослабевает в ходе последующего процесса роста, что соответствует изменению скорости потока материала на фронте роста кристалла структуры 0 на рисунке 4 (d). В структуре 1 из-за влияния ПГ интерфейс кристалла не показывает деформации. Кроме того, ПГ также делает скорость роста структуры 1 значительно ниже, чем у структуры 0. Центральная толщина кристалла структуры 1 через 100 ч составляет всего 68% от таковой у структуры 0.
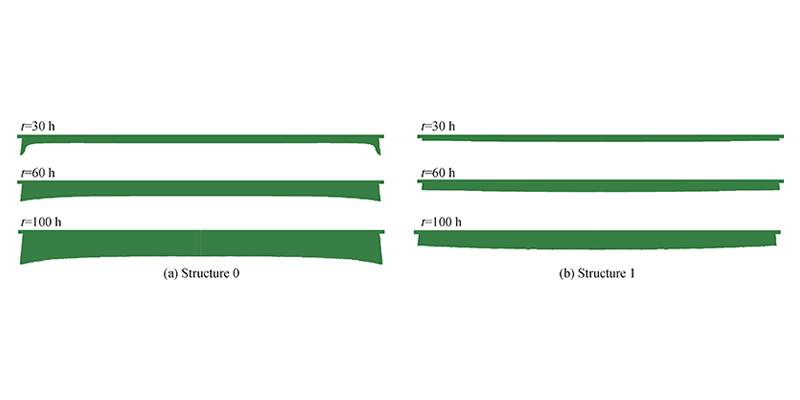
Рисунок 7 Изменения интерфейса кристаллов структуры 0 и структуры 1 через 30, 60 и 100 ч.
Рост кристаллов проводился в условиях процесса численного моделирования. Кристаллы, выращенные структурой 0 и структурой 1, показаны на рисунке 8(a) и рисунке 8(b) соответственно. Кристалл структуры 0 показывает вогнутый интерфейс с волнистостью в центральной области и фазовым переходом на краю. Выпуклость поверхности представляет собой определенную степень неоднородности в транспорте газофазных материалов, а возникновение фазового перехода соответствует низкому отношению C/Si. Интерфейс кристалла, выращенного структурой 1, слегка выпуклый, фазовый переход не обнаружен, а толщина составляет 65% от кристалла без PG. В целом результаты роста кристаллов соответствуют результатам моделирования, при большем радиальном перепаде температур на интерфейсе кристалла структуры 1 быстрый рост на краю подавляется, а общая скорость потока материала медленнее. Общая тенденция согласуется с результатами численного моделирования.
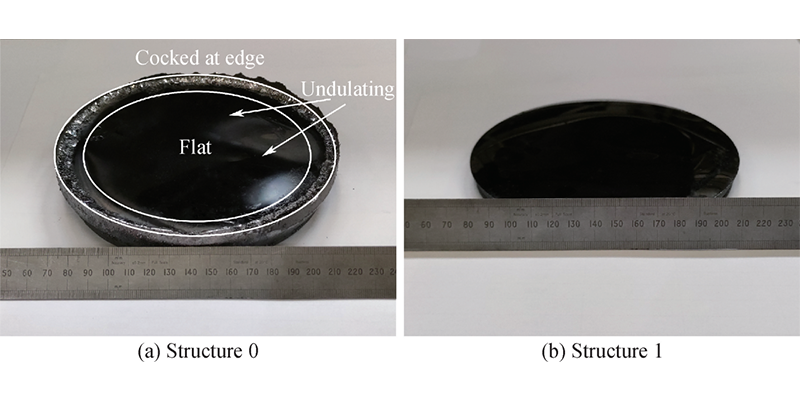
Рисунок 8 Кристаллы SiC, выращенные в условиях структуры 0 и структуры 1
Заключение
PG способствует улучшению общей температуры в зоне сырья и улучшению осевой и радиальной однородности температуры, способствуя полной сублимации и использованию сырья; разница температур сверху и снизу увеличивается, а радиальный градиент поверхности затравочного кристалла увеличивается, что помогает поддерживать рост выпуклого интерфейса. С точки зрения массопереноса введение PG снижает общую скорость массопереноса, скорость потока материала в камере роста, содержащей PG, меньше изменяется со временем, и весь процесс роста становится более стабильным. В то же время PG также эффективно подавляет возникновение чрезмерного краевого массопереноса. Кроме того, PG также увеличивает соотношение C/Si в среде роста, особенно на переднем крае интерфейса затравочного кристалла, что помогает уменьшить возникновение фазового перехода во время процесса роста. В то же время теплоизоляционный эффект PG в определенной степени снижает возникновение рекристаллизации в верхней части сырья. Для роста кристаллов PG замедляет скорость роста кристалла, но интерфейс роста более выпуклый. Таким образом, PG является эффективным средством для улучшения условий роста кристаллов SiC и оптимизации качества кристаллов.
Время публикации: 18 июня 2024 г.
