د اساسي پروسېسي سيد کرسټال وده په لوړه تودوخه کې د خامو موادو د سبلیمیشن او تجزیې، د تودوخې د تدریجي عمل لاندې د ګازي مرحلې موادو لیږد، او د تخم کرسټال کې د ګازي مرحلې موادو د بیا کرسټال کولو وده ویشل شوې ده. د دې پر بنسټ، د کروسیبل داخلي برخه په دریو برخو ویشل شوې ده: د خامو موادو ساحه، د ودې خونه او د تخم کرسټال. د اصلي مقاومت پر بنسټ د عددي سمولیشن ماډل رسم شوی.سي سيد واحد کرسټال ودې تجهیزات (شکل 1 وګورئ). په محاسبه کې: دمصلوبد اړخ هیټر له ښکته څخه 90 ملي میتر لرې دی، د کروسیبل پورته تودوخه 2100 ℃ ده، د خامو موادو ذراتو قطر 1000 μm دی، مسامیت 0.6 دی، د ودې فشار 300 Pa دی، او د ودې وخت 100 h دی. د PG ضخامت 5 ملي میتر دی، قطر یې د کروسیبل داخلي قطر سره مساوي دی، او دا د خامو موادو څخه 30 ملي میتر پورته موقعیت لري. د خامو موادو زون د سبلیمیشن، کاربونیزیشن، او بیا کریسټال کولو پروسې په محاسبه کې په پام کې نیول کیږي، او د PG او ګازو مرحلو موادو ترمنځ تعامل په پام کې نه نیول کیږي. د محاسبې پورې اړوند فزیکي ملکیت پیرامیټرې په جدول 1 کې ښودل شوي.
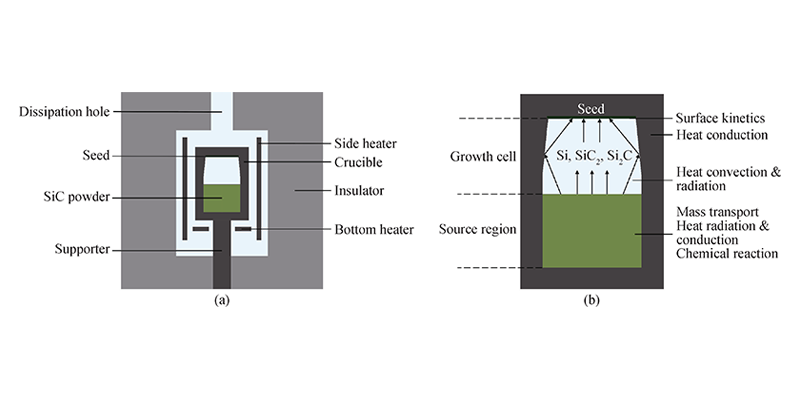
شکل ۱ د سمولیشن محاسبې ماډل. (الف) د کرسټال ودې سمولیشن لپاره د تودوخې ساحې ماډل؛ (ب) د کروسیبل داخلي ساحې ویش او اړوند فزیکي ستونزې
جدول ۱ ځینې فزیکي پیرامیټرې چې په محاسبه کې کارول کیږي

شکل ۲(a) ښیي چې د PG لرونکي جوړښت (چې د جوړښت ۱ په توګه ښودل شوی) د PG لاندې د PG-فري جوړښت (چې د جوړښت ۱ په توګه ښودل شوی) څخه لوړ دی، او د PG پورته جوړښت ۰ څخه ټیټ دی. د تودوخې ټولیز تدریجي زیاتوالی راځي، او PG د تودوخې عایق کولو اجنټ په توګه کار کوي. د شکل ۲(b) او ۲(c) له مخې، د خامو موادو په زون کې د جوړښت ۱ محوري او شعاعي تودوخې تدریجي کوچني دي، د تودوخې ویش ډیر یونیفورم دی، او د موادو لوړوالی ډیر بشپړ دی. د خامو موادو زون برعکس، شکل ۲(c) ښیي چې د جوړښت ۱ د تخم کرسټال کې د شعاعي تودوخې تدریجي لوی دی، کوم چې ممکن د تودوخې د لیږد مختلف حالتونو د مختلف تناسب له امله رامینځته شي، کوم چې کرسټال سره د محدب انٹرفیس سره وده کې مرسته کوي. په شکل ۲(d) کې، د کروسیبل په مختلفو موقعیتونو کې تودوخه د ودې پرمختګ سره مخ په زیاتیدونکي رجحان ښیې، مګر د جوړښت ۰ او جوړښت ۱ ترمنځ د تودوخې توپیر په تدریجي ډول د خامو موادو په زون کې کمیږي او په تدریجي ډول د ودې په خونه کې زیاتیږي.
 شکل ۲ د تودوخې ویش او په کروسیبل کې بدلونونه. (الف) د جوړښت ۰ (کیڼ اړخ) او جوړښت ۱ (ښي اړخ) د کروسیبل دننه د تودوخې ویش په ۰ ساعتونو کې، واحد: ℃؛ (ب) د جوړښت ۰ او جوړښت ۱ د کروسیبل په مرکزي کرښه کې د خامو موادو له ښکته څخه د تخم کرسټال ته د تودوخې ویش په ۰ ساعتونو کې؛ (ج) د مرکز څخه د کروسیبل په څنډه کې د تخم کرسټال سطح (A) او د خامو موادو سطح (B)، منځنۍ (C) او ښکته (D) په ۰ ساعتونو کې، افقي محور r د تخم کرسټال وړانګې د A لپاره، او د خامو موادو ساحې وړانګې د B~D لپاره دي؛ (د) د جوړښت ۰ او جوړښت ۱ د ودې خونې د پورتنۍ برخې (A)، خامو موادو سطحې (B) او منځنۍ (C) په مرکز کې د تودوخې بدلون په ۰ ساعتونو کې.
شکل ۲ د تودوخې ویش او په کروسیبل کې بدلونونه. (الف) د جوړښت ۰ (کیڼ اړخ) او جوړښت ۱ (ښي اړخ) د کروسیبل دننه د تودوخې ویش په ۰ ساعتونو کې، واحد: ℃؛ (ب) د جوړښت ۰ او جوړښت ۱ د کروسیبل په مرکزي کرښه کې د خامو موادو له ښکته څخه د تخم کرسټال ته د تودوخې ویش په ۰ ساعتونو کې؛ (ج) د مرکز څخه د کروسیبل په څنډه کې د تخم کرسټال سطح (A) او د خامو موادو سطح (B)، منځنۍ (C) او ښکته (D) په ۰ ساعتونو کې، افقي محور r د تخم کرسټال وړانګې د A لپاره، او د خامو موادو ساحې وړانګې د B~D لپاره دي؛ (د) د جوړښت ۰ او جوړښت ۱ د ودې خونې د پورتنۍ برخې (A)، خامو موادو سطحې (B) او منځنۍ (C) په مرکز کې د تودوخې بدلون په ۰ ساعتونو کې.
شکل ۳ د جوړښت ۰ او جوړښت ۱ په کروسیبل کې په مختلفو وختونو کې د موادو لیږد ښیي. د خامو موادو په ساحه او د ودې خونې کې د ګاز مرحلې موادو د جریان کچه د موقعیت زیاتوالي سره زیاتیږي، او د ودې پرمختګ سره د موادو لیږد کمزوری کیږي. شکل ۳ دا هم ښیي چې د سمولیشن شرایطو لاندې، خام مواد لومړی د کروسیبل په اړخ دیوال کې او بیا د کروسیبل په ښکته برخه کې ګرافیټ کیږي. سربیره پردې، د خامو موادو په سطحه بیا کریسټالیزیشن شتون لري او دا په تدریجي ډول د ودې پرمختګ سره موټی کیږي. شکل ۴(a) او ۴(b) ښیي چې د خامو موادو دننه د موادو د جریان کچه د ودې پرمختګ سره کمیږي، او په ۱۰۰ ساعتونو کې د موادو د جریان کچه د لومړنۍ شیبې شاوخوا ۵۰٪ ده؛ په هرصورت، د خامو موادو د ګرافیټ کولو له امله د جریان کچه په څنډه کې نسبتا لویه ده، او په څنډه کې د جریان کچه د منځنۍ ساحې په پرتله ۱۰ ځله زیاته ده په ۱۰۰ ساعتونو کې؛ برسېره پردې، په جوړښت ۱ کې د PG اغیز د جوړښت ۱ د خامو موادو په ساحه کې د موادو د جریان کچه د جوړښت ۱ په پرتله ټیټه کوي. په شکل ۴(c) کې، د خامو موادو په ساحه او د ودې خونې دواړو کې د موادو جریان په تدریجي ډول کمزوری کیږي ځکه چې وده پرمختګ کوي، او د خامو موادو په ساحه کې د موادو جریان کمیږي، کوم چې د کروسیبل په څنډه کې د هوا جریان چینل خلاصیدو او په پورتنۍ برخه کې د بیا کریسټال کولو خنډ له امله رامینځته کیږي؛ د ودې خونې کې، د جوړښت ۰ د موادو جریان کچه په لومړیو 30 ساعتونو کې په چټکۍ سره 16٪ ته راټیټیږي، او یوازې په راتلونکي وخت کې 3٪ کمیږي، پداسې حال کې چې جوړښت ۱ د ودې په ټوله پروسه کې نسبتا مستحکم پاتې کیږي. له همدې امله، PG د ودې خونې کې د موادو د جریان کچه ثبات کولو کې مرسته کوي. شکل ۴(d) د کرسټال ودې په مخ کې د موادو د جریان کچه پرتله کوي. په لومړۍ شیبه او ۱۰۰ ساعتونو کې، د جوړښت ۰ د ودې زون کې د موادو لیږد د جوړښت ۱ په پرتله قوي دی، مګر تل د جوړښت ۰ په څنډه کې د لوړ جریان کچه ساحه شتون لري، کوم چې په څنډه کې د ډیرې ودې لامل کیږي. په جوړښت ۱ کې د PG شتون په مؤثره توګه دا پدیده ځپي.

شکل ۳ په کروسیبل کې د موادو جریان. په مختلفو وختونو کې په 0 او 1 جوړښتونو کې د ګاز موادو لیږد ساده (کیڼ اړخ ته) او د سرعت ویکتورونه (ښي اړخ ته)، د سرعت ویکتور واحد: m/s
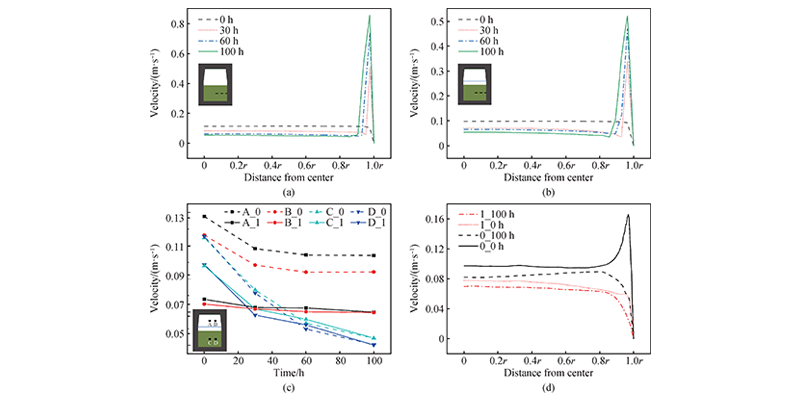
شکل ۴ د موادو د جریان په کچه کې بدلونونه. (الف) د جوړښت ۰ د خامو موادو په منځ کې د موادو د جریان په کچه ویش کې بدلونونه په ۰، ۳۰، ۶۰ او ۱۰۰ ساعتونو کې، r د خامو موادو د ساحې شعاع ده؛ (ب) د جوړښت ۱ د خامو موادو په منځ کې د موادو د جریان په کچه ویش په ۰، ۳۰، ۶۰ او ۱۰۰ ساعتونو کې، r د خامو موادو د ساحې شعاع ده؛ (ج) د ودې خونې (A، B) دننه او د جوړښت ۰ او ۱ د خامو موادو (C، D) دننه د موادو د جریان په کچه کې د وخت په تیریدو سره بدلونونه؛ (د) د جوړښت ۰ او ۱ د تخم کرسټال سطحې ته نږدې د موادو د جریان په کچه ویش په ۰ او ۱۰۰ ساعتونو کې، r د تخم کرسټال شعاع ده.
C/Si د SiC کرسټال ودې د کرسټال ثبات او عیب کثافت اغیزه کوي. شکل 5(a) په لومړي شیبه کې د دواړو جوړښتونو د C/Si تناسب ویش پرتله کوي. د C/Si تناسب په تدریجي ډول د کروسیبل له ښکته څخه تر سر پورې کمیږي، او د جوړښت 1 C/Si تناسب تل په مختلفو موقعیتونو کې د جوړښت 0 څخه لوړ وي. شکل 5(b) او 5(c) ښیي چې د C/Si تناسب په تدریجي ډول د ودې سره زیاتیږي، کوم چې د ودې په وروستي مرحله کې د داخلي تودوخې زیاتوالي، د خامو موادو ګرافیټ کولو زیاتوالي، او د ګرافیټ کروسیبل سره د ګاز مرحله کې د Si اجزاو غبرګون سره تړاو لري. په شکل 5(d) کې، د جوړښت 0 او جوړښت 1 C/Si تناسب د PG (0، 25 ملي میتر) څخه ښکته خورا توپیر لري، مګر د PG (50 ملي میتر) څخه پورته یو څه توپیر لري، او توپیر په تدریجي ډول د کرسټال ته نږدې کیدو سره زیاتیږي. په عمومي توګه، د جوړښت 1 C/Si تناسب لوړ دی، کوم چې د کرسټال بڼه ثبات کولو او د پړاو لیږد احتمال کمولو کې مرسته کوي.

شکل ۵ د C/Si تناسب ویش او بدلونونه. (a) د جوړښت 0 (کیڼ اړخ) او جوړښت 1 (ښي اړخ) په کروسیبلونو کې د C/Si تناسب ویش په 0 h کې؛ (b) د جوړښت 0 د کروسیبل د مرکزي کرښې څخه په مختلفو فاصلو کې د C/Si تناسب په مختلفو وختونو کې (0، 30، 60، 100 h)؛ (c) د جوړښت 1 د کروسیبل د مرکزي کرښې څخه په مختلفو فاصلو کې د C/Si تناسب په مختلفو وختونو کې (0، 30، 60، 100 h)؛ (d) د جوړښت 0 (جامد کرښه) او جوړښت 1 (ډشډ کرښه) د کروسیبل د مرکزي کرښې څخه په مختلفو فاصلو کې د C/Si تناسب پرتله کول په مختلفو وختونو کې (0، 30، 60، 100 h).
شکل ۶ د دوو جوړښتونو د خامو موادو د سیمو د ذراتو قطر او مسمومیت کې بدلونونه ښیي. شکل ښيي چې د خامو موادو قطر کمیږي او مسمومیت د کروسیبل دیوال ته نږدې زیاتیږي، او د څنډې مسمومیت زیاتیږي او د ذراتو قطر کمیږي لکه څنګه چې وده کوي. د څنډې اعظمي مسمومیت په 100 ساعتونو کې شاوخوا 0.99 دی، او د ذراتو لږترلږه قطر شاوخوا 300 μm دی. د خامو موادو په پورتنۍ سطحه کې د ذراتو قطر زیاتیږي او مسمومیت کمیږي، چې د بیا کریسټال کولو سره مطابقت لري. د بیا کریسټال کولو ساحې ضخامت د ودې په پرمختګ سره زیاتیږي، او د ذراتو اندازه او مسمومیت بدلون ته دوام ورکوي. د ذراتو اعظمي قطر له 1500 μm څخه ډیر ته رسیږي، او لږترلږه مسمومیت 0.13 دی. سربیره پردې، څرنګه چې PG د خامو موادو ساحې تودوخه زیاتوي او د ګاز سوپر سیچوریشن کوچنی دی، د جوړښت 1 د خامو موادو د پورتنۍ برخې د بیا کریسټال کولو ضخامت کوچنی دی، کوم چې د خامو موادو د کارولو کچه ښه کوي.
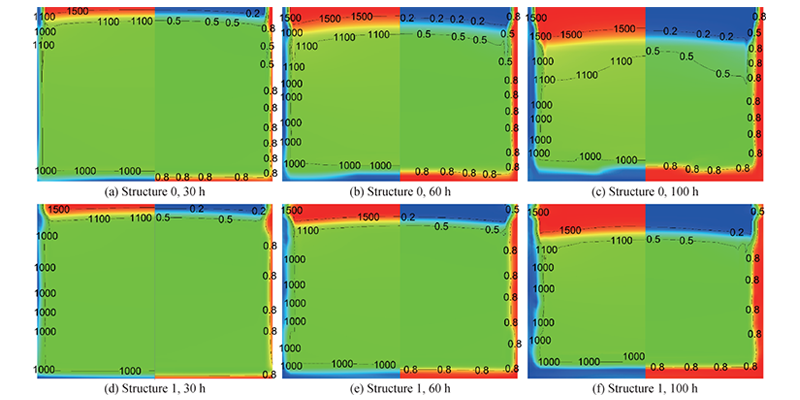 شکل ۶ د جوړښت ۰ او جوړښت ۱ د خامو موادو ساحې د ذراتو قطر (کیڼ اړخ) او پورسیت (ښي اړخ) کې په مختلفو وختونو کې بدلونونه، د ذراتو قطر واحد: μm
شکل ۶ د جوړښت ۰ او جوړښت ۱ د خامو موادو ساحې د ذراتو قطر (کیڼ اړخ) او پورسیت (ښي اړخ) کې په مختلفو وختونو کې بدلونونه، د ذراتو قطر واحد: μm
شکل ۷ ښیي چې جوړښت ۰ د ودې په پیل کې وارپ کوي، کوم چې ممکن د خامو موادو د څنډې د ګرافیټ کولو له امله د موادو د ډیر جریان نرخ سره تړاو ولري. د وارپ کولو کچه د وروسته ودې پروسې په جریان کې کمزورې کیږي، کوم چې د جوړښت ۰ د کرسټال ودې په مخ کې د موادو د جریان نرخ کې بدلون سره مطابقت لري په شکل ۴ (d) کې. په جوړښت ۱ کې، د PG اغیزې له امله، د کرسټال انٹرفیس وارپ کول نه ښیې. سربیره پردې، PG د جوړښت ۱ د ودې کچه د جوړښت ۰ په پرتله د پام وړ ټیټه کوي. د جوړښت ۱ د کرسټال د مرکز ضخامت د ۱۰۰ ساعتونو وروسته د جوړښت ۱ د جوړښت ۰ یوازې ۶۸٪ دی.
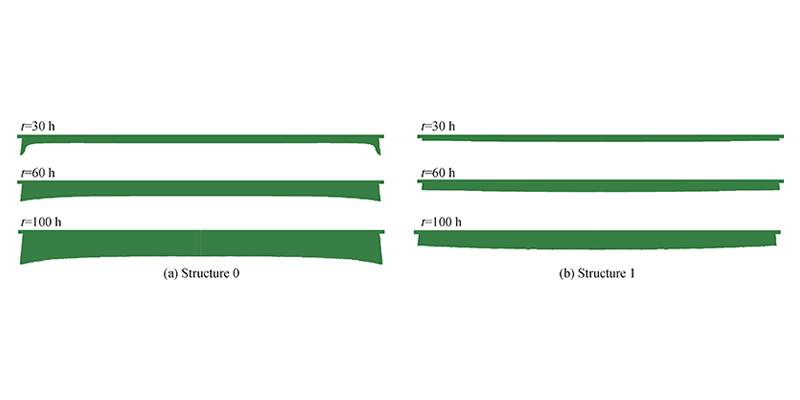
شکل ۷ د جوړښت ۰ او جوړښت ۱ کرسټالونو د انٹرفیس بدلونونه په ۳۰، ۶۰، او ۱۰۰ ساعتونو کې
د کرسټال وده د عددي سمولیشن د پروسې شرایطو لاندې ترسره شوه. هغه کرسټالونه چې د جوړښت 0 او جوړښت 1 لخوا کرل شوي په ترتیب سره په شکل 8(a) او شکل 8(b) کې ښودل شوي دي. د جوړښت 0 کرسټال یو مقعر انٹرفیس ښیې، په مرکزي ساحه کې د انډولیشنونو او په څنډه کې د مرحلې لیږد سره. د سطحې محدب د ګاز مرحلې موادو په لیږد کې د غیر همجنسۍ یو ټاکلی درجې استازیتوب کوي، او د مرحلې لیږد واقع کیدل د C/Si ټیټ تناسب سره مطابقت لري. د جوړښت 1 لخوا کرل شوي کرسټال انٹرفیس یو څه محدب دی، د مرحلې لیږد نه موندل کیږي، او ضخامت د PG پرته د کرسټال 65٪ دی. په عموم کې، د کرسټال ودې پایلې د سمولیشن پایلو سره مطابقت لري، د جوړښت 1 د کرسټال انٹرفیس کې د لوی شعاعي تودوخې توپیر سره، په څنډه کې چټک وده فشارول کیږي، او د موادو د جریان ټولیز کچه ورو ده. ټولیز رجحان د عددي سمولیشن پایلو سره مطابقت لري.
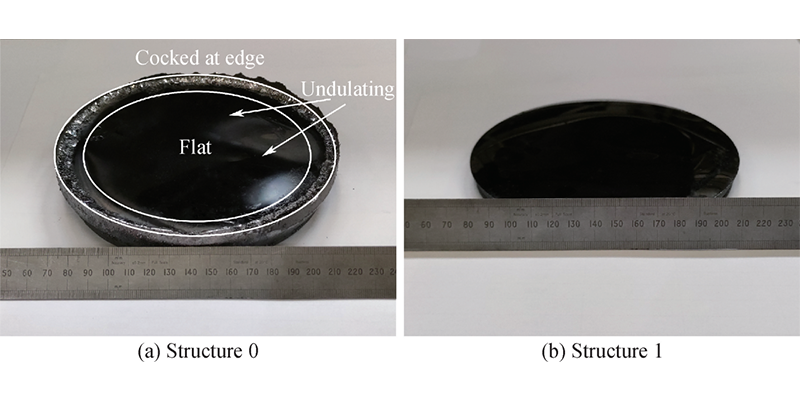
شکل ۸ د SiC کرسټالونه چې د جوړښت ۰ او جوړښت ۱ لاندې کرل شوي دي
پایله
PG د خامو موادو د ساحې د ټولیز تودوخې د ښه والي او د محوري او شعاعي تودوخې د یووالي د ښه والي لپاره ګټور دی، د خامو موادو بشپړ لوړوالی او کارول هڅوي؛ د پورته او ښکته تودوخې توپیر زیاتیږي، او د تخم کرسټال سطحې شعاعي تدریجي زیاتوالی راځي، کوم چې د محدب انٹرفیس ودې ساتلو کې مرسته کوي. د ډله ایز لیږد په شرایطو کې، د PG معرفي کول د ټولیز ډله ایز لیږد کچه کموي، د ودې په خونه کې د موادو جریان کچه چې PG لري د وخت سره لږ بدلون مومي، او د ودې ټوله پروسه ډیره باثباته ده. په ورته وخت کې، PG په مؤثره توګه د ډیر څنډې ډله ایز لیږد پیښې مخه هم نیسي. سربیره پردې، PG د ودې چاپیریال C/Si تناسب هم زیاتوي، په ځانګړې توګه د تخم کرسټال انٹرفیس په مخکینۍ څنډه کې، کوم چې د ودې پروسې په جریان کې د مرحلې بدلون پیښې کمولو کې مرسته کوي. په ورته وخت کې، د PG د تودوخې موصلیت اغیز د خامو موادو په پورتنۍ برخه کې د بیا کریسټال کولو پیښې تر یوې اندازې پورې کموي. د کرسټال ودې لپاره، PG د کرسټال ودې کچه ورو کوي، مګر د ودې انٹرفیس ډیر محدب دی. له همدې امله، PG د SiC کرسټالونو د ودې چاپیریال ښه کولو او د کرسټال کیفیت غوره کولو لپاره یوه مؤثره وسیله ده.
د پوسټ وخت: جون-۱۸-۲۰۲۴
