ძირითადი პროცესიSiCკრისტალის ზრდა დაყოფილია ნედლეულის სუბლიმაციასა და დაშლაზე მაღალ ტემპერატურაზე, აირადი ფაზის ნივთიერებების ტრანსპორტირებაზე ტემპერატურის გრადიენტის ზემოქმედებით და აირადი ფაზის ნივთიერებების რეკრისტალიზაციის ზრდაზე სათესლე კრისტალზე. ამის საფუძველზე, ტიგანის ინტერიერი დაყოფილია სამ ნაწილად: ნედლეულის არე, ზრდის კამერა და სათესლე კრისტალი. რიცხვითი სიმულაციის მოდელი შედგენილია რეალური რეზისტენტული კრისტალის საფუძველზე.SiCერთკრისტალის ზრდის მოწყობილობა (იხ. სურათი 1). გაანგარიშებისას: ქვედა ნაწილიტილოგვერდითი გამათბობლის ფსკერიდან 90 მმ-ით არის დაშორებული, ტიგანის ზედა ტემპერატურაა 2100 ℃, ნედლეულის ნაწილაკების დიამეტრია 1000 μm, ფორიანობაა 0.6, ზრდის წნევაა 300 Pa, ხოლო ზრდის დროა 100 საათი. PG სისქეა 5 მმ, დიამეტრი ტოლია ტიგანის შიდა დიამეტრისა და მდებარეობს ნედლეულიდან 30 მმ-ით ზემოთ. გაანგარიშებაში გათვალისწინებულია ნედლეულის ზონის სუბლიმაციის, კარბონიზაციის და რეკრისტალიზაციის პროცესები, ხოლო PG-სა და აირადისებრ ნივთიერებებს შორის რეაქცია არ არის გათვალისწინებული. გაანგარიშებასთან დაკავშირებული ფიზიკური თვისებების პარამეტრები ნაჩვენებია ცხრილში 1.
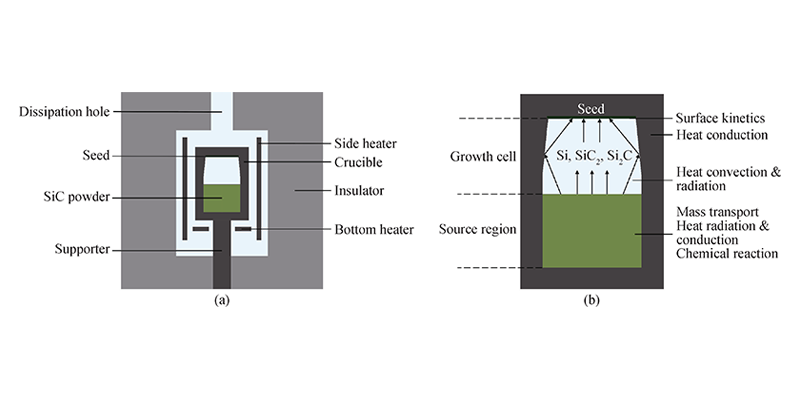
სურათი 1. სიმულაციური გაანგარიშების მოდელი. (ა) კრისტალის ზრდის სიმულაციის თერმული ველის მოდელი; (ბ) ტიგანის შიდა ფართობის გაყოფა და მასთან დაკავშირებული ფიზიკური პრობლემები
ცხრილი 1. გაანგარიშებაში გამოყენებული ზოგიერთი ფიზიკური პარამეტრი

სურათი 2(ა) გვიჩვენებს, რომ PG-შემცველი სტრუქტურის (აღნიშნულია, როგორც სტრუქტურა 1) ტემპერატურა უფრო მაღალია, ვიდრე PG-სგან თავისუფალი სტრუქტურის (აღნიშნულია, როგორც სტრუქტურა 0) ტემპერატურა PG-ზე ქვემოთ და უფრო დაბალი, ვიდრე სტრუქტურის 0 ტემპერატურა PG-ზე ზემოთ. საერთო ტემპერატურის გრადიენტი იზრდება და PG მოქმედებს როგორც თბოიზოლაციის აგენტი. სურათები 2(ბ) და 2(გ)-ის მიხედვით, სტრუქტურა 1-ის ღერძული და რადიალური ტემპერატურის გრადიენტები ნედლეულის ზონაში უფრო მცირეა, ტემპერატურის განაწილება უფრო ერთგვაროვანია და მასალის სუბლიმაცია უფრო სრულყოფილია. ნედლეულის ზონისგან განსხვავებით, სურათი 2(გ) გვიჩვენებს, რომ სტრუქტურა 1-ის სათესლე კრისტალზე რადიალური ტემპერატურის გრადიენტი უფრო დიდია, რაც შეიძლება გამოწვეული იყოს სხვადასხვა სითბოს გადაცემის რეჟიმების განსხვავებული პროპორციებით, რაც ხელს უწყობს კრისტალის ზრდას ამოზნექილი ინტერფეისით. სურათი 2(დ)-ზე, ტემპერატურა ტიგანში სხვადასხვა პოზიციაზე ზრდის ტენდენციას აჩვენებს, მაგრამ სტრუქტურა 0-სა და სტრუქტურა 1-ს შორის ტემპერატურის სხვაობა თანდათან მცირდება ნედლეულის ზონაში და თანდათან იზრდება ზრდის კამერაში.
 სურათი 2. ტემპერატურის განაწილება და ცვლილებები ტიგანში. (ა) ტემპერატურის განაწილება სტრუქტურის 0 (მარცხნივ) და სტრუქტურა 1 (მარჯვნივ) ტიგანში 0 სთ-ზე, ერთეული: ℃; (ბ) ტემპერატურის განაწილება სტრუქტურის 0 და სტრუქტურა 1 ტიგანის ცენტრალურ ხაზზე ნედლეულის ფსკერიდან თესლის კრისტალამდე 0 სთ-ზე; (გ) ტემპერატურის განაწილება ცენტრიდან ტიგანის კიდემდე თესლის კრისტალის ზედაპირზე (A) და ნედლეულის ზედაპირზე (B), შუაში (C) და ფსკერზე (D) 0 სთ-ზე, ჰორიზონტალური ღერძი r არის თესლის კრისტალის რადიუსი A-სთვის, ხოლო ნედლეულის ფართობის რადიუსი B~D-სთვის; (დ) ტემპერატურის ცვლილებები სტრუქტურის 0 და სტრუქტურა 1-ის ზრდის კამერის ზედა ნაწილის (A), ნედლეულის ზედაპირის (B) და შუაში (C) 0, 30, 60 და 100 სთ-ზე.
სურათი 2. ტემპერატურის განაწილება და ცვლილებები ტიგანში. (ა) ტემპერატურის განაწილება სტრუქტურის 0 (მარცხნივ) და სტრუქტურა 1 (მარჯვნივ) ტიგანში 0 სთ-ზე, ერთეული: ℃; (ბ) ტემპერატურის განაწილება სტრუქტურის 0 და სტრუქტურა 1 ტიგანის ცენტრალურ ხაზზე ნედლეულის ფსკერიდან თესლის კრისტალამდე 0 სთ-ზე; (გ) ტემპერატურის განაწილება ცენტრიდან ტიგანის კიდემდე თესლის კრისტალის ზედაპირზე (A) და ნედლეულის ზედაპირზე (B), შუაში (C) და ფსკერზე (D) 0 სთ-ზე, ჰორიზონტალური ღერძი r არის თესლის კრისტალის რადიუსი A-სთვის, ხოლო ნედლეულის ფართობის რადიუსი B~D-სთვის; (დ) ტემპერატურის ცვლილებები სტრუქტურის 0 და სტრუქტურა 1-ის ზრდის კამერის ზედა ნაწილის (A), ნედლეულის ზედაპირის (B) და შუაში (C) 0, 30, 60 და 100 სთ-ზე.
სურათი 3 გვიჩვენებს მასალის ტრანსპორტირებას სხვადასხვა დროს სტრუქტურის 0 და სტრუქტურის 1 ტიტანის ქვაბში. ნედლეულის არეალსა და ზრდის კამერაში აირადი ფაზის მასალის ნაკადის სიჩქარე იზრდება პოზიციის ზრდასთან ერთად და მასალის ტრანსპორტირება სუსტდება ზრდის პროგრესირებასთან ერთად. სურათი 3 ასევე აჩვენებს, რომ სიმულაციის პირობებში, ნედლეული ჯერ გრაფიტირდება ტიტანის გვერდით კედელზე, შემდეგ კი ტიტანის ფსკერზე. გარდა ამისა, ნედლეულის ზედაპირზე ხდება რეკრისტალიზაცია და ის თანდათან სქელდება ზრდის პროგრესირებასთან ერთად. სურათები 4(ა) და 4(ბ) აჩვენებს, რომ ნედლეულის შიგნით მასალის ნაკადის სიჩქარე მცირდება ზრდის პროგრესირებასთან ერთად და მასალის ნაკადის სიჩქარე 100 საათის შემდეგ საწყისი მომენტის დაახლოებით 50%-ია; თუმცა, ნაკადის სიჩქარე კიდეზე შედარებით დიდია ნედლეულის გრაფიტიზაციის გამო და ნაკადის სიჩქარე კიდეზე 10-ჯერ მეტია, ვიდრე ნაკადის სიჩქარე შუა არეალში 100 საათის შემდეგ; გარდა ამისა, სტრუქტურა 1-ში PG-ს გავლენა სტრუქტურა 1-ის ნედლეულის არეში მასალის ნაკადის სიჩქარეს სტრუქტურა 0-ის სიჩქარესთან შედარებით ამცირებს. ნახაზ 4(გ)-ზე, მასალის ნაკადი როგორც ნედლეულის არეში, ასევე ზრდის კამერაში თანდათან სუსტდება ზრდის პროგრესირებასთან ერთად და ნედლეულის არეში მასალის ნაკადი აგრძელებს შემცირებას, რაც გამოწვეულია ტიგანის კიდეზე ჰაერის ნაკადის არხის გახსნით და ზედა ნაწილში რეკრისტალიზაციის დაბრკოლებით; ზრდის კამერაში, სტრუქტურა 0-ის მასალის ნაკადის სიჩქარე სწრაფად მცირდება საწყისი 30 საათის განმავლობაში 16%-მდე და შემდგომში მხოლოდ 3%-ით მცირდება, ხოლო სტრუქტურა 1 ზრდის პროცესის განმავლობაში შედარებით სტაბილური რჩება. ამრიგად, PG ხელს უწყობს მასალის ნაკადის სიჩქარის სტაბილიზაციას ზრდის კამერაში. სურათი 4(დ) ადარებს მასალის ნაკადის სიჩქარეს კრისტალის ზრდის ფრონტზე. საწყის მომენტში და 100 საათში, სტრუქტურა 0-ის ზრდის ზონაში მასალის ტრანსპორტი უფრო ძლიერია, ვიდრე სტრუქტურა 1-ში, მაგრამ სტრუქტურა 0-ის კიდეზე ყოველთვის არის მაღალი ნაკადის სიჩქარის არე, რაც იწვევს კიდეზე ჭარბ ზრდას. PG-ის არსებობა სტრუქტურა 1-ში ეფექტურად თრგუნავს ამ ფენომენს.

სურათი 3. მასალის ნაკადი ტიგანში. აიროვანი მასალის ტრანსპორტირების დინების ხაზები (მარცხნივ) და სიჩქარის ვექტორები (მარჯვნივ) 0 და 1 სტრუქტურებში სხვადასხვა დროს, სიჩქარის ვექტორის ერთეული: მ/წმ.
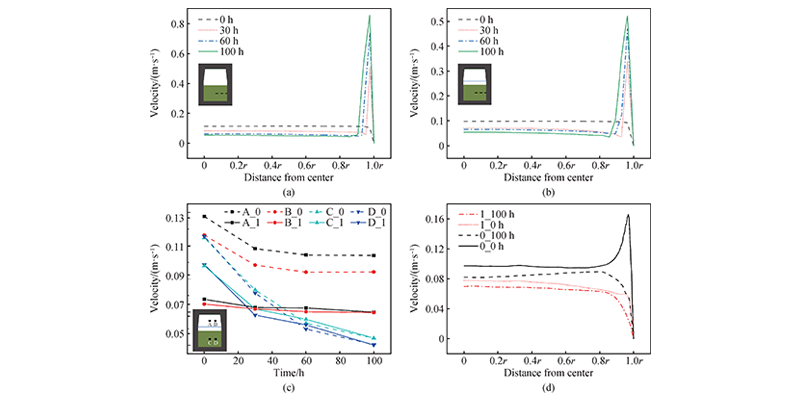
სურათი 4. მასალის ნაკადის სიჩქარის ცვლილებები. (ა) მასალის ნაკადის სიჩქარის განაწილების ცვლილებები სტრუქტურის 0 ნედლეულის შუაში 0, 30, 60 და 100 სთ-ზე, r არის ნედლეულის ფართობის რადიუსი; (ბ) მასალის ნაკადის სიჩქარის განაწილების ცვლილებები სტრუქტურის 1 ნედლეულის შუაში 0, 30, 60 და 100 სთ-ზე, r არის ნედლეულის ფართობის რადიუსი; (გ) მასალის ნაკადის სიჩქარის ცვლილებები 0 და 1 სტრუქტურების ზრდის კამერის (A, B) და ნედლეულის (C, D) შიგნით დროთა განმავლობაში; (დ) მასალის ნაკადის სიჩქარის განაწილება 0 და 1 სტრუქტურების სათესლე კრისტალის ზედაპირთან ახლოს 0 და 100 სთ-ზე, r არის სათესლე კრისტალის რადიუსი
C/Si გავლენას ახდენს SiC კრისტალის ზრდის კრისტალურ სტაბილურობასა და დეფექტების სიმკვრივეზე. სურათი 5(ა) ადარებს ორი სტრუქტურის C/Si თანაფარდობის განაწილებას საწყის მომენტში. C/Si თანაფარდობა თანდათან მცირდება ტიგანის ქვემოდან ზედა მიმართულებით და სტრუქტურა 1-ის C/Si თანაფარდობა ყოველთვის უფრო მაღალია, ვიდრე სტრუქტურა 0-ის თანაფარდობა სხვადასხვა პოზიციაზე. სურათები 5(ბ) და 5(გ) აჩვენებს, რომ C/Si თანაფარდობა თანდათან იზრდება ზრდასთან ერთად, რაც დაკავშირებულია ზრდის გვიანდელ ეტაპზე შიდა ტემპერატურის მატებასთან, ნედლეულის გრაფიტიზაციის გაძლიერებასთან და Si კომპონენტების რეაქციასთან აირისებრ ფაზაში გრაფიტის ტიგანთან. სურათი 5(დ)-ზე, სტრუქტურა 0-ის და სტრუქტურა 1-ის C/Si თანაფარდობები საკმაოდ განსხვავებულია PG-ს ქვემოთ (0, 25 მმ), მაგრამ ოდნავ განსხვავებულია PG-ს ზემოთ (50 მმ) და სხვაობა თანდათან იზრდება კრისტალის მიახლოებისას. ზოგადად, სტრუქტურა 1-ის C/Si თანაფარდობა უფრო მაღალია, რაც ხელს უწყობს კრისტალური ფორმის სტაბილიზაციას და ფაზური გადასვლის ალბათობის შემცირებას.

სურათი 5. C/Si თანაფარდობის განაწილება და ცვლილებები. (ა) C/Si თანაფარდობის განაწილება სტრუქტურის 0 (მარცხნივ) და სტრუქტურა 1 (მარჯვნივ) ტიგანებში 0 სთ-ზე; (ბ) C/Si თანაფარდობა სტრუქტურის 0 ტიგანის ცენტრალური ხაზიდან სხვადასხვა მანძილზე სხვადასხვა დროს (0, 30, 60, 100 სთ); (გ) C/Si თანაფარდობა სტრუქტურის 1 ტიგანის ცენტრალური ხაზიდან სხვადასხვა მანძილზე სხვადასხვა დროს (0, 30, 60, 100 სთ); (დ) C/Si თანაფარდობის შედარება სხვადასხვა მანძილზე (0, 25, 50, 75, 100 მმ) სტრუქტურის 0 ტიგანის ცენტრალური ხაზიდან (მყარი ხაზი) და სტრუქტურა 1-ის (წყვეტილი ხაზი) სხვადასხვა დროს (0, 30, 60, 100 სთ).
სურათი 6 გვიჩვენებს ორი სტრუქტურის ნედლეულის რეგიონების ნაწილაკების დიამეტრისა და ფორიანობის ცვლილებებს. სურათი გვიჩვენებს, რომ ნედლეულის დიამეტრი მცირდება და ფორიანობა იზრდება ტიგანის კედელთან ახლოს, ხოლო კიდის ფორიანობა აგრძელებს ზრდას და ნაწილაკების დიამეტრის შემცირებას ზრდის პროგრესირებასთან ერთად. კიდის მაქსიმალური ფორიანობა დაახლოებით 0.99-ია 100 საათში, ხოლო მინიმალური ნაწილაკების დიამეტრი დაახლოებით 300 მკმ. ნაწილაკების დიამეტრი იზრდება და ფორიანობა მცირდება ნედლეულის ზედა ზედაპირზე, რაც შეესაბამება რეკრისტალიზაციას. რეკრისტალიზაციის არეალის სისქე იზრდება ზრდის პროგრესირებასთან ერთად და ნაწილაკების ზომა და ფორიანობა აგრძელებენ ცვლილებას. ნაწილაკების მაქსიმალური დიამეტრი აღწევს 1500 მკმ-ზე მეტს, ხოლო მინიმალური ფორიანობა 0.13-ია. გარდა ამისა, რადგან PG ზრდის ნედლეულის არეალის ტემპერატურას და გაზის ზეგაჯერება მცირეა, სტრუქტურა 1-ის ნედლეულის ზედა ნაწილის რეკრისტალიზაციის სისქე მცირეა, რაც აუმჯობესებს ნედლეულის გამოყენების მაჩვენებელს.
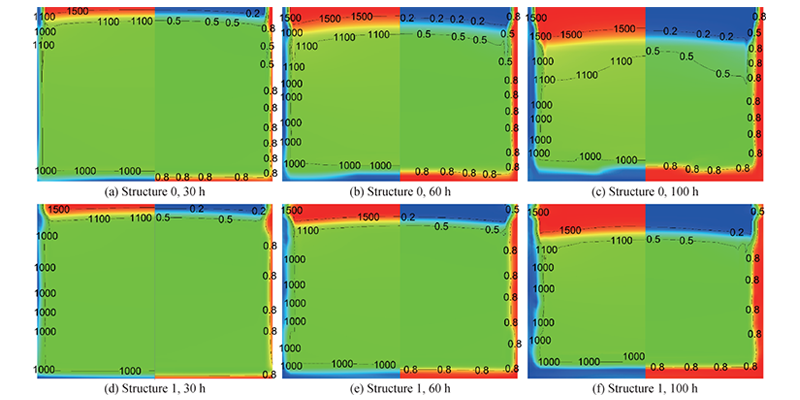 სურათი 6. სტრუქტურა 0-ისა და სტრუქტურა 1-ის ნედლეულის ფართობის ნაწილაკების დიამეტრის (მარცხნივ) და ფორიანობის (მარჯვნივ) ცვლილებები სხვადასხვა დროს, ნაწილაკების დიამეტრის ერთეული: μm
სურათი 6. სტრუქტურა 0-ისა და სტრუქტურა 1-ის ნედლეულის ფართობის ნაწილაკების დიამეტრის (მარცხნივ) და ფორიანობის (მარჯვნივ) ცვლილებები სხვადასხვა დროს, ნაწილაკების დიამეტრის ერთეული: μm
სურათი 7 გვიჩვენებს, რომ სტრუქტურა 0 დეფორმირდება ზრდის დასაწყისში, რაც შეიძლება დაკავშირებული იყოს ნედლეულის კიდის გრაფიტიზაციით გამოწვეულ მასალის ნაკადის სიჩქარესთან. დეფორმაციის ხარისხი სუსტდება შემდგომი ზრდის პროცესის დროს, რაც შეესაბამება მასალის ნაკადის სიჩქარის ცვლილებას სტრუქტურა 0-ის კრისტალის ზრდის წინა ნაწილში, ნახაზ 4 (დ)-ზე. სტრუქტურა 1-ში, PG-ის ეფექტის გამო, კრისტალის ინტერფეისი არ ავლენს დეფორმაციას. გარდა ამისა, PG ასევე მნიშვნელოვნად ამცირებს სტრუქტურა 1-ის ზრდის ტემპს სტრუქტურა 0-ის ზრდის ტემპთან შედარებით. სტრუქტურა 1-ის კრისტალის ცენტრალური სისქე 100 საათის შემდეგ სტრუქტურა 0-ის ზრდის ტემპის მხოლოდ 68%-ია.
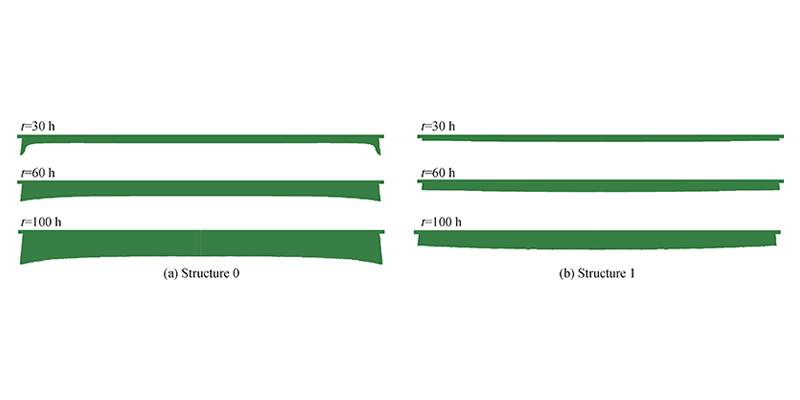
სურათი 7. სტრუქტურა 0-ისა და სტრუქტურა 1-ის კრისტალების ინტერფეისის ცვლილებები 30, 60 და 100 საათში
კრისტალის ზრდა რიცხვითი სიმულაციის პროცესის პირობებში განხორციელდა. სტრუქტურით 0 და სტრუქტურით გაზრდილ კრისტალებს, შესაბამისად, ნახაზი 8(ა) და ნახაზი 8(ბ) აჩვენებს. სტრუქტურით 0 კრისტალს აქვს ჩაზნექილი ზედაპირი, ცენტრალურ არეში ტალღოვანი და კიდეზე ფაზური გადასვლა. ზედაპირის ამოზნექილი წარმოადგენს გაზის ფაზის მასალების ტრანსპორტირების გარკვეულ ხარისხს არაერთგვაროვნებით, ხოლო ფაზური გადასვლის არსებობა შეესაბამება C/Si დაბალ თანაფარდობას. სტრუქტურა 1-ით გაზრდილ კრისტალის ზედაპირი ოდნავ ამოზნექილია, ფაზური გადასვლა არ დაფიქსირებულა და სისქე PG-ს გარეშე კრისტალის 65%-ია. ზოგადად, კრისტალის ზრდის შედეგები შეესაბამება სიმულაციის შედეგებს, სტრუქტურა 1-ის კრისტალურ საზღვარზე რადიალური ტემპერატურის უფრო დიდი სხვაობით, კიდეზე სწრაფი ზრდა დათრგუნულია და მასალის საერთო ნაკადის სიჩქარე უფრო ნელია. საერთო ტენდენცია შეესაბამება რიცხვითი სიმულაციის შედეგებს.
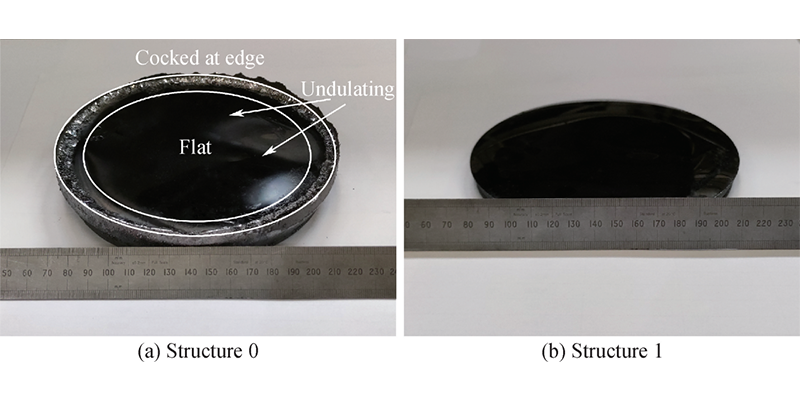
სურათი 8. SiC კრისტალები, რომლებიც გაზრდილია სტრუქტურით 0 და სტრუქტურით 1
დასკვნა
PG ხელს უწყობს ნედლეულის არეალის საერთო ტემპერატურის გაუმჯობესებას და ღერძული და რადიალური ტემპერატურის ერთგვაროვნების გაუმჯობესებას, რაც ხელს უწყობს ნედლეულის სრულ სუბლიმაციას და გამოყენებას; იზრდება ზედა და ქვედა ტემპერატურული სხვაობა და იზრდება თესლის კრისტალის ზედაპირის რადიალური გრადიენტი, რაც ხელს უწყობს ამოზნექილი ინტერფეისის ზრდის შენარჩუნებას. მასის გადაცემის თვალსაზრისით, PG-ის შეყვანა ამცირებს მასის გადაცემის საერთო სიჩქარეს, PG-ს შემცველ ზრდის კამერაში მასალის ნაკადის სიჩქარე დროთა განმავლობაში ნაკლებად იცვლება და მთელი ზრდის პროცესი უფრო სტაბილურია. ამავდროულად, PG ასევე ეფექტურად აფერხებს კიდის მასის ჭარბი გადაცემის წარმოქმნას. გარდა ამისა, PG ასევე ზრდის ზრდის გარემოს C/Si თანაფარდობას, განსაკუთრებით თესლის კრისტალის ინტერფეისის წინა კიდეზე, რაც ხელს უწყობს ფაზის ცვლილების შემთხვევების შემცირებას ზრდის პროცესში. ამავდროულად, PG-ის თბოიზოლაციის ეფექტი გარკვეულწილად ამცირებს ნედლეულის ზედა ნაწილში რეკრისტალიზაციის შემთხვევებს. კრისტალის ზრდისთვის, PG ანელებს კრისტალის ზრდის ტემპს, მაგრამ ზრდის ინტერფეისი უფრო ამოზნექილია. ამგვარად, PG წარმოადგენს ეფექტურ საშუალებას SiC კრისტალების ზრდის გარემოს გასაუმჯობესებლად და კრისტალების ხარისხის ოპტიმიზაციისთვის.
გამოქვეყნების დრო: 2024 წლის 18 ივნისი
