ప్రాథమిక ప్రక్రియసిఐసిస్ఫటిక పెరుగుదలను అధిక ఉష్ణోగ్రత వద్ద ముడి పదార్థాల సబ్లిమేషన్ మరియు కుళ్ళిపోవడం, ఉష్ణోగ్రత ప్రవణత చర్యలో గ్యాస్ దశ పదార్థాల రవాణా మరియు సీడ్ క్రిస్టల్ వద్ద గ్యాస్ దశ పదార్థాల పునఃస్ఫటికీకరణ పెరుగుదలగా విభజించారు. దీని ఆధారంగా, క్రూసిబుల్ లోపలి భాగాన్ని మూడు భాగాలుగా విభజించారు: ముడి పదార్థ ప్రాంతం, పెరుగుదల గది మరియు సీడ్ క్రిస్టల్. వాస్తవ రెసిస్టివ్ ఆధారంగా సంఖ్యా అనుకరణ నమూనాను రూపొందించారు.సిఐసిసింగిల్ క్రిస్టల్ గ్రోత్ పరికరాలు (చిత్రం 1 చూడండి). గణనలో: దిగువనక్రూసిబుల్సైడ్ హీటర్ దిగువ నుండి 90 మిమీ దూరంలో ఉంది, క్రూసిబుల్ యొక్క పై ఉష్ణోగ్రత 2100 ℃, ముడి పదార్థ కణ వ్యాసం 1000 μm, సచ్ఛిద్రత 0.6, వృద్ధి పీడనం 300 Pa, మరియు వృద్ధి సమయం 100 h. PG మందం 5 మిమీ, వ్యాసం క్రూసిబుల్ లోపలి వ్యాసానికి సమానం మరియు ఇది ముడి పదార్థం కంటే 30 మిమీ పైన ఉంది. గణనలో ముడి పదార్థ జోన్ యొక్క సబ్లిమేషన్, కార్బొనైజేషన్ మరియు రీక్రిస్టలైజేషన్ ప్రక్రియలు పరిగణించబడతాయి మరియు PG మరియు గ్యాస్ దశ పదార్థాల మధ్య ప్రతిచర్య పరిగణించబడదు. గణన-సంబంధిత భౌతిక ఆస్తి పారామితులు టేబుల్ 1లో చూపబడ్డాయి.
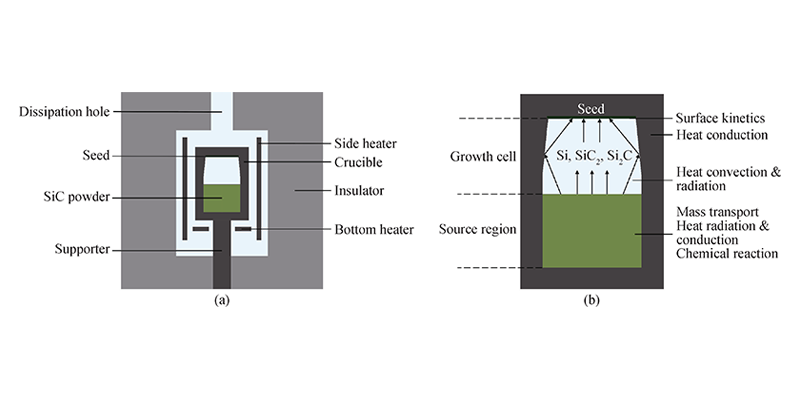
చిత్రం 1 అనుకరణ గణన నమూనా. (ఎ) క్రిస్టల్ పెరుగుదల అనుకరణ కోసం ఉష్ణ క్షేత్ర నమూనా; (బి) క్రూసిబుల్ యొక్క అంతర్గత ప్రాంతం యొక్క విభజన మరియు సంబంధిత భౌతిక సమస్యలు
పట్టిక 1 గణనలో ఉపయోగించిన కొన్ని భౌతిక పారామితులు

PG-కలిగిన నిర్మాణం (స్ట్రక్చర్ 1 గా సూచించబడింది) యొక్క ఉష్ణోగ్రత PG క్రింద ఉన్న PG-రహిత నిర్మాణం (స్ట్రక్చర్ 0 గా సూచించబడింది) కంటే ఎక్కువగా ఉందని మరియు PG పైన ఉన్న నిర్మాణం 0 కంటే తక్కువగా ఉందని చిత్రం 2(a) చూపిస్తుంది. మొత్తం ఉష్ణోగ్రత ప్రవణత పెరుగుతుంది మరియు PG వేడి-ఇన్సులేటింగ్ ఏజెంట్గా పనిచేస్తుంది. గణాంకాలు 2(b) మరియు 2(c) ప్రకారం, ముడి పదార్థ మండలంలో నిర్మాణం 1 యొక్క అక్షసంబంధ మరియు రేడియల్ ఉష్ణోగ్రత ప్రవణతలు చిన్నవిగా ఉంటాయి, ఉష్ణోగ్రత పంపిణీ మరింత ఏకరీతిగా ఉంటుంది మరియు పదార్థం యొక్క సబ్లిమేషన్ మరింత పూర్తి అవుతుంది. ముడి పదార్థ మండలం వలె కాకుండా, చిత్రం 2(c) నిర్మాణం 1 యొక్క సీడ్ క్రిస్టల్ వద్ద రేడియల్ ఉష్ణోగ్రత ప్రవణత పెద్దదిగా ఉందని చూపిస్తుంది, ఇది వేర్వేరు ఉష్ణ బదిలీ మోడ్ల యొక్క విభిన్న నిష్పత్తుల వల్ల సంభవించవచ్చు, ఇది క్రిస్టల్ కుంభాకార ఇంటర్ఫేస్తో పెరగడానికి సహాయపడుతుంది. చిత్రం 2(d)లో, క్రూసిబుల్లోని వివిధ స్థానాల్లో ఉష్ణోగ్రత పెరుగుదల పెరుగుతున్న కొద్దీ పెరుగుతున్న ధోరణిని చూపుతుంది, అయితే నిర్మాణం 0 మరియు నిర్మాణం 1 మధ్య ఉష్ణోగ్రత వ్యత్యాసం ముడి పదార్థ మండలంలో క్రమంగా తగ్గుతుంది మరియు వృద్ధి గదిలో క్రమంగా పెరుగుతుంది.
 చిత్రం 2 క్రూసిబుల్లో ఉష్ణోగ్రత పంపిణీ మరియు మార్పులు. (ఎ) 0 గం వద్ద నిర్మాణం 0 (ఎడమ) మరియు నిర్మాణం 1 (కుడి) యొక్క క్రూసిబుల్ లోపల ఉష్ణోగ్రత పంపిణీ, యూనిట్: ℃; (బి) ముడి పదార్థం దిగువ నుండి విత్తన స్ఫటికానికి నిర్మాణం 0 మరియు నిర్మాణం 1 యొక్క క్రూసిబుల్ మధ్య రేఖపై ఉష్ణోగ్రత పంపిణీ 0 గం వద్ద; (సి) విత్తన స్ఫటిక ఉపరితలం (A) మరియు ముడి పదార్థం ఉపరితలం (B), మధ్య (C) మరియు దిగువ (D) పై మధ్య నుండి క్రూసిబుల్ అంచు వరకు ఉష్ణోగ్రత పంపిణీ 0 గం వద్ద, క్షితిజ సమాంతర అక్షం r అనేది A కోసం విత్తన స్ఫటిక వ్యాసార్థం మరియు B~D కోసం ముడి పదార్థం వైశాల్య వ్యాసార్థం; (డి) నిర్మాణం 0 మరియు నిర్మాణం 1 యొక్క పెరుగుదల గది యొక్క ఎగువ భాగం (A), ముడి పదార్థం ఉపరితలం (B) మరియు మధ్య (C) మధ్యలో ఉష్ణోగ్రత మార్పులు 0, 30, 60, మరియు 100 గం వద్ద నిర్మాణం 1 మరియు నిర్మాణం 1.
చిత్రం 2 క్రూసిబుల్లో ఉష్ణోగ్రత పంపిణీ మరియు మార్పులు. (ఎ) 0 గం వద్ద నిర్మాణం 0 (ఎడమ) మరియు నిర్మాణం 1 (కుడి) యొక్క క్రూసిబుల్ లోపల ఉష్ణోగ్రత పంపిణీ, యూనిట్: ℃; (బి) ముడి పదార్థం దిగువ నుండి విత్తన స్ఫటికానికి నిర్మాణం 0 మరియు నిర్మాణం 1 యొక్క క్రూసిబుల్ మధ్య రేఖపై ఉష్ణోగ్రత పంపిణీ 0 గం వద్ద; (సి) విత్తన స్ఫటిక ఉపరితలం (A) మరియు ముడి పదార్థం ఉపరితలం (B), మధ్య (C) మరియు దిగువ (D) పై మధ్య నుండి క్రూసిబుల్ అంచు వరకు ఉష్ణోగ్రత పంపిణీ 0 గం వద్ద, క్షితిజ సమాంతర అక్షం r అనేది A కోసం విత్తన స్ఫటిక వ్యాసార్థం మరియు B~D కోసం ముడి పదార్థం వైశాల్య వ్యాసార్థం; (డి) నిర్మాణం 0 మరియు నిర్మాణం 1 యొక్క పెరుగుదల గది యొక్క ఎగువ భాగం (A), ముడి పదార్థం ఉపరితలం (B) మరియు మధ్య (C) మధ్యలో ఉష్ణోగ్రత మార్పులు 0, 30, 60, మరియు 100 గం వద్ద నిర్మాణం 1 మరియు నిర్మాణం 1.
చిత్రం 3 నిర్మాణం 0 మరియు నిర్మాణం 1 యొక్క క్రూసిబుల్లో వేర్వేరు సమయాల్లో పదార్థ రవాణాను చూపిస్తుంది. ముడి పదార్థ ప్రాంతం మరియు వృద్ధి గదిలో గ్యాస్ దశ పదార్థ ప్రవాహ రేటు స్థానం పెరుగుదలతో పెరుగుతుంది మరియు పెరుగుదల పెరుగుతున్న కొద్దీ పదార్థ రవాణా బలహీనపడుతుంది. చిత్రం 3 కూడా అనుకరణ పరిస్థితులలో, ముడి పదార్థం మొదట క్రూసిబుల్ యొక్క ప్రక్క గోడపై మరియు తరువాత క్రూసిబుల్ దిగువన గ్రాఫిటైజ్ అవుతుందని చూపిస్తుంది. అదనంగా, ముడి పదార్థం యొక్క ఉపరితలంపై పునఃస్ఫటికీకరణ జరుగుతుంది మరియు పెరుగుదల పెరుగుతున్న కొద్దీ అది క్రమంగా చిక్కగా మారుతుంది. గణాంకాలు 4(a) మరియు 4(b) ముడి పదార్థం లోపల పదార్థ ప్రవాహ రేటు పెరుగుదల పెరుగుతున్న కొద్దీ తగ్గుతుందని మరియు 100 h వద్ద పదార్థ ప్రవాహ రేటు ప్రారంభ క్షణంలో దాదాపు 50% ఉంటుందని చూపిస్తుంది; అయితే, ముడి పదార్థం యొక్క గ్రాఫిటైజేషన్ కారణంగా అంచు వద్ద ప్రవాహం రేటు సాపేక్షంగా పెద్దదిగా ఉంటుంది మరియు అంచు వద్ద ప్రవాహం రేటు 100 h వద్ద మధ్య ప్రాంతంలో ప్రవాహం రేటు కంటే 10 రెట్లు ఎక్కువగా ఉంటుంది; అదనంగా, నిర్మాణం 1లో PG ప్రభావం నిర్మాణం 1 యొక్క ముడి పదార్థ ప్రాంతంలో పదార్థ ప్రవాహ రేటును నిర్మాణం 0 కంటే తక్కువగా చేస్తుంది. చిత్రం 4(c)లో, ముడి పదార్థ ప్రాంతం మరియు వృద్ధి గది రెండింటిలోనూ పదార్థ ప్రవాహం పెరుగుదల పెరుగుతున్న కొద్దీ క్రమంగా బలహీనపడుతుంది మరియు ముడి పదార్థ ప్రాంతంలో పదార్థ ప్రవాహం తగ్గుతూనే ఉంటుంది, ఇది క్రూసిబుల్ అంచున గాలి ప్రవాహ ఛానెల్ తెరవడం మరియు పైభాగంలో పునఃస్ఫటికీకరణకు ఆటంకం కలిగించడం వల్ల సంభవిస్తుంది; వృద్ధి గదిలో, నిర్మాణం 0 యొక్క పదార్థ ప్రవాహ రేటు ప్రారంభ 30 గంటలలో 16% వరకు వేగంగా తగ్గుతుంది మరియు తదుపరి సమయంలో 3% మాత్రమే తగ్గుతుంది, అయితే నిర్మాణం 1 వృద్ధి ప్రక్రియ అంతటా సాపేక్షంగా స్థిరంగా ఉంటుంది. అందువల్ల, PG వృద్ధి గదిలో పదార్థ ప్రవాహ రేటును స్థిరీకరించడానికి సహాయపడుతుంది. చిత్రం 4(d) క్రిస్టల్ పెరుగుదల ముందు భాగంలో పదార్థ ప్రవాహ రేటును పోల్చింది. ప్రారంభ క్షణం మరియు 100 గం వద్ద, నిర్మాణం 0 యొక్క పెరుగుదల జోన్లో పదార్థ రవాణా నిర్మాణం 1 కంటే బలంగా ఉంటుంది, కానీ నిర్మాణం 0 అంచున ఎల్లప్పుడూ అధిక ప్రవాహ రేటు ప్రాంతం ఉంటుంది, ఇది అంచు వద్ద అధిక పెరుగుదలకు దారితీస్తుంది. నిర్మాణం 1 లో PG ఉనికి ఈ దృగ్విషయాన్ని సమర్థవంతంగా అణిచివేస్తుంది.

చిత్రం 3 క్రూసిబుల్లో పదార్థ ప్రవాహం. వేర్వేరు సమయాల్లో 0 మరియు 1 నిర్మాణాలలో వాయు పదార్థ రవాణా యొక్క స్ట్రీమ్లైన్లు (ఎడమ) మరియు వేగ వెక్టర్లు (కుడి), వేగ వెక్టర్ యూనిట్: m/s
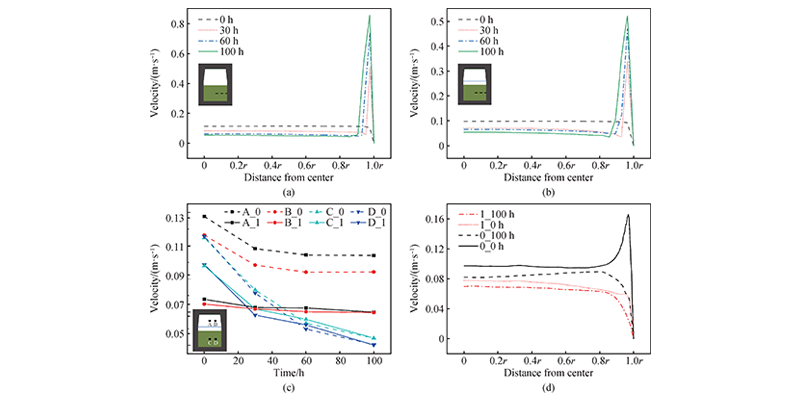
చిత్రం 4 పదార్థ ప్రవాహ రేటులో మార్పులు. (ఎ) 0, 30, 60, మరియు 100 h వద్ద నిర్మాణం 0 యొక్క ముడి పదార్థం మధ్యలో పదార్థ ప్రవాహ రేటు పంపిణీలో మార్పులు, r అనేది ముడి పదార్థం ప్రాంతం యొక్క వ్యాసార్థం; (బి) 0, 30, 60, మరియు 100 h వద్ద నిర్మాణం 1 యొక్క ముడి పదార్థం మధ్యలో పదార్థ ప్రవాహ రేటు పంపిణీలో మార్పులు, r అనేది ముడి పదార్థం ప్రాంతం యొక్క వ్యాసార్థం; (సి) కాలక్రమేణా 0 మరియు 1 నిర్మాణాల పెరుగుదల గది (A, B) లోపల మరియు ముడి పదార్థం (C, D) లోపల పదార్థ ప్రవాహ రేటులో మార్పులు; (డి) 0 మరియు 100 h వద్ద నిర్మాణాల 0 మరియు 1 యొక్క విత్తన క్రిస్టల్ ఉపరితలం దగ్గర పదార్థ ప్రవాహ రేటు పంపిణీ, r అనేది విత్తన క్రిస్టల్ యొక్క వ్యాసార్థం.
C/Si అనేది SiC క్రిస్టల్ పెరుగుదల యొక్క స్ఫటికాకార స్థిరత్వం మరియు లోప సాంద్రతను ప్రభావితం చేస్తుంది. చిత్రం 5(a) ప్రారంభ క్షణంలో రెండు నిర్మాణాల C/Si నిష్పత్తి పంపిణీని పోల్చింది. C/Si నిష్పత్తి క్రూసిబుల్ దిగువ నుండి పైభాగానికి క్రమంగా తగ్గుతుంది మరియు నిర్మాణం 1 యొక్క C/Si నిష్పత్తి ఎల్లప్పుడూ వేర్వేరు స్థానాల్లో నిర్మాణం 0 కంటే ఎక్కువగా ఉంటుంది. గణాంకాలు 5(b) మరియు 5(c) పెరుగుదలతో C/Si నిష్పత్తి క్రమంగా పెరుగుతుందని చూపిస్తున్నాయి, ఇది పెరుగుదల యొక్క తరువాతి దశలో అంతర్గత ఉష్ణోగ్రత పెరుగుదల, ముడి పదార్థాల గ్రాఫిటైజేషన్ మెరుగుదల మరియు గ్రాఫైట్ క్రూసిబుల్తో గ్యాస్ దశలో Si భాగాల ప్రతిచర్యకు సంబంధించినది. చిత్రం 5(d)లో, నిర్మాణం 0 మరియు నిర్మాణం 1 యొక్క C/Si నిష్పత్తులు PG (0, 25 mm) కంటే చాలా భిన్నంగా ఉంటాయి, కానీ PG (50 mm) కంటే కొద్దిగా భిన్నంగా ఉంటాయి మరియు క్రిస్టల్కు చేరుకున్నప్పుడు వ్యత్యాసం క్రమంగా పెరుగుతుంది. సాధారణంగా, నిర్మాణం 1 యొక్క C/Si నిష్పత్తి ఎక్కువగా ఉంటుంది, ఇది క్రిస్టల్ రూపాన్ని స్థిరీకరించడానికి మరియు దశ పరివర్తన సంభావ్యతను తగ్గించడానికి సహాయపడుతుంది.

చిత్రం 5 C/Si నిష్పత్తి పంపిణీ మరియు మార్పులు. (a) 0 h వద్ద నిర్మాణం 0 (ఎడమ) మరియు నిర్మాణం 1 (కుడి) యొక్క క్రూసిబుల్స్లో C/Si నిష్పత్తి పంపిణీ; (b) వివిధ సమయాల్లో (0, 30, 60, 100 h) నిర్మాణం 0 యొక్క క్రూసిబుల్ మధ్య రేఖ నుండి వేర్వేరు దూరాల వద్ద C/Si నిష్పత్తి; (c) వివిధ సమయాల్లో (0, 30, 60, 100 h) నిర్మాణం 1 యొక్క క్రూసిబుల్ మధ్య రేఖ నుండి వేర్వేరు దూరాల వద్ద C/Si నిష్పత్తి; (d) వివిధ సమయాల్లో (0, 30, 60, 100 h) నిర్మాణం 0 (ఘన రేఖ) మరియు నిర్మాణం 1 (డాష్డ్ లైన్) మధ్య రేఖ నుండి వేర్వేరు దూరాల వద్ద (0, 25, 50, 75, 100 mm) C/Si నిష్పత్తి పోలిక.
రెండు నిర్మాణాలలోని ముడి పదార్థ ప్రాంతాల కణ వ్యాసం మరియు సచ్ఛిద్రతలో మార్పులను చిత్రం 6 చూపిస్తుంది. క్రూసిబుల్ గోడ దగ్గర ముడి పదార్థం వ్యాసం తగ్గుతుందని మరియు సచ్ఛిద్రత పెరుగుతుందని మరియు అంచు సచ్ఛిద్రత పెరుగుతూనే ఉంటుందని మరియు పెరుగుదల పెరుగుతున్న కొద్దీ కణ వ్యాసం తగ్గుతూనే ఉంటుందని చిత్రం చూపిస్తుంది. గరిష్ట అంచు సచ్ఛిద్రత 100 h వద్ద 0.99 ఉంటుంది మరియు కనిష్ట కణ వ్యాసం దాదాపు 300 μm ఉంటుంది. కణ వ్యాసం పెరుగుతుంది మరియు ముడి పదార్థం యొక్క పై ఉపరితలంపై సచ్ఛిద్రత తగ్గుతుంది, ఇది పునఃస్ఫటికీకరణకు అనుగుణంగా ఉంటుంది. పెరుగుదల పెరుగుతున్న కొద్దీ పునఃస్ఫటికీకరణ ప్రాంతం యొక్క మందం పెరుగుతుంది మరియు కణ పరిమాణం మరియు సచ్ఛిద్రత మారుతూనే ఉంటుంది. గరిష్ట కణ వ్యాసం 1500 μm కంటే ఎక్కువకు చేరుకుంటుంది మరియు కనిష్ట సచ్ఛిద్రత 0.13. అదనంగా, PG ముడి పదార్థం ప్రాంతం యొక్క ఉష్ణోగ్రతను పెంచుతుంది మరియు గ్యాస్ సూపర్సాచురేషన్ చిన్నదిగా ఉంటుంది కాబట్టి, నిర్మాణం 1 యొక్క ముడి పదార్థం యొక్క పై భాగం యొక్క పునఃస్ఫటికీకరణ మందం చిన్నదిగా ఉంటుంది, ఇది ముడి పదార్థ వినియోగ రేటును మెరుగుపరుస్తుంది.
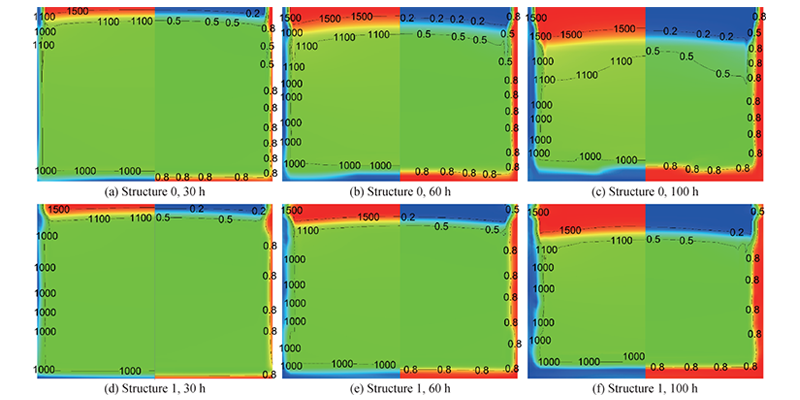 మూర్తి 6 నిర్మాణం 0 మరియు నిర్మాణం 1 యొక్క ముడి పదార్థ ప్రాంతం యొక్క కణ వ్యాసం (ఎడమ) మరియు సచ్ఛిద్రత (కుడి)లో వేర్వేరు సమయాల్లో మార్పులు, కణ వ్యాసం యూనిట్: μm
మూర్తి 6 నిర్మాణం 0 మరియు నిర్మాణం 1 యొక్క ముడి పదార్థ ప్రాంతం యొక్క కణ వ్యాసం (ఎడమ) మరియు సచ్ఛిద్రత (కుడి)లో వేర్వేరు సమయాల్లో మార్పులు, కణ వ్యాసం యూనిట్: μm
చిత్రం 7 పెరుగుదల ప్రారంభంలో నిర్మాణం 0 వార్ప్ అవుతుందని చూపిస్తుంది, ఇది ముడి పదార్థం అంచు యొక్క గ్రాఫిటైజేషన్ వల్ల కలిగే అధిక పదార్థ ప్రవాహ రేటుకు సంబంధించినది కావచ్చు. తదుపరి వృద్ధి ప్రక్రియలో వార్పింగ్ డిగ్రీ బలహీనపడుతుంది, ఇది చిత్రం 4 (d) లోని నిర్మాణం 0 యొక్క క్రిస్టల్ పెరుగుదల ముందు భాగంలో పదార్థ ప్రవాహ రేటులో మార్పుకు అనుగుణంగా ఉంటుంది. నిర్మాణం 1లో, PG ప్రభావం కారణంగా, క్రిస్టల్ ఇంటర్ఫేస్ వార్పింగ్ను చూపించదు. అదనంగా, PG నిర్మాణం 1 యొక్క వృద్ధి రేటును నిర్మాణం 0 కంటే గణనీయంగా తక్కువగా చేస్తుంది. 100 h తర్వాత నిర్మాణం 1 యొక్క క్రిస్టల్ యొక్క మధ్య మందం నిర్మాణం 0 యొక్క 68% మాత్రమే.
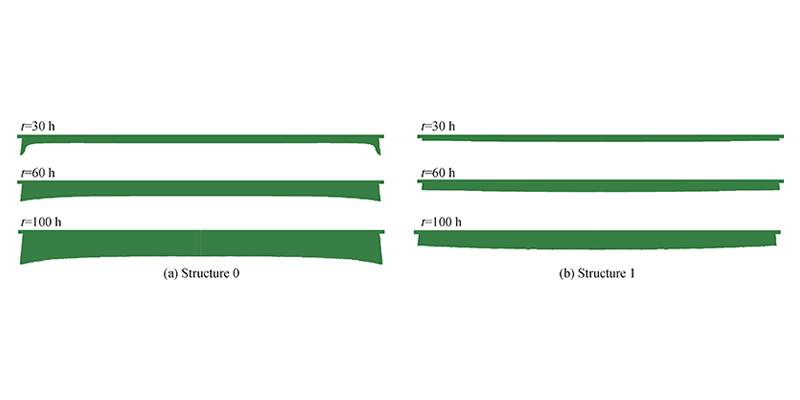
చిత్రం 7 30, 60, మరియు 100 h వద్ద నిర్మాణం 0 మరియు నిర్మాణం 1 స్ఫటికాల ఇంటర్ఫేస్ మార్పులు
సంఖ్యా అనుకరణ ప్రక్రియ పరిస్థితులలో స్ఫటిక పెరుగుదల జరిగింది. నిర్మాణం 0 మరియు నిర్మాణం 1 ద్వారా పెరిగిన స్ఫటికాలు వరుసగా చిత్రం 8(a) మరియు చిత్రం 8(b)లో చూపబడ్డాయి. నిర్మాణం 0 యొక్క స్ఫటికం ఒక పుటాకార ఇంటర్ఫేస్ను చూపిస్తుంది, మధ్య ప్రాంతంలో తరంగాలు మరియు అంచు వద్ద దశ పరివర్తన ఉంటుంది. ఉపరితల కుంభాకారం గ్యాస్-దశ పదార్థాల రవాణాలో కొంత స్థాయి అసంపూర్ణతను సూచిస్తుంది మరియు దశ పరివర్తన సంభవించడం తక్కువ C/Si నిష్పత్తికి అనుగుణంగా ఉంటుంది. నిర్మాణం 1 ద్వారా పెరిగిన క్రిస్టల్ యొక్క ఇంటర్ఫేస్ కొద్దిగా కుంభాకారంగా ఉంటుంది, దశ పరివర్తన కనుగొనబడలేదు మరియు PG లేకుండా మందం క్రిస్టల్లో 65% ఉంటుంది. సాధారణంగా, క్రిస్టల్ పెరుగుదల ఫలితాలు అనుకరణ ఫలితాలకు అనుగుణంగా ఉంటాయి, నిర్మాణం 1 యొక్క క్రిస్టల్ ఇంటర్ఫేస్ వద్ద పెద్ద రేడియల్ ఉష్ణోగ్రత వ్యత్యాసంతో, అంచు వద్ద వేగవంతమైన పెరుగుదల అణచివేయబడుతుంది మరియు మొత్తం పదార్థ ప్రవాహం రేటు నెమ్మదిగా ఉంటుంది. మొత్తం ధోరణి సంఖ్యా అనుకరణ ఫలితాలకు అనుగుణంగా ఉంటుంది.
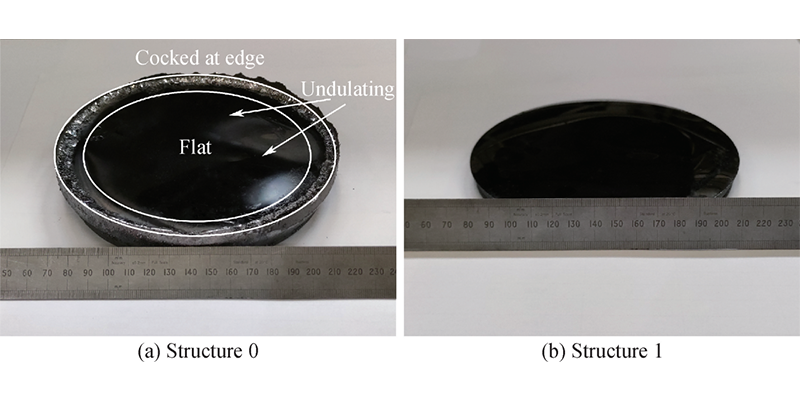
చిత్రం 8 నిర్మాణం 0 మరియు నిర్మాణం 1 కింద పెరిగిన SiC స్ఫటికాలు
ముగింపు
ముడి పదార్థ ప్రాంతం యొక్క మొత్తం ఉష్ణోగ్రత మెరుగుదలకు మరియు అక్షసంబంధ మరియు రేడియల్ ఉష్ణోగ్రత ఏకరూపతను మెరుగుపరచడానికి PG అనుకూలంగా ఉంటుంది, ముడి పదార్థం యొక్క పూర్తి సబ్లిమేషన్ మరియు వినియోగాన్ని ప్రోత్సహిస్తుంది; ఎగువ మరియు దిగువ ఉష్ణోగ్రత వ్యత్యాసం పెరుగుతుంది మరియు సీడ్ క్రిస్టల్ ఉపరితలం యొక్క రేడియల్ ప్రవణత పెరుగుతుంది, ఇది కుంభాకార ఇంటర్ఫేస్ పెరుగుదలను నిర్వహించడానికి సహాయపడుతుంది. ద్రవ్యరాశి బదిలీ పరంగా, PG పరిచయం మొత్తం ద్రవ్యరాశి బదిలీ రేటును తగ్గిస్తుంది, PG కలిగి ఉన్న గ్రోత్ చాంబర్లో పదార్థ ప్రవాహం రేటు కాలక్రమేణా తక్కువగా మారుతుంది మరియు మొత్తం వృద్ధి ప్రక్రియ మరింత స్థిరంగా ఉంటుంది. అదే సమయంలో, PG అధిక అంచు ద్రవ్యరాశి బదిలీ సంభవించడాన్ని కూడా సమర్థవంతంగా నిరోధిస్తుంది. అదనంగా, PG వృద్ధి వాతావరణం యొక్క C/Si నిష్పత్తిని కూడా పెంచుతుంది, ముఖ్యంగా సీడ్ క్రిస్టల్ ఇంటర్ఫేస్ యొక్క ముందు అంచు వద్ద, ఇది వృద్ధి ప్రక్రియలో దశ మార్పు సంభవించడాన్ని తగ్గించడానికి సహాయపడుతుంది. అదే సమయంలో, PG యొక్క థర్మల్ ఇన్సులేషన్ ప్రభావం ముడి పదార్థం యొక్క ఎగువ భాగంలో పునఃస్ఫటికీకరణ సంభవించడాన్ని కొంతవరకు తగ్గిస్తుంది. క్రిస్టల్ పెరుగుదల కోసం, PG క్రిస్టల్ వృద్ధి రేటును నెమ్మదిస్తుంది, కానీ వృద్ధి ఇంటర్ఫేస్ మరింత కుంభాకారంగా ఉంటుంది. అందువల్ల, SiC స్ఫటికాల పెరుగుదల వాతావరణాన్ని మెరుగుపరచడానికి మరియు క్రిస్టల్ నాణ్యతను ఆప్టిమైజ్ చేయడానికి PG ఒక ప్రభావవంతమైన మార్గం.
పోస్ట్ సమయం: జూన్-18-2024
