Основни процесSiCРаст кристала је подељен на сублимацију и разградњу сировина на високој температури, транспорт супстанци у гасној фази под дејством температурног градијента и раст рекристализације супстанци у гасној фази на кристалном семену. На основу тога, унутрашњост тиглице је подељена на три дела: простор за сировине, комору за раст и кристални семен. Нумерички симулациони модел је нацртан на основу стварне отпорности.SiCопрема за раст монокристала (видети слику 1). У прорачуну: днолончићје удаљен 90 мм од дна бочног грејача, горња температура лончића је 2100 ℃, пречник честица сировине је 1000 μм, порозност је 0,6, притисак раста је 300 Па, а време раста је 100 сати. Дебљина PG је 5 мм, пречник је једнак унутрашњем пречнику лончића и налази се 30 мм изнад сировине. Процеси сублимације, карбонизације и рекристализације зоне сировине су узети у обзир у прорачуну, а реакција између PG и супстанци у гасној фази није узета у обзир. Параметри физичких својстава повезани са прорачуном су приказани у Табели 1.
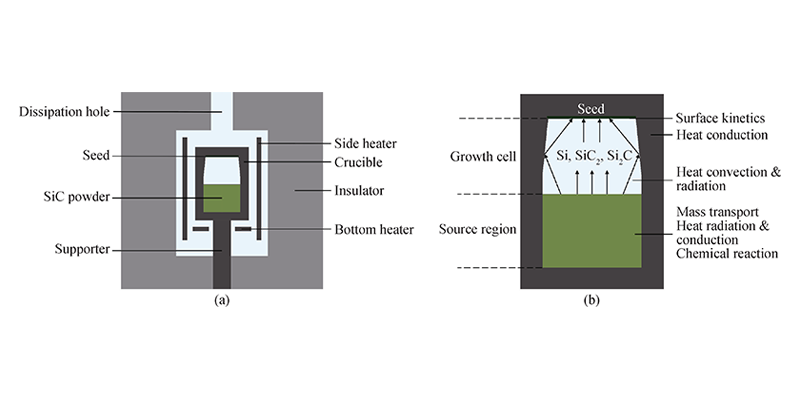
Слика 1. Модел симулације прорачуна. (а) Модел термалног поља за симулацију раста кристала; (б) Подела унутрашњег простора лончића и повезани физички проблеми
Табела 1 Неки физички параметри коришћени у прорачуну

Слика 2(а) показује да је температура структуре која садржи PG (означене као структура 1) виша од температуре структуре без PG (означене као структура 0) испод PG, а нижа од температуре структуре 0 изнад PG. Укупни температурни градијент се повећава, а PG делује као топлотноизолационо средство. Према сликама 2(б) и 2(ц), аксијални и радијални температурни градијенти структуре 1 у зони сировине су мањи, расподела температуре је равномернија, а сублимација материјала је потпунија. За разлику од зоне сировине, слика 2(ц) показује да је радијални температурни градијент на кристалу семена структуре 1 већи, што може бити узроковано различитим пропорцијама различитих начина преноса топлоте, што помаже кристалу да расте са конвексном површином. На слици 2(д), температура на различитим положајима у лончићу показује тренд раста како раст напредује, али температурна разлика између структуре 0 и структуре 1 постепено се смањује у зони сировине и постепено се повећава у комори за раст.
 Слика 2 Расподела температуре и промене у лончићу. (а) Расподела температуре унутар лончића структуре 0 (лево) и структуре 1 (десно) у 0 h, јединица: ℃; (б) Расподела температуре на средишњој линији лончића структуре 0 и структуре 1 од дна сировине до кристала семена у 0 h; (ц) Расподела температуре од центра до ивице лончића на површини кристала семена (А) и површини сировине (Б), средини (Ц) и дну (Д) у 0 h, хоризонтална оса r је полупречник кристала семена за А, а полупречник површине сировине за Б~Д; (д) Промене температуре у центру горњег дела (А), површини сировине (Б) и средини (Ц) коморе за раст структуре 0 и структуре 1 у 0, 30, 60 и 100 h.
Слика 2 Расподела температуре и промене у лончићу. (а) Расподела температуре унутар лончића структуре 0 (лево) и структуре 1 (десно) у 0 h, јединица: ℃; (б) Расподела температуре на средишњој линији лончића структуре 0 и структуре 1 од дна сировине до кристала семена у 0 h; (ц) Расподела температуре од центра до ивице лончића на површини кристала семена (А) и површини сировине (Б), средини (Ц) и дну (Д) у 0 h, хоризонтална оса r је полупречник кристала семена за А, а полупречник површине сировине за Б~Д; (д) Промене температуре у центру горњег дела (А), површини сировине (Б) и средини (Ц) коморе за раст структуре 0 и структуре 1 у 0, 30, 60 и 100 h.
Слика 3 приказује транспорт материјала у различитим временима у лончићу структуре 0 и структуре 1. Брзина протока материјала у гасној фази у подручју сировине и комори за раст повећава се са повећањем положаја, а транспорт материјала слаби како раст напредује. Слика 3 такође показује да се под условима симулације сировина прво графитизује на бочном зиду лончића, а затим на дну лончића. Поред тога, долази до рекристализације на површини сировине и она се постепено згушњава како раст напредује. Слике 4(а) и 4(б) показују да се брзина протока материјала унутар сировине смањује како раст напредује, а брзина протока материјала након 100 сати је око 50% почетног тренутка; међутим, брзина протока је релативно велика на ивици због графитизације сировине, а брзина протока на ивици је више од 10 пута већа од брзине протока у средњем подручју након 100 сати; Поред тога, ефекат PG у структури 1 чини брзину протока материјала у области сировине структуре 1 нижом од оне код структуре 0. На слици 4(ц), проток материјала и у области сировине и у комори за раст постепено слаби како раст напредује, а проток материјала у области сировине наставља да се смањује, што је узроковано отварањем канала за проток ваздуха на ивици лончића и ометањем рекристализације на врху; у комори за раст, брзина протока материјала структуре 0 брзо опада у првих 30 сати на 16%, а у наредном времену опада само за 3%, док структура 1 остаје релативно стабилна током целог процеса раста. Стога, PG помаже у стабилизацији брзине протока материјала у комори за раст. Слика 4(д) упоређује брзину протока материјала на фронту раста кристала. У почетном тренутку и након 100 сати, транспорт материјала у зони раста структуре 0 је јачи него у структури 1, али увек постоји подручје велике брзине протока на ивици структуре 0, што доводи до прекомерног раста на ивици. Присуство PG у структури 1 ефикасно сузбија овај феномен.

Слика 3 Проток материјала у лончићу. Линије струје (лево) и вектори брзине (десно) транспорта гасовитог материјала у структурама 0 и 1 у различитим временима, јединица вектора брзине: m/s
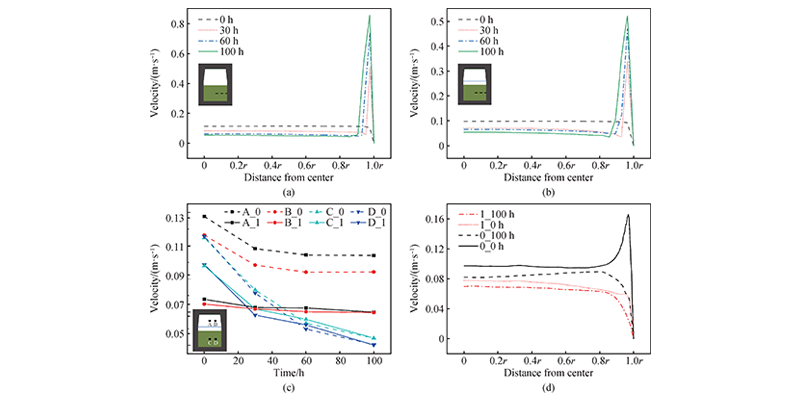
Слика 4 Промене брзине протока материјала. (а) Промене у расподели брзине протока материјала у средини сировине структуре 0 у 0, 30, 60 и 100 h, r је полупречник подручја сировине; (б) Промене у расподели брзине протока материјала у средини сировине структуре 1 у 0, 30, 60 и 100 h, r је полупречник подручја сировине; (ц) Промене брзине протока материјала унутар коморе за раст (А, Б) и унутар сировине (Ц, Д) структура 0 и 1 током времена; (д) Расподела брзине протока материјала близу површине кристала семена структура 0 и 1 у 0 и 100 h, r је полупречник кристала семена
C/Si утиче на кристалну стабилност и густину дефеката раста SiC кристала. Слика 5(а) упоређује расподелу односа C/Si две структуре у почетном тренутку. Однос C/Si постепено се смањује од дна ка врху лончића, а однос C/Si структуре 1 је увек већи од односа структуре 0 на различитим положајима. Слике 5(б) и 5(ц) показују да однос C/Si постепено расте са растом, што је повезано са повећањем унутрашње температуре у каснијој фази раста, побољшањем графитизације сировине и реакцијом Si компоненти у гасној фази са графитним лончићем. На слици 5(д), односи C/Si структуре 0 и структуре 1 су прилично различити испод PG (0, 25 mm), али се мало разликују изнад PG (50 mm), и разлика се постепено повећава како се приближава кристалу. Генерално, однос C/Si структуре 1 је већи, што помаже у стабилизацији кристалног облика и смањењу вероватноће фазног прелаза.

Слика 5. Расподела и промене односа C/Si. (а) Расподела односа C/Si у лончићима структуре 0 (лево) и структуре 1 (десно) у 0 h; (б) Однос C/Si на различитим растојањима од средишње линије лончића структуре 0 у различитим временима (0, 30, 60, 100 h); (ц) Однос C/Si на различитим растојањима од средишње линије лончића структуре 1 у различитим временима (0, 30, 60, 100 h); (д) Поређење односа C/Si на различитим растојањима (0, 25, 50, 75, 100 mm) од средишње линије лончића структуре 0 (пуна линија) и структуре 1 (испрекидана линија) у различитим временима (0, 30, 60, 100 h).
Слика 6 приказује промене у пречнику честица и порозности региона сировине две структуре. Слика показује да се пречник сировине смањује, а порозност повећава близу зида лончића, при чему порозност ивица наставља да расте, а пречник честице наставља да се смањује како раст напредује. Максимална порозност ивица је око 0,99 на 100 сати, а минимални пречник честица је око 300 μm. Пречник честица се повећава, а порозност смањује на горњој површини сировине, што одговара рекристализацији. Дебљина подручја рекристализације се повећава како раст напредује, а величина честица и порозност се настављају мењати. Максимални пречник честица достиже више од 1500 μm, а минимална порозност је 0,13. Поред тога, пошто PG повећава температуру подручја сировине, а презасићеност гасом је мала, дебљина рекристализације горњег дела сировине структуре 1 је мала, што побољшава стопу искоришћења сировине.
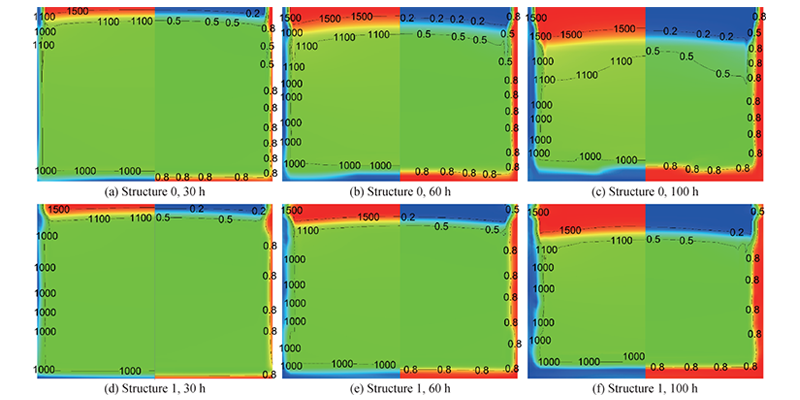 Слика 6 Промене пречника честица (лево) и порозности (десно) површине сировине структуре 0 и структуре 1 у различитим временима, јединица пречника честица: μm
Слика 6 Промене пречника честица (лево) и порозности (десно) површине сировине структуре 0 и структуре 1 у различитим временима, јединица пречника честица: μm
Слика 7 показује да се структура 0 искривљује на почетку раста, што може бити повезано са прекомерном брзином протока материјала изазваном графитизацијом ивице сировине. Степен искривљења је ослабљен током наредног процеса раста, што одговара промени брзине протока материјала на челу раста кристала структуре 0 на слици 4 (д). Код структуре 1, због ефекта PG, кристална површина не показује искривљење. Поред тога, PG такође чини брзину раста структуре 1 знатно нижом од оне код структуре 0. Централна дебљина кристала структуре 1 након 100 сати је само 68% од оне код структуре 0.
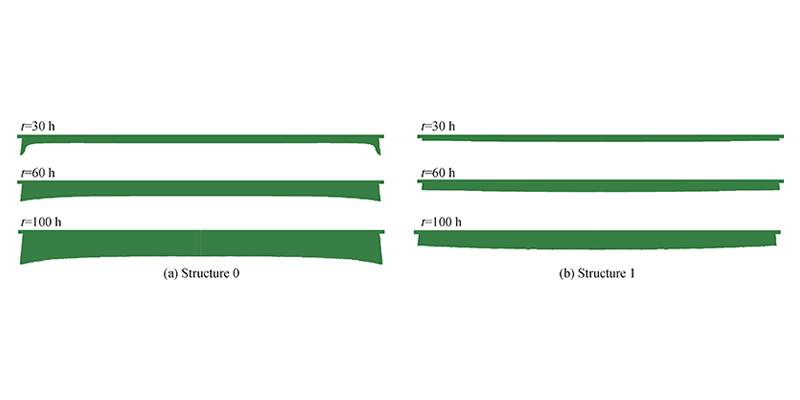
Слика 7 Промене на површини кристала структуре 0 и структуре 1 након 30, 60 и 100 сати
Раст кристала је спроведен под условима процеса нумеричке симулације. Кристали узгајани структуром 0 и структуром 1 приказани су на слици 8(а) и слици 8(б), респективно. Кристал структуре 0 показује конкавну површину, са таласима у централном подручју и фазним прелазом на ивици. Површинска конвексност представља одређени степен нехомогености у транспорту материјала у гасној фази, а појава фазног прелаза одговара ниском односу C/Si. Површина кристала узгајаног структуром 1 је благо конвексна, није пронађен фазни прелаз, а дебљина је 65% кристала без PG. Генерално, резултати раста кристала одговарају резултатима симулације, са већом радијалном температурном разликом на кристалној површини структуре 1, брзи раст на ивици је потиснут, а укупна брзина протока материјала је спорија. Укупни тренд је у складу са резултатима нумеричке симулације.
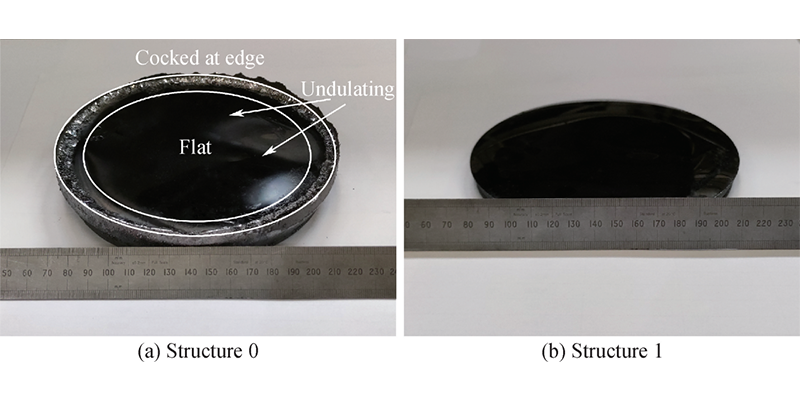
Слика 8 Кристали SiC узгајани под структуром 0 и структуром 1
Закључак
ПГ доприноси побољшању укупне температуре подручја сировине и побољшању аксијалне и радијалне температурне уједначености, промовишући потпуну сублимацију и искоришћење сировине; повећава се разлика у температури између врха и дна, а повећава се и радијални градијент површине кристала семена, што помаже у одржавању раста конвексне површине. Што се тиче преноса масе, увођење ПГ смањује укупну брзину преноса масе, брзина протока материјала у комори за раст која садржи ПГ се мање мења са временом, а цео процес раста је стабилнији. Истовремено, ПГ такође ефикасно инхибира појаву прекомерног преноса масе на ивицама. Поред тога, ПГ такође повећава однос C/Si у средини за раст, посебно на предњој ивици површине кристала семена, што помаже у смањењу појаве фазне промене током процеса раста. Истовремено, ефекат топлотне изолације ПГ донекле смањује појаву рекристализације у горњем делу сировине. За раст кристала, ПГ успорава брзину раста кристала, али је површина раста конвекснија. Стога је PG ефикасно средство за побољшање окружења за раст SiC кристала и оптимизацију квалитета кристала.
Време објаве: 18. јун 2024.
