ची मूलभूत प्रक्रियाएसआयसीक्रिस्टल वाढ ही उच्च तापमानात कच्च्या मालाचे उदात्तीकरण आणि विघटन, तापमान ग्रेडियंटच्या प्रभावाखाली वायू टप्प्यातील पदार्थांचे वाहतूक आणि बीज स्फटिकावर वायू टप्प्यातील पदार्थांचे पुनर्स्फटिकीकरण वाढ यामध्ये विभागली जाते. या आधारावर, क्रुसिबलचा आतील भाग तीन भागांमध्ये विभागला गेला आहे: कच्च्या मालाचे क्षेत्रफळ, वाढ कक्ष आणि बीज स्फटिक. प्रत्यक्ष प्रतिरोधकतेवर आधारित एक संख्यात्मक सिम्युलेशन मॉडेल तयार करण्यात आले.एसआयसीसिंगल क्रिस्टल ग्रोथ उपकरणे (आकृती १ पहा). गणनामध्ये: तळाशीक्रूसिबलसाईड हीटरच्या तळापासून ९० मिमी अंतरावर, क्रूसिबलचे वरचे तापमान २१०० ℃ आहे, कच्च्या मालाच्या कणांचा व्यास १००० μm आहे, सच्छिद्रता ०.६ आहे, वाढीचा दाब ३०० Pa आहे आणि वाढीचा वेळ १०० तास आहे. PG जाडी ५ मिमी आहे, व्यास क्रूसिबलच्या आतील व्यासाइतका आहे आणि तो कच्च्या मालापासून ३० मिमी वर स्थित आहे. गणनामध्ये कच्च्या मालाच्या झोनच्या उदात्तीकरण, कार्बनायझेशन आणि पुनर्क्रिस्टलायझेशन प्रक्रिया विचारात घेतल्या जातात आणि PG आणि गॅस फेज पदार्थांमधील प्रतिक्रिया विचारात घेतली जात नाही. गणना-संबंधित भौतिक गुणधर्म पॅरामीटर्स तक्ता १ मध्ये दर्शविले आहेत.
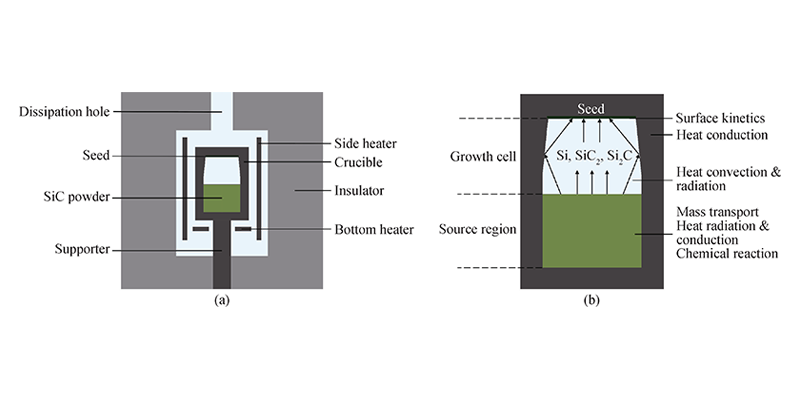
आकृती १ सिम्युलेशन कॅल्क्युलेशन मॉडेल. (अ) क्रिस्टल ग्रोथ सिम्युलेशनसाठी थर्मल फील्ड मॉडेल; (ब) क्रूसिबलच्या अंतर्गत क्षेत्राचे विभाजन आणि संबंधित भौतिक समस्या
तक्ता १ गणनामध्ये वापरलेले काही भौतिक मापदंड

आकृती २(अ) दर्शविते की PG-युक्त संरचनेचे (रचना १ म्हणून दर्शविलेले) तापमान PG च्या खाली असलेल्या PG-मुक्त संरचनेपेक्षा (रचना ० म्हणून दर्शविलेले) जास्त आहे आणि PG वरील रचना ० पेक्षा कमी आहे. एकूण तापमान ग्रेडियंट वाढते आणि PG उष्णता-इन्सुलेट करणारे एजंट म्हणून काम करते. आकृती २(ब) आणि २(क) नुसार, कच्च्या मालाच्या झोनमध्ये रचना १ चे अक्षीय आणि रेडियल तापमान ग्रेडियंट लहान आहेत, तापमान वितरण अधिक एकसमान आहे आणि सामग्रीचे उदात्तीकरण अधिक पूर्ण आहे. कच्च्या मालाच्या झोनच्या विपरीत, आकृती २(क) दर्शविते की रचना १ च्या सीड क्रिस्टलवरील रेडियल तापमान ग्रेडियंट मोठे आहे, जे वेगवेगळ्या उष्णता हस्तांतरण मोडच्या वेगवेगळ्या प्रमाणांमुळे होऊ शकते, जे क्रिस्टलला उत्तल इंटरफेससह वाढण्यास मदत करते. आकृती २(ड) मध्ये, क्रूसिबलमधील वेगवेगळ्या स्थानांवर तापमान वाढत्या प्रमाणात वाढत असल्याचे दिसून येते, परंतु कच्च्या मालाच्या क्षेत्रात रचना ० आणि रचना १ मधील तापमानातील फरक हळूहळू कमी होतो आणि वाढीच्या कक्षात हळूहळू वाढतो.
 आकृती २ क्रूसिबलमधील तापमान वितरण आणि बदल. (अ) रचना ० (डावीकडे) आणि रचना १ (उजवीकडे) च्या क्रूसिबलच्या आत ० तासांवर तापमान वितरण, एकक: ℃; (ब) कच्च्या मालाच्या तळापासून ० तासांवर रचना ० आणि रचना १ च्या क्रूसिबलच्या मध्य रेषेवरील तापमान वितरण; (क) ० तासांवर बियाणे क्रिस्टल पृष्ठभागावर (अ) आणि कच्च्या मालाच्या पृष्ठभागावर (ब), मध्य (क) आणि तळाशी (ड) क्रूसिबलच्या मध्यभागी तापमान वितरण, क्षैतिज अक्ष r हा A साठी बियाणे क्रिस्टल त्रिज्या आणि B~D साठी कच्च्या मालाच्या क्षेत्र त्रिज्या आहे; (ड) रचना ० आणि रचना १ च्या वाढीच्या चेंबरच्या वरच्या भागाच्या (अ), कच्च्या मालाच्या पृष्ठभागाच्या (ब) आणि मध्य (क) मध्यभागी तापमान बदल ०, ३०, ६० आणि १०० तासांवर.
आकृती २ क्रूसिबलमधील तापमान वितरण आणि बदल. (अ) रचना ० (डावीकडे) आणि रचना १ (उजवीकडे) च्या क्रूसिबलच्या आत ० तासांवर तापमान वितरण, एकक: ℃; (ब) कच्च्या मालाच्या तळापासून ० तासांवर रचना ० आणि रचना १ च्या क्रूसिबलच्या मध्य रेषेवरील तापमान वितरण; (क) ० तासांवर बियाणे क्रिस्टल पृष्ठभागावर (अ) आणि कच्च्या मालाच्या पृष्ठभागावर (ब), मध्य (क) आणि तळाशी (ड) क्रूसिबलच्या मध्यभागी तापमान वितरण, क्षैतिज अक्ष r हा A साठी बियाणे क्रिस्टल त्रिज्या आणि B~D साठी कच्च्या मालाच्या क्षेत्र त्रिज्या आहे; (ड) रचना ० आणि रचना १ च्या वाढीच्या चेंबरच्या वरच्या भागाच्या (अ), कच्च्या मालाच्या पृष्ठभागाच्या (ब) आणि मध्य (क) मध्यभागी तापमान बदल ०, ३०, ६० आणि १०० तासांवर.
आकृती ३ मध्ये स्ट्रक्चर ० आणि स्ट्रक्चर १ च्या क्रूसिबलमध्ये वेगवेगळ्या वेळी होणारी सामग्री वाहतूक दर्शविली आहे. कच्च्या मालाच्या क्षेत्रामध्ये आणि वाढीच्या कक्षेत गॅस फेज मटेरियल फ्लो रेट स्थिती वाढल्याने वाढतो आणि वाढ जसजशी होते तसतसे मटेरियल ट्रान्सपोर्ट कमकुवत होते. आकृती ३ मध्ये असेही दिसून आले आहे की सिम्युलेशन परिस्थितीत, कच्चा माल प्रथम क्रूसिबलच्या बाजूच्या भिंतीवर आणि नंतर क्रूसिबलच्या तळाशी ग्राफिटाइज होतो. याव्यतिरिक्त, कच्च्या मालाच्या पृष्ठभागावर पुनर्स्फटिकीकरण होते आणि वाढ जसजशी होते तसतसे ते हळूहळू जाड होते. आकृती ४(अ) आणि ४(ब) दर्शविते की कच्च्या मालाच्या आत मटेरियल फ्लो रेट वाढत्या प्रमाणात कमी होतो आणि १०० तासांवर मटेरियल फ्लो रेट सुरुवातीच्या क्षणाच्या सुमारे ५०% असतो; तथापि, कच्च्या मालाच्या ग्राफिटायझेशनमुळे काठावर प्रवाह दर तुलनेने मोठा असतो आणि काठावर प्रवाह दर १०० तासांवर मध्यम क्षेत्रातील फ्लो रेटपेक्षा १० पट जास्त असतो; याव्यतिरिक्त, रचना १ मधील PG च्या प्रभावामुळे रचना १ च्या कच्च्या मालाच्या क्षेत्रातील सामग्रीचा प्रवाह दर रचना ० पेक्षा कमी होतो. आकृती ४(c) मध्ये, वाढ होत असताना कच्च्या मालाच्या क्षेत्रामध्ये आणि वाढीच्या कक्षेत सामग्रीचा प्रवाह हळूहळू कमकुवत होतो आणि कच्च्या मालाच्या क्षेत्रातील सामग्रीचा प्रवाह कमी होत राहतो, जो क्रूसिबलच्या काठावर वायु प्रवाह वाहिनी उघडल्यामुळे आणि वरच्या बाजूला पुनर्क्रिस्टलायझेशनच्या अडथळ्यामुळे होतो; वाढीच्या कक्षेत, रचना ० चा सामग्रीचा प्रवाह दर सुरुवातीच्या ३० तासांत वेगाने १६% पर्यंत कमी होतो आणि त्यानंतरच्या काळात फक्त ३% ने कमी होतो, तर रचना १ संपूर्ण वाढीच्या प्रक्रियेत तुलनेने स्थिर राहते. म्हणून, PG वाढीच्या कक्षेत सामग्रीचा प्रवाह दर स्थिर करण्यास मदत करते. आकृती ४(d) क्रिस्टल वाढीच्या अग्रभागी सामग्रीच्या प्रवाह दराची तुलना करते. सुरुवातीच्या क्षणी आणि १०० तासांत, रचना ० च्या वाढीच्या क्षेत्रामध्ये भौतिक वाहतूक रचना १ पेक्षा जास्त असते, परंतु रचना ० च्या काठावर नेहमीच उच्च प्रवाह दर क्षेत्र असते, ज्यामुळे काठावर जास्त वाढ होते. रचना १ मध्ये PG ची उपस्थिती या घटनेला प्रभावीपणे दडपते.

आकृती ३ क्रूसिबलमधील पदार्थाचा प्रवाह. वेगवेगळ्या वेळी ० आणि १ संरचनांमध्ये वायू पदार्थांच्या वाहतुकीचे सुव्यवस्थितीकरण (डावीकडे) आणि वेग वेक्टर (उजवीकडे), वेग वेक्टर युनिट: m/s
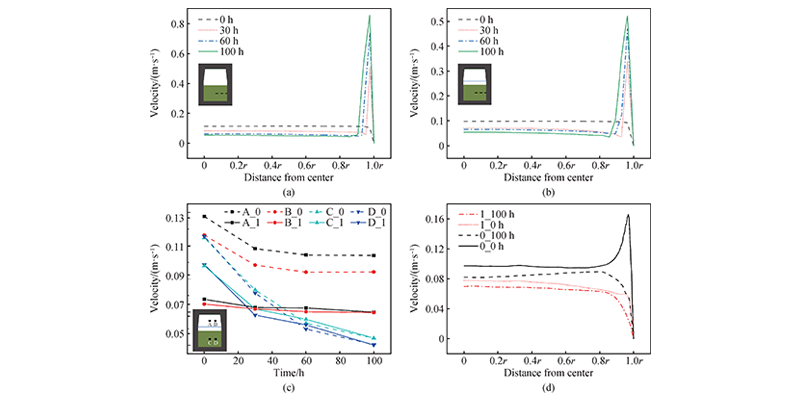
आकृती ४ पदार्थाच्या प्रवाह दरात बदल. (अ) ०, ३०, ६० आणि १०० तासांवर रचना ० च्या कच्च्या मालाच्या मध्यभागी असलेल्या पदार्थाच्या प्रवाह दर वितरणात बदल, r ही कच्च्या मालाच्या क्षेत्राची त्रिज्या आहे; (ब) ०, ३०, ६० आणि १०० तासांवर रचना ० च्या कच्च्या मालाच्या मध्यभागी असलेल्या पदार्थाच्या प्रवाह दर वितरणात बदल, r ही कच्च्या मालाच्या क्षेत्राची त्रिज्या आहे; (क) कालांतराने वाढ कक्ष (अ, ब) आणि ० आणि १ च्या कच्च्या मालाच्या आत असलेल्या पदार्थाच्या प्रवाह दरात बदल; (ड) ० आणि १०० तासांवर रचना ० आणि १ च्या बीज क्रिस्टल पृष्ठभागाजवळ असलेल्या पदार्थाच्या प्रवाह दर वितरणात, r ही बीज क्रिस्टलची त्रिज्या आहे.
C/Si मुळे SiC क्रिस्टल वाढीच्या स्फटिकीय स्थिरता आणि दोष घनतेवर परिणाम होतो. आकृती 5(a) मध्ये सुरुवातीच्या क्षणी दोन्ही रचनांच्या C/Si गुणोत्तर वितरणाची तुलना केली आहे. C/Si गुणोत्तर क्रूसिबलच्या तळापासून वरपर्यंत हळूहळू कमी होते आणि रचना 1 चे C/Si गुणोत्तर वेगवेगळ्या स्थानांवर रचना 0 पेक्षा नेहमीच जास्त असते. आकृती 5(b) आणि 5(c) दर्शवितात की C/Si गुणोत्तर वाढीसह हळूहळू वाढते, जे वाढीच्या नंतरच्या टप्प्यात अंतर्गत तापमानात वाढ, कच्च्या मालाचे ग्राफिटायझेशन वाढवणे आणि ग्रेफाइट क्रूसिबलसह गॅस टप्प्यात Si घटकांच्या प्रतिक्रियेशी संबंधित आहे. आकृती 5(d) मध्ये, रचना 0 आणि रचना 1 चे C/Si गुणोत्तर PG (0, 25 मिमी) पेक्षा बरेच वेगळे आहेत, परंतु PG (50 मिमी) पेक्षा थोडे वेगळे आहेत आणि क्रिस्टलच्या जवळ येताच फरक हळूहळू वाढतो. सर्वसाधारणपणे, रचना 1 चे C/Si गुणोत्तर जास्त असते, जे क्रिस्टल फॉर्म स्थिर करण्यास आणि फेज संक्रमणाची शक्यता कमी करण्यास मदत करते.

आकृती ५ C/Si गुणोत्तराचे वितरण आणि बदल. (a) रचना 0 (डावीकडे) आणि रचना 1 (उजवीकडे) च्या क्रूसिबलमध्ये 0 h वर C/Si गुणोत्तर वितरण; (b) रचना 0 च्या क्रूसिबलच्या मध्य रेषेपासून वेगवेगळ्या वेळी (0, 30, 60, 100 h) वेगवेगळ्या अंतरावर C/Si गुणोत्तर; (c) रचना 1 च्या क्रूसिबलच्या मध्य रेषेपासून वेगवेगळ्या वेळी (0, 30, 60, 100 h) वेगवेगळ्या अंतरावर C/Si गुणोत्तर; (d) रचना 0 (घन रेषा) आणि रचना 1 (डॅश केलेली रेषा) च्या क्रूसिबलच्या मध्य रेषेपासून वेगवेगळ्या वेळी (0, 30, 60, 100 h) वेगवेगळ्या अंतरावर (0, 25, 50, 75, 100 मिमी) C/Si गुणोत्तराची तुलना.
आकृती ६ मध्ये दोन्ही रचनांच्या कच्च्या मालाच्या क्षेत्रांच्या कण व्यास आणि सच्छिद्रतेमध्ये बदल दाखवले आहेत. आकृती दाखवते की कच्च्या मालाचा व्यास कमी होतो आणि क्रूसिबल भिंतीजवळ सच्छिद्रता वाढते आणि काठाची सच्छिद्रता वाढत राहते आणि वाढ जसजशी होते तसतसे कण व्यास कमी होत राहतो. १०० तासांनी कमाल कडा सच्छिद्रता सुमारे ०.९९ असते आणि किमान कण व्यास सुमारे ३०० μm असतो. कच्च्या मालाच्या वरच्या पृष्ठभागावर कण व्यास वाढतो आणि सच्छिद्रता कमी होते, जी पुनर्स्खलनाशी संबंधित असते. वाढ जसजशी पुढे जाते तसतसे पुनर्स्खलन क्षेत्राची जाडी वाढते आणि कण आकार आणि सच्छिद्रता बदलत राहते. कमाल कण व्यास १५०० μm पेक्षा जास्त पोहोचतो आणि किमान सच्छिद्रता ०.१३ असते. याव्यतिरिक्त, PG कच्च्या मालाच्या क्षेत्राचे तापमान वाढवते आणि वायूचे सुपरसॅच्युरेशन लहान असल्याने, रचना १ च्या कच्च्या मालाच्या वरच्या भागाची पुनर्स्खलन जाडी लहान असते, ज्यामुळे कच्च्या मालाचा वापर दर सुधारतो.
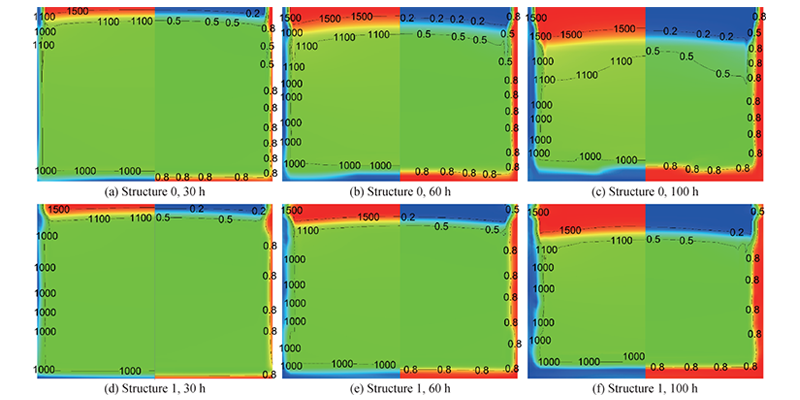 आकृती ६ वेगवेगळ्या वेळी रचना ० आणि रचना १ च्या कच्च्या मालाच्या क्षेत्राच्या कण व्यास (डावीकडे) आणि सच्छिद्रता (उजवीकडे) मध्ये बदल, कण व्यासाचे एकक: μm
आकृती ६ वेगवेगळ्या वेळी रचना ० आणि रचना १ च्या कच्च्या मालाच्या क्षेत्राच्या कण व्यास (डावीकडे) आणि सच्छिद्रता (उजवीकडे) मध्ये बदल, कण व्यासाचे एकक: μm
आकृती ७ मध्ये असे दिसून आले आहे की वाढीच्या सुरुवातीला रचना ० वार्प्स होते, जे कच्च्या मालाच्या काठाच्या ग्राफिटायझेशनमुळे होणाऱ्या अत्यधिक सामग्री प्रवाह दराशी संबंधित असू शकते. त्यानंतरच्या वाढीच्या प्रक्रियेदरम्यान वार्पिंगची डिग्री कमकुवत होते, जी आकृती ४ (ड) मधील रचना ० च्या क्रिस्टल वाढीच्या पुढच्या भागात असलेल्या सामग्री प्रवाह दरातील बदलाशी संबंधित आहे. रचना १ मध्ये, PG च्या प्रभावामुळे, क्रिस्टल इंटरफेस वार्पिंग दर्शवत नाही. याव्यतिरिक्त, PG रचना ० च्या तुलनेत रचना १ चा वाढीचा दर लक्षणीयरीत्या कमी करते. १०० तासांनंतर रचना १ च्या क्रिस्टलची मध्य जाडी रचना ० च्या फक्त ६८% आहे.
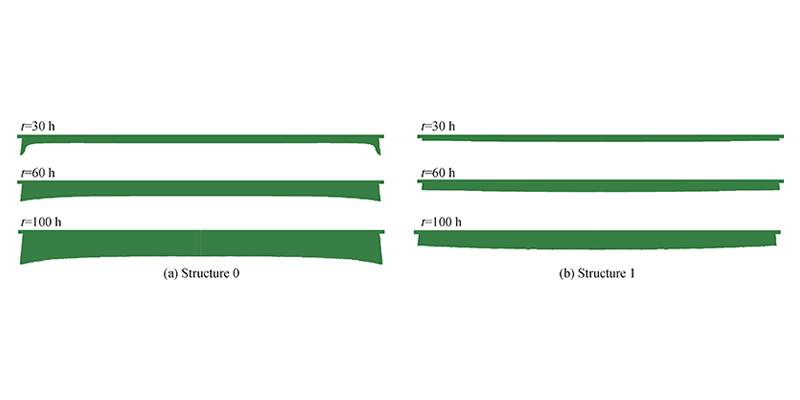
आकृती ७ ३०, ६० आणि १०० तासांवर रचना ० आणि रचना १ क्रिस्टल्समधील इंटरफेस बदल
क्रिस्टलची वाढ संख्यात्मक सिम्युलेशनच्या प्रक्रियेच्या परिस्थितीत झाली. रचना 0 आणि रचना 1 द्वारे वाढवलेले क्रिस्टल्स अनुक्रमे आकृती 8(a) आणि आकृती 8(b) मध्ये दर्शविले आहेत. रचना 0 मधील क्रिस्टल मध्यवर्ती भागात अंड्युलेशन आणि काठावर फेज संक्रमणासह एक अवतल इंटरफेस दर्शवितो. पृष्ठभागाची बहिर्गोलता गॅस-फेज सामग्रीच्या वाहतुकीत विशिष्ट प्रमाणात असंगतता दर्शवते आणि फेज संक्रमणाची घटना कमी C/Si गुणोत्तराशी संबंधित आहे. रचना 1 द्वारे वाढवलेल्या क्रिस्टलचा इंटरफेस किंचित बहिर्गोल आहे, कोणतेही फेज संक्रमण आढळत नाही आणि PG शिवाय जाडी क्रिस्टलच्या 65% आहे. सर्वसाधारणपणे, क्रिस्टल वाढीचे परिणाम सिम्युलेशन परिणामांशी संबंधित आहेत, रचना 1 च्या क्रिस्टल इंटरफेसवर मोठ्या रेडियल तापमान फरकासह, काठावरील जलद वाढ दाबली जाते आणि एकूण सामग्री प्रवाह दर मंद असतो. एकूण ट्रेंड संख्यात्मक सिम्युलेशन परिणामांशी सुसंगत आहे.
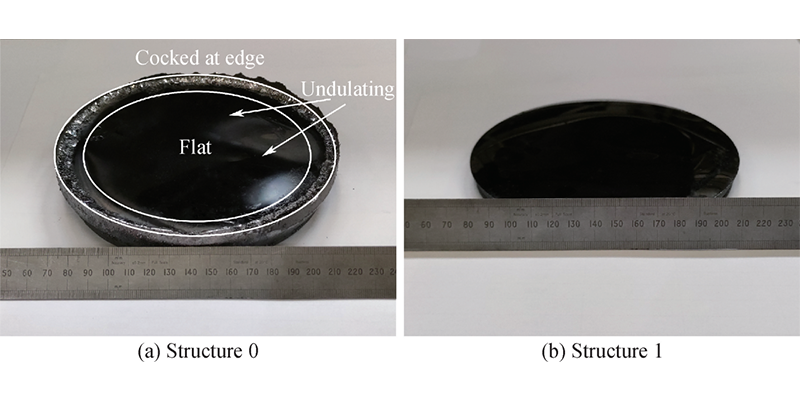
आकृती ८ रचना ० आणि रचना १ अंतर्गत वाढलेले SiC क्रिस्टल्स
निष्कर्ष
कच्च्या मालाच्या क्षेत्राचे एकूण तापमान सुधारण्यासाठी आणि अक्षीय आणि रेडियल तापमान एकरूपतेमध्ये सुधारणा करण्यासाठी पीजी अनुकूल आहे, कच्च्या मालाचे पूर्ण उदात्तीकरण आणि वापर करण्यास प्रोत्साहन देते; वरच्या आणि खालच्या तापमानातील फरक वाढतो आणि बियाणे क्रिस्टल पृष्ठभागाचा रेडियल ग्रेडियंट वाढतो, ज्यामुळे उत्तल इंटरफेस वाढ राखण्यास मदत होते. वस्तुमान हस्तांतरणाच्या बाबतीत, पीजीचा परिचय एकूण वस्तुमान हस्तांतरण दर कमी करतो, पीजी असलेल्या वाढीच्या चेंबरमध्ये सामग्रीचा प्रवाह दर वेळेनुसार कमी बदलतो आणि संपूर्ण वाढ प्रक्रिया अधिक स्थिर असते. त्याच वेळी, पीजी अत्यधिक धार वस्तुमान हस्तांतरणाच्या घटनेला देखील प्रभावीपणे प्रतिबंधित करते. याव्यतिरिक्त, पीजी वाढीच्या वातावरणाचे सी/एसआय गुणोत्तर देखील वाढवते, विशेषतः बियाणे क्रिस्टल इंटरफेसच्या पुढच्या काठावर, जे वाढीच्या प्रक्रियेदरम्यान टप्प्यातील बदलाची घटना कमी करण्यास मदत करते. त्याच वेळी, पीजीचा थर्मल इन्सुलेशन प्रभाव कच्च्या मालाच्या वरच्या भागात पुनर्क्रिस्टलायझेशनची घटना काही प्रमाणात कमी करतो. क्रिस्टल वाढीसाठी, पीजी क्रिस्टल वाढीचा दर कमी करतो, परंतु वाढीचा इंटरफेस अधिक उत्तल असतो. म्हणून, SiC क्रिस्टल्सच्या वाढीचे वातावरण सुधारण्यासाठी आणि क्रिस्टलची गुणवत्ता ऑप्टिमाइझ करण्यासाठी PG हे एक प्रभावी माध्यम आहे.
पोस्ट वेळ: जून-१८-२०२४
