In a fase di u prucessu back-end, ucialda (cialda di siliciucù circuiti nantu à u fronte) deve esse diluitu nantu à u spinu prima di a successiva taglio, saldatura è imballaggio per riduce l'altezza di montaggio di u pacchettu, riduce u vulume di u pacchettu di chip, migliurà l'efficienza di diffusione termica di u chip, e prestazioni elettriche, e proprietà meccaniche è riduce a quantità di taglio. A rettifica posteriore hà i vantaghji di alta efficienza è bassu costu. Hà rimpiazzatu i prucessi tradiziunali di incisione umida è incisione ionica per diventà a tecnulugia di assottigliatura posteriore più impurtante.
A cialda diluita
Cumu dimagrisce?

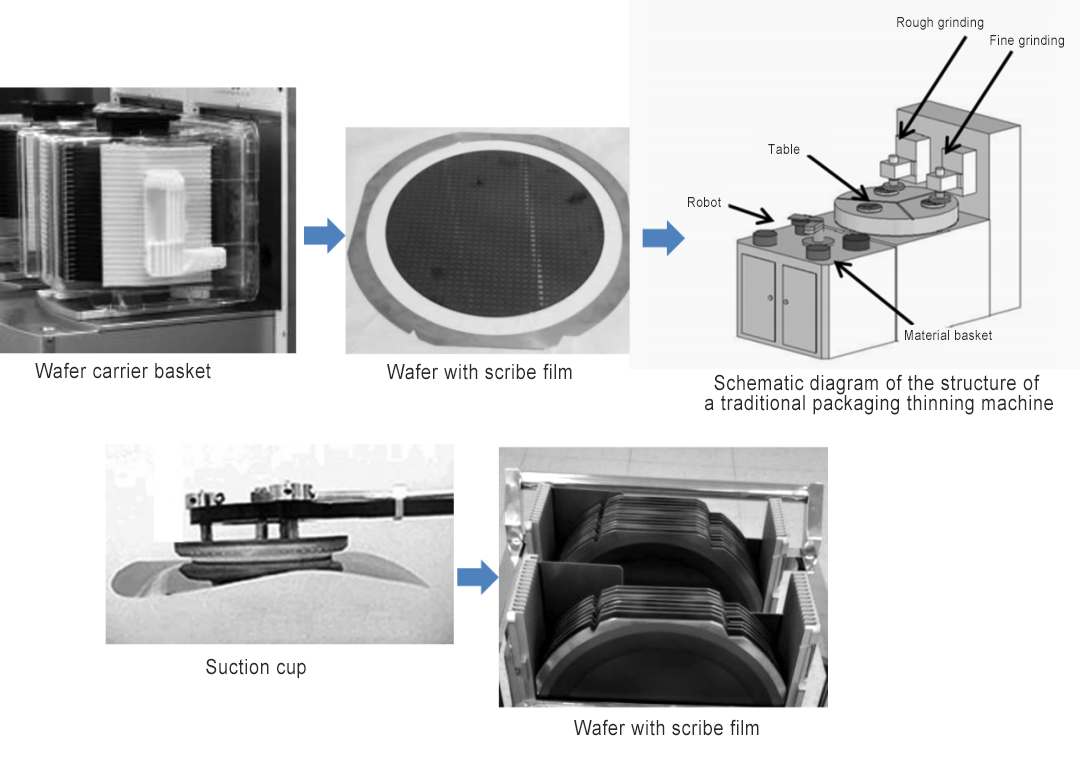 Prucessu principale di assottigliatura di wafer in u prucessu di imballaggio tradiziunale
Prucessu principale di assottigliatura di wafer in u prucessu di imballaggio tradiziunale
I passi specifichi dicialdaL'assottigliatura consiste à ligà a cialda da trasfurmà à u film d'assottigliatura, è dopu aduprà u vacuum per adsorbe u film d'assottigliatura è u chip sopra à a tavola di cialda ceramica porosa, aghjustà e linee centrali di a barca circulare interna è esterna di a superficia di travagliu di a mola di diamanti in forma di tazza à u centru di a cialda di silicone, è a cialda di silicone è a mola giranu intornu à i so rispettivi assi per a rettifica di taglio. A rettifica include trè fasi: rettifica grossolana, rettifica fine è lucidatura.
A cialda chì esce da a fabbrica di cialde hè rettificata in daretu per assottiglià a cialda à u spessore necessariu per l'imballaggio. Quandu si macina a cialda, ci vole à applicà un nastro adesivo à a parte anteriore (Zona Attiva) per prutege l'area di u circuitu, è a parte posteriore hè rettificata à u listessu tempu. Dopu a rettifica, caccià u nastro adesivo è misurà u spessore.
I prucessi di macinazione chì sò stati applicati cù successu à a preparazione di wafer di siliciu includenu a macinazione à tavola rotante,cialda di siliciumacinazione rotativa, macinazione à doppia faccia, ecc. Cù l'ulteriore miglioramentu di i requisiti di qualità superficiale di e cialde di siliciu monocristalline, sò constantemente pruposte nuove tecnulugie di macinazione, cum'è a macinazione TAIKO, a macinazione chimica-meccanica, a macinazione di lucidatura è a macinazione di discu planetariu.
Rettifica à tavola rotativa:
A macinazione à tavola rotativa (macinazione à tavola rotativa) hè un prucessu di macinazione precoce utilizatu in a preparazione di wafer di siliciu è in u diradamentu di u spinu. U so principiu hè mostratu in a Figura 1. I wafer di siliciu sò fissi nantu à e ventose di a tavola rotativa, è giranu sincronamente guidati da a tavola rotativa. I wafer di siliciu stessi ùn giranu micca intornu à u so asse; a mola hè alimentata assialmente mentre gira à alta velocità, è u diametru di a mola hè più grande di u diametru di u wafer di siliciu. Ci sò dui tipi di macinazione à tavola rotativa: macinazione à tuffu frontale è macinazione tangenziale frontale. In a macinazione à tuffu frontale, a larghezza di a mola hè più grande di u diametru di u wafer di siliciu, è u mandrinu di a mola alimenta continuamente longu a so direzzione assiale finu à chì l'eccessu hè trattatu, è dopu u wafer di siliciu hè giratu sottu à l'azionamentu di a tavola rotativa; in a macinazione tangenziale frontale, a mola alimenta longu a so direzzione assiale, è u wafer di siliciu hè giratu continuamente sottu à l'azionamentu di u discu rotativu, è a macinazione hè cumpletata da alimentazione alternativa (reciprocazione) o alimentazione creep (creepfeed).
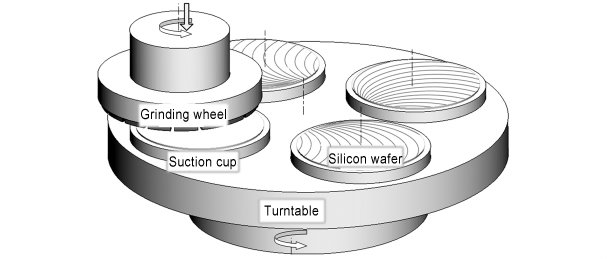
Figura 1, schema di u principiu di a rettifica di a tavola rotativa (tangenziale di a faccia)
In paragone cù u metudu di macinazione, a macinazione à tavula rotativa hà i vantaghji di una alta velocità di rimozione, picculi danni à a superficia è una faciule automatizazione. Tuttavia, l'area di macinazione attuale (macinazione attiva) B è l'angulu di tagliu θ (l'angulu trà u cerchju esternu di a mola è u cerchju esternu di u wafer di siliciu) in u prucessu di macinazione cambianu cù u cambiamentu di a pusizione di tagliu di a mola, risultendu in una forza di macinazione instabile, rendendu difficiule ottene a precisione di a superficia ideale (valore TTV altu), è causendu facilmente difetti cum'è u collassu di u bordu è u collassu di u bordu. A tecnulugia di macinazione à tavula rotativa hè aduprata principalmente per a trasfurmazione di wafer di siliciu monocristallinu sottu à 200 mm. L'aumentu di a dimensione di i wafer di siliciu monocristallinu hà messu in avanti esigenze più elevate per a precisione di a superficia è a precisione di u muvimentu di u bancu di travagliu di l'equipaggiu, dunque a macinazione à tavula rotativa ùn hè micca adatta per a macinazione di wafer di siliciu monocristallinu sopra à 300 mm.
Per migliurà l'efficienza di a macinazione, l'attrezzatura di macinazione tangenziale di u pianu cummerciale adotta di solitu una struttura multi-mola di macinazione. Per esempiu, un inseme di mole di macinazione sgrossa è un inseme di mole di macinazione fina sò equipaggiati nantu à l'attrezzatura, è a tavola rotante gira di un cerchju per cumpletà a macinazione sgrossa è a macinazione fina à turnu. Stu tipu d'attrezzatura include u G-500DS di a cumpagnia americana GTI (Figura 2).
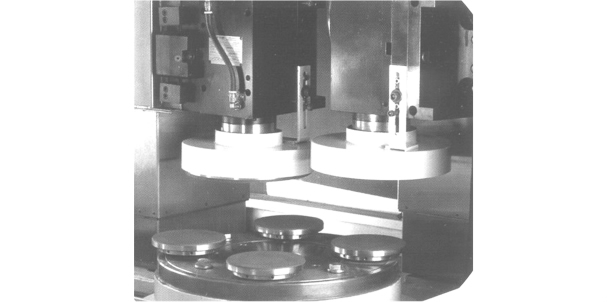
Figura 2, Attrezzatura di macinazione à tavola rotante G-500DS di a cumpagnia GTI in i Stati Uniti
Macinazione di rotazione di wafer di silicone:
Per risponde à i bisogni di a preparazione di wafer di siliciu di grande dimensione è di u trattamentu di assottigliatura di u spinu, è ottene una precisione di superficia cù un bonu valore TTV. In u 1988, u studiosu giapponese Matsui hà prupostu un metudu di macinazione di rotazione di wafer di siliciu (in-feedgrinding). U so principiu hè mostratu in a Figura 3. U wafer di siliciu monocristallinu è a mola di diamanti in forma di tazza adsorbiti nantu à u bancu di travagliu giranu intornu à i so rispettivi assi, è a mola hè alimentata continuamente longu a direzzione assiale à u listessu tempu. Trà questi, u diametru di a mola hè più grande di u diametru di u wafer di siliciu trasfurmatu, è a so circunferenza passa per u centru di u wafer di siliciu. Per riduce a forza di macinazione è riduce u calore di macinazione, a ventosa à vuoto hè generalmente tagliata in una forma convessa o concava o l'angulu trà u mandrinu di a mola è l'asse di u mandrinu di a ventosa hè aghjustatu per assicurà una macinazione di semi-cuntattu trà a mola è u wafer di siliciu.

Figura 3, Schema di u principiu di macinazione rotativa di wafer di siliciu
In paragone cù a macinazione à tavola rotativa, a macinazione rotativa di wafer di siliciu hà i seguenti vantaghji: ① A macinazione à wafer unicu pò processà wafer di siliciu di grande dimensione di più di 300 mm; ② L'area di macinazione effettiva B è l'angulu di taglio θ sò custanti, è a forza di macinazione hè relativamente stabile; ③ Aghjustendu l'angulu d'inclinazione trà l'asse di a mola è l'asse di u wafer di siliciu, a forma di a superficia di u wafer di siliciu monocristallinu pò esse cuntrullata attivamente per ottene una migliore precisione di a forma di a superficia. Inoltre, l'area di macinazione è l'angulu di taglio θ di a macinazione rotativa di wafer di siliciu anu ancu i vantaghji di una macinazione à grande margine, una facile rilevazione è cuntrollu di u spessore in linea è di a qualità di a superficia, una struttura compatta di l'apparecchiatura, una facile macinazione integrata multi-stazione è una alta efficienza di macinazione.
Per migliurà l'efficienza di a pruduzzione è risponde à i bisogni di e linee di pruduzzione di semiconduttori, l'attrezzatura cummerciale di macinazione basata annantu à u principiu di a macinazione rotativa di wafer di siliciu adotta una struttura multi-mandrinu multi-stazione, chì pò cumpletà a macinazione grossolana è a macinazione fina in un unicu caricamentu è scaricamentu. Cumbinata cù altre strutture ausiliarie, pò realizà a macinazione cumpletamente automatica di wafer di siliciu monocristallinu "asciugatura/asciugatura" è "cassetta à cassetta".
Macinazione à doppia faccia:
Quandu a macinazione rotativa di wafer di siliciu processa e superfici superiore è inferiore di u wafer di siliciu, a pezza deve esse girata è realizata per passi, ciò chì limita l'efficienza. À u listessu tempu, a macinazione rotativa di wafer di siliciu hà errori di copia di superficia (copiati) è marchi di macinazione (grindingmark), è hè impussibile di rimuovere efficacemente i difetti cum'è l'ondulazione è a conicità nantu à a superficia di u wafer di siliciu monocristallinu dopu u tagliu di u filu (multi-saw), cum'è mostratu in a Figura 4. Per superà i difetti sopra menzionati, a tecnulugia di macinazione à doppia faccia (doublesidegrinding) hè apparsa in l'anni 1990, è u so principiu hè mostratu in a Figura 5. I morsetti distribuiti simmetricamente da i dui lati chjudenu u wafer di siliciu monocristallinu in l'anellu di ritenzione è giranu lentamente guidati da u rullu. Una coppia di mole di macinazione diamantate in forma di tazza sò situate relativamente da i dui lati di u wafer di siliciu monocristallinu. Guidate da u mandrinu elettricu à cuscinettu d'aria, giranu in direzzioni opposte è alimentanu assialmente per ottene a macinazione à doppia faccia di u wafer di siliciu monocristallinu. Cum'è si pò vede da a figura, a mola à doppia faccia pò eliminà efficacemente l'ondulazione è a conicità nantu à a superficia di a fetta di siliciu monocristallina dopu u tagliu di u filu. Sicondu a direzzione di a dispusizione di l'asse di a mola, a mola à doppia faccia pò esse orizzontale è verticale. Frà elle, a mola à doppia faccia orizzontale pò riduce efficacemente l'influenza di a deformazione di a fetta di siliciu causata da u pesu mortu di a fetta di siliciu nantu à a qualità di a mola, è hè faciule d'assicurà chì e cundizioni di u prucessu di mola da i dui lati di a fetta di siliciu monocristallina sianu listesse, è chì e particelle abrasive è i trucioli di mola ùn sianu micca faciuli à stà nantu à a superficia di a fetta di siliciu monocristallina. Hè un metudu di mola relativamente ideale.
Figura 4, "Errore di copia" è difetti di marca di usura in a macinazione di rotazione di wafer di siliciu
Figura 5, schema di u principiu di macinazione à duie facce
A Tavula 1 mostra a paragone trà a macinazione è a macinazione à doppia faccia di i trè tippi sopra citati di wafer di siliciu monocristallinu. A macinazione à doppia faccia hè principalmente aduprata per a trasfurmazione di wafer di siliciu sottu à 200 mm, è hà un altu rendimentu di wafer. A causa di l'usu di mole abrasive fisse, a macinazione di wafer di siliciu monocristallinu pò ottene una qualità di superficia assai più alta chè quella di a macinazione à doppia faccia. Dunque, sia a macinazione rotativa di wafer di siliciu sia a macinazione à doppia faccia ponu risponde à i requisiti di qualità di trasfurmazione di i wafer di siliciu mainstream di 300 mm, è sò attualmente i metudi di trasfurmazione di appiattimentu più impurtanti. Quandu si sceglie un metudu di trasfurmazione di appiattimentu di wafer di siliciu, hè necessariu cunsiderà cumpletamente i requisiti di a dimensione di u diametru, a qualità di a superficia è a tecnulugia di trasfurmazione di wafer di lucidatura di u wafer di siliciu monocristallinu. L'assottigliatura posteriore di u wafer pò selezziunà solu un metudu di trasfurmazione à una sola faccia, cum'è u metudu di macinazione rotativa di wafer di siliciu.
In più di a selezzione di u metudu di macinazione in a macinazione di wafer di siliciu, hè ancu necessariu determinà a selezzione di parametri di prucessu ragionevuli cum'è a pressione pusitiva, a dimensione di u granu di a mola, u legante di a mola, a velocità di a mola, a velocità di u wafer di siliciu, a viscosità è a velocità di u fluidu di macinazione, ecc., è determinà una strada di prucessu ragionevule. Di solitu, un prucessu di macinazione segmentatu chì include a macinazione grossolana, a macinazione semi-finitura, a macinazione di finitura, a macinazione senza scintille è u supportu lentu hè adupratu per ottene wafer di siliciu monocristallinu cù alta efficienza di trasfurmazione, alta planarità superficiale è bassi danni superficiali.
A nova tecnulugia di macinazione pò riferisce à a literatura:

Figura 5, schema di u principiu di macinazione TAIKO
Figura 6, schema di u principiu di macinazione di u discu planetariu
Tecnulugia di diradamentu di a macinazione di wafer ultra-sottili:
Ci hè una tecnulugia di diradamentu di a macinazione di i purtatori di wafer è una tecnulugia di macinazione di i bordi (Figura 5).
Data di publicazione: 8 d'aostu 2024