នៅក្នុងដំណាក់កាលនៃដំណើរការ back-end, thewafer (ស៊ីលីកុន waferជាមួយសៀគ្វីនៅខាងមុខ) ត្រូវការស្តើងនៅផ្នែកខាងក្រោយ មុនពេលឌីសជាបន្តបន្ទាប់ ការផ្សារ និងការវេចខ្ចប់ ដើម្បីកាត់បន្ថយកម្ពស់នៃការភ្ជាប់កញ្ចប់ កាត់បន្ថយបរិមាណកញ្ចប់បន្ទះឈីប ធ្វើអោយប្រសើរឡើងនូវប្រសិទ្ធភាពនៃការសាយភាយកម្ដៅរបស់បន្ទះឈីប ដំណើរការអគ្គិសនី លក្ខណៈសម្បត្តិមេកានិច និងកាត់បន្ថយបរិមាណនៃការឌីស។ ការកិនខាងក្រោយមានគុណសម្បត្តិនៃប្រសិទ្ធភាពខ្ពស់និងការចំណាយទាប។ វាបានជំនួសដំណើរការ etching សើមប្រពៃណី និងដំណើរការ etching អ៊ីយ៉ុង ដើម្បីក្លាយជា បច្ចេកវិទ្យា ស្តើង ត្រឡប់មកវិញ ដ៏សំខាន់បំផុត។
wafer ស្តើង
តើធ្វើដូចម្តេចដើម្បីស្តើង?

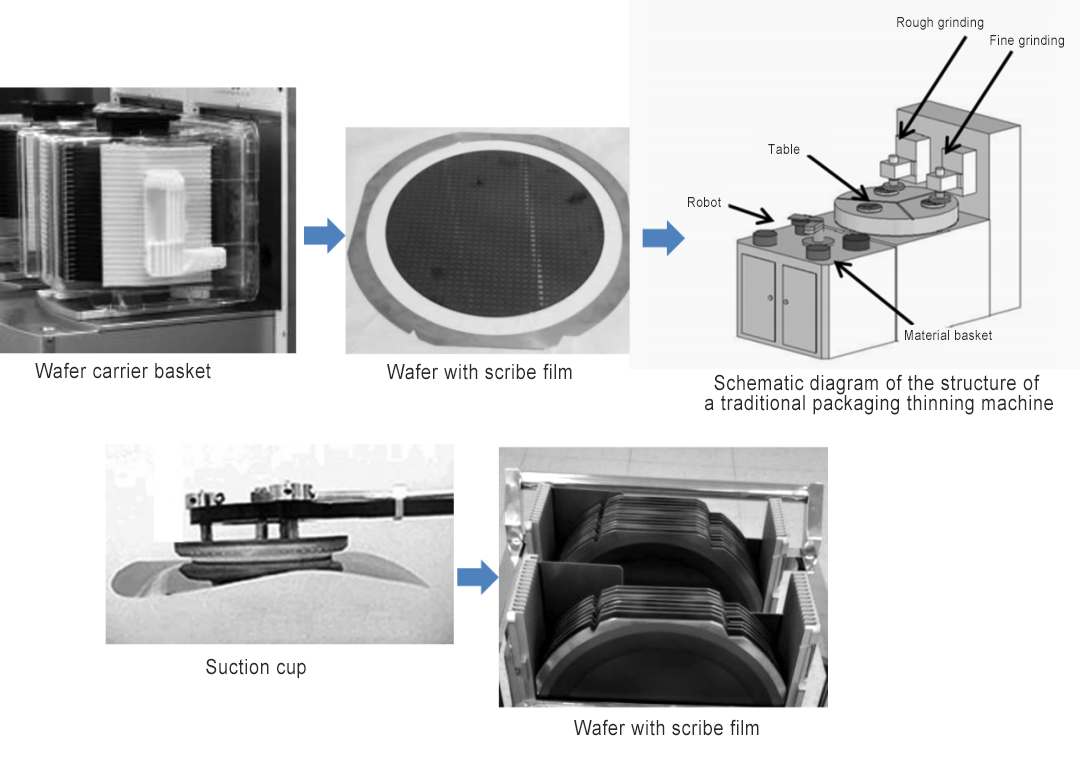 ដំណើរការចម្បងនៃការស្តើង wafer នៅក្នុងដំណើរការវេចខ្ចប់ប្រពៃណី
ដំណើរការចម្បងនៃការស្តើង wafer នៅក្នុងដំណើរការវេចខ្ចប់ប្រពៃណី
ជំហានជាក់លាក់នៃwaferthinning គឺដើម្បីភ្ជាប់ wafer ដែលត្រូវបានដំណើរការទៅនឹងខ្សែភាពយន្តស្តើង ហើយបន្ទាប់មកប្រើម៉ាស៊ីនបូមធូលីដើម្បីស្រូបយកខ្សែភាពយន្តស្តើង និងបន្ទះឈីបនៅលើវាទៅនឹងតារាង wafer សេរ៉ាមិច porous, លៃតម្រូវខ្សែកណ្តាលទូករាងជារង្វង់ខាងក្នុង និងខាងក្រៅនៃផ្ទៃការងារនៃកង់កិនពេជ្ររាងពែងទៅកណ្តាលនៃ wafer ស៊ីលីកុន ហើយ wafer ស៊ីលីកុនរបស់ពួកគេសម្រាប់កិន និងកិនជុំវិញ។ ការកិនរួមមានបីដំណាក់កាល៖ ការកិនរដុប ការកិនល្អ និងការខាត់។
wafer ចេញពីរោងចក្រ wafer ត្រូវបានកិនត្រឡប់មកវិញដើម្បីស្តើង wafer ទៅកម្រាស់ដែលត្រូវការសម្រាប់ការវេចខ្ចប់។ នៅពេលកិន wafer កាសែតត្រូវអនុវត្តទៅផ្នែកខាងមុខ (Active Area) ដើម្បីការពារតំបន់សៀគ្វី ហើយផ្នែកខាងក្រោយគឺដីក្នុងពេលតែមួយ។ បនា្ទាប់ពីកិនរួចយកកាសែតចេញហើយវាស់កម្រាស់។
ដំណើរការកិនដែលត្រូវបានអនុវត្តដោយជោគជ័យចំពោះការរៀបចំ wafer ស៊ីលីកុន រួមមានការកិនតារាងបង្វិល។ស៊ីលីកុន waferការកិនបង្វិល ការកិនទ្វេរភាគី។ល។ ជាមួយនឹងការធ្វើឱ្យប្រសើរឡើងបន្ថែមទៀតនៃតម្រូវការគុណភាពផ្ទៃនៃ wafers ស៊ីលីកូនគ្រីស្តាល់តែមួយ បច្ចេកវិទ្យាកិនថ្មីត្រូវបានស្នើឡើងឥតឈប់ឈរ ដូចជាការកិន TAIKO ការកិនមេកានិចគីមី ការកិនប៉ូលា និងការកិនឌីសភព។
ការកិនតារាងបង្វិល៖
ការកិនតុរ៉ូតារី (ការកិនតុរ៉ូតារី) គឺជាដំណើរការកិនដំបូងគេដែលប្រើក្នុងការរៀបចំស៊ីលីកុនវ៉េហ្វឺរ និងការធ្វើឱ្យស្តើងខ្នង។ គោលការណ៍របស់វាត្រូវបានបង្ហាញក្នុងរូបភាពទី 1. ស៊ីលីកុន wafers ត្រូវបានជួសជុលនៅលើពែងបឺតនៃតារាងបង្វិល ហើយបង្វិលធ្វើសមកាលកម្មដែលជំរុញដោយតារាងបង្វិល។ ស៊ីលីកុន wafers ខ្លួនឯងមិនបង្វិលជុំវិញអ័ក្សរបស់ពួកគេ; កង់កិនត្រូវបានចុកតាមអ័ក្ស ខណៈពេលដែលបង្វិលក្នុងល្បឿនលឿន ហើយអង្កត់ផ្ចិតនៃកង់កិនគឺធំជាងអង្កត់ផ្ចិតនៃ wafer ស៊ីលីកុន។ ការកិនតុរ៉ូតារីមានពីរប្រភេទគឺការកិនលើមុខនិងការកិនមុខ។ នៅក្នុងការកិនមុខ ទទឹងរបស់កង់កិនគឺធំជាងអង្កត់ផ្ចិត wafer ស៊ីលីកុន ហើយ spindle កង់កិន បន្តតាមទិសអ័ក្សរបស់វា រហូតដល់ការលើសត្រូវបានដំណើរការ ហើយបន្ទាប់មក wafer ស៊ីលីកូនត្រូវបានបង្វិលនៅក្រោមដ្រាយនៃតារាងបង្វិល។ នៅក្នុងការកិន tangential មុខ កង់កិនចំណីតាមទិសអ័ក្សរបស់វា ហើយ wafer ស៊ីលីកុនត្រូវបានបង្វិលជាបន្តបន្ទាប់នៅក្រោមដ្រាយនៃថាសបង្វិល ហើយការកិនត្រូវបានបញ្ចប់ដោយការចិញ្ចឹមតបស្នង (reciprocation) ឬការចិញ្ចឹម creep (creepfeed) ។
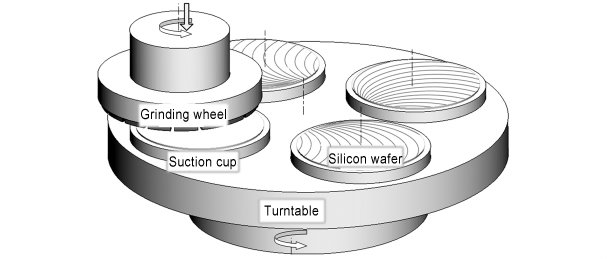
រូបភាពទី 1 ដ្យាក្រាមគំនូសតាងនៃការកិនតារាង rotary (មុខ tangential) គោលការណ៍
បើប្រៀបធៀបជាមួយនឹងវិធីសាស្ត្រកិន ការកិនតុ rotary មានគុណសម្បត្តិនៃអត្រាដកយកចេញខ្ពស់ ការខូចខាតផ្ទៃតូច និងស្វ័យប្រវត្តិកម្មងាយស្រួល។ ទោះជាយ៉ាងណាក៏ដោយ ផ្ទៃកិនពិតប្រាកដ (ការកិនសកម្ម) B និងមុំកាត់θ (មុំរវាងរង្វង់ខាងក្រៅនៃកង់កិន និងរង្វង់ខាងក្រៅនៃស៊ីលីកុន wafer) នៅក្នុងដំណើរការកិនផ្លាស់ប្តូរជាមួយនឹងការផ្លាស់ប្តូរទីតាំងកាត់របស់កង់កិន ដែលបណ្តាលឱ្យមានកម្លាំងកិនមិនស្ថិតស្ថេរ ធ្វើឱ្យពិបាកក្នុងការទទួលបានគែមផ្ទៃដ៏ល្អ (ការដួលរលំយ៉ាងងាយ និងបណ្តាលឱ្យខូចគុណភាព)។ បច្ចេកវិទ្យាកិនតុ rotary ត្រូវបានប្រើជាចម្បងសម្រាប់ដំណើរការនៃ wafers ស៊ីលីកូនគ្រីស្តាល់តែមួយក្រោម 200mm ។ ការកើនឡើងនៃទំហំនៃបន្ទះស៊ីលីកុនគ្រីស្តាល់តែមួយ បានដាក់ចេញនូវតម្រូវការខ្ពស់សម្រាប់ភាពត្រឹមត្រូវនៃផ្ទៃ និងភាពត្រឹមត្រូវនៃចលនានៃកន្លែងធ្វើការរបស់ឧបករណ៍ ដូច្នេះការកិនតារាងបង្វិលមិនសមស្របសម្រាប់ការកិនស៊ីលីកូនគ្រីស្តាល់តែមួយលើសពី 300mm នោះទេ។
ដើម្បីបង្កើនប្រសិទ្ធភាពនៃការកិន ឧបករណ៍កិនតង់សង់យន្តហោះពាណិជ្ជកម្មជាធម្មតាប្រើរចនាសម្ព័ន្ធកង់កិនច្រើន។ ឧទាហរណ៍ សំណុំនៃកង់កិនរដុប និងសំណុំនៃកង់កិនល្អត្រូវបានបំពាក់នៅលើឧបករណ៍ ហើយតារាងបង្វិលបង្វិលរង្វង់មួយដើម្បីបញ្ចប់ការកិនរដុប និងការកិនល្អជាវេន។ ឧបករណ៍ប្រភេទនេះរួមមាន G-500DS របស់ក្រុមហ៊ុន GTI របស់អាមេរិក (រូបភាពទី 2) ។
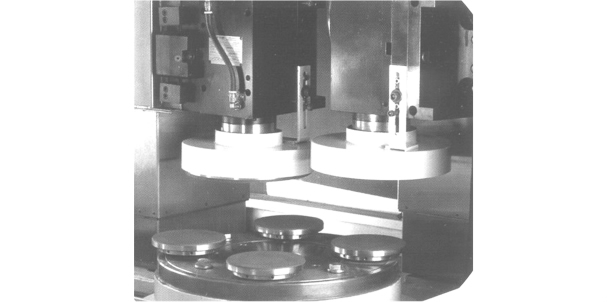
រូបភាពទី 2 ឧបករណ៍កិនតុរ៉ូតារី G-500DS របស់ក្រុមហ៊ុន GTI នៅសហរដ្ឋអាមេរិក
ការកិនបង្វិលស៊ីលីកុន wafer:
ដើម្បីបំពេញតម្រូវការនៃការរៀបចំ wafer ស៊ីលីកុនដែលមានទំហំធំ និងដំណើរការស្តើងជាងមុន និងទទួលបានភាពត្រឹមត្រូវនៃផ្ទៃជាមួយនឹងតម្លៃ TTV ដ៏ល្អ។ នៅឆ្នាំ 1988 អ្នកប្រាជ្ញជនជាតិជប៉ុន Matsui បានស្នើវិធីសាស្ត្របង្វិលស៊ីលីកុន wafer grinding (in-feedgrinding) ។ គោលការណ៍របស់វាត្រូវបានបង្ហាញក្នុងរូបភាពទី 3 ក្នុងចំនោមពួកគេ អង្កត់ផ្ចិតនៃកង់កិនមានទំហំធំជាងអង្កត់ផ្ចិតនៃស៊ីលីកុន wafer កែច្នៃ ហើយបរិមាត្ររបស់វាឆ្លងកាត់កណ្តាលនៃ wafer ស៊ីលីកុន។ ដើម្បីកាត់បន្ថយកម្លាំងកិន និងកាត់បន្ថយកំដៅម៉ាស៊ីន ពែងបូមធូលីជាធម្មតាត្រូវបានកាត់ជារាងប៉ោង ឬរាងប៉ោង ឬមុំរវាង spindle នៃកង់កិន និងអ័ក្ស spindle cup ត្រូវបានកែតម្រូវ ដើម្បីធានាបាននូវការកិនពាក់កណ្តាលទំនាក់ទំនងរវាងកង់កិន និង wafer ស៊ីលីកុន។

រូបភាពទី 3 ដ្យាក្រាមគ្រោងការណ៍នៃគោលការណ៍កិន rotary ស៊ីលីកុន wafer
បើប្រៀបធៀបជាមួយការកិនតុរ៉ូតារី ការកិនស៊ីលីកុន វេហ្វឺររ៉ូតារី មានគុណសម្បត្តិដូចខាងក្រោមៈ ① ការកិន វ៉េហ្វ័រ តែមួយដងអាចដំណើរការស៊ីលីកុន wafers ធំជាង 300mm; ② ផ្ទៃកិនពិតប្រាកដ B និងមុំកាត់ θ គឺថេរ ហើយកម្លាំងកិនមានស្ថេរភាព។ ③ ដោយការលៃតម្រូវមុំទំនោររវាងអ័ក្សកង់កិន និងអ័ក្សស៊ីលីកុន wafer រូបរាងផ្ទៃនៃ wafer ស៊ីលីកូនគ្រីស្តាល់តែមួយអាចត្រូវបានគ្រប់គ្រងយ៉ាងសកម្ម ដើម្បីទទួលបានភាពត្រឹមត្រូវនៃរូបរាងផ្ទៃប្រសើរជាងមុន។ លើសពីនេះទៀត ផ្ទៃកិន និងមុំកាត់θ នៃការកិនស៊ីលីកុន wafer rotary ក៏មានគុណសម្បត្តិនៃការកិនរឹមធំ កម្រាស់អនឡាញងាយស្រួល និងការត្រួតពិនិត្យគុណភាពផ្ទៃ រចនាសម្ព័ន្ធឧបករណ៍បង្រួម ការកិនរួមបញ្ចូលគ្នាពហុស្ថានីយងាយស្រួល និងប្រសិទ្ធភាពកិនខ្ពស់។
ដើម្បីបង្កើនប្រសិទ្ធភាពផលិតកម្ម និងបំពេញតាមតម្រូវការនៃខ្សែសង្វាក់ផលិតកម្ម semiconductor ឧបករណ៍កិនពាណិជ្ជកម្មដោយផ្អែកលើគោលការណ៍នៃការកិនស៊ីលីកុន wafer rotary grinding ទទួលយករចនាសម្ព័ន្ធពហុស្ថានីយពហុ spindle ដែលអាចបញ្ចប់ការកិនរដុប និងកិនល្អក្នុងការផ្ទុក និង unloading ។ រួមផ្សំជាមួយនឹងគ្រឿងបរិក្ខារជំនួយផ្សេងទៀត វាអាចដឹងពីការកិនដោយស្វ័យប្រវត្តិយ៉ាងពេញលេញនៃគ្រីស្តាល់ស៊ីលីកុន wafers "ស្ងួតក្នុង/ស្ងួត" និង " cassette to cassette"។
ការកិនពីរផ្នែក៖
នៅពេលដែលការកិនស៊ីលីកុន wafer ដំណើរការផ្ទៃខាងលើ និងខាងក្រោមនៃ wafer ស៊ីលីកុន នោះ workpiece ត្រូវការបង្វិល និងអនុវត្តជាជំហានៗ ដែលកំណត់ប្រសិទ្ធភាព។ ក្នុងពេលជាមួយគ្នានេះ ការកិនស៊ីលីកុន wafer មានកំហុសលើផ្ទៃលើការចម្លង (ចម្លង) និងស្នាមកិន (ការកិន) ហើយវាមិនអាចទៅរួចទេក្នុងការលុបបំបាត់ពិការភាពដូចជា ភាពរញ៉េរញ៉ៃ និងស្តើងលើផ្ទៃនៃគ្រីស្តាល់ស៊ីលីកុន wafer តែមួយបន្ទាប់ពីការកាត់ខ្សែ (ច្រើនដង) ដូចបង្ហាញក្នុងរូបភាពទី 4 បច្ចេកវិទ្យានៃការកិនទ្វេដងខាងលើ។ (doublesidegrinding) បានបង្ហាញខ្លួននៅក្នុងទសវត្សរ៍ឆ្នាំ 1990 ហើយគោលការណ៍របស់វាត្រូវបានបង្ហាញក្នុងរូបភាពទី 5 ។ ការគៀបដែលចែកចាយដោយស៊ីមេទ្រីនៅលើភាគីទាំងសងខាង តោងបន្ទះស៊ីលីកុនគ្រីស្តាល់តែមួយនៅក្នុងសង្វៀនរក្សា ហើយបង្វិលយឺតៗដែលជំរុញដោយ roller ។ កង់កិនពេជ្ររាងជាពែងមួយគូ មានទីតាំងនៅសងខាងនៃគ្រីស្តាល់ស៊ីលីកុន wafer តែមួយ។ ជំរុញដោយ spindle អគ្គិសនីដែលផ្ទុកដោយខ្យល់ ពួកវាបង្វិលក្នុងទិសដៅផ្ទុយ និងចិញ្ចឹមតាមអ័ក្ស ដើម្បីសម្រេចបាននូវការកិនពីរផ្នែកនៃ wafer ស៊ីលីកូនគ្រីស្តាល់តែមួយ។ ដូចដែលអាចមើលឃើញពីរូបភាព ការកិនទ្វេរដងអាចបំបាត់ភាពរវើរវាយ និងស្តើងលើផ្ទៃនៃគ្រីស្តាល់ស៊ីលីកុន wafer តែមួយបន្ទាប់ពីកាត់ខ្សែ។ យោងទៅតាមទិសដៅនៃការរៀបចំរបស់អ័ក្សកង់ ការកិនពីរផ្នែកអាចផ្ដេក និងបញ្ឈរ។ ក្នុងចំនោមពួកគេ ការកិនពីរជ្រុងផ្តេកអាចកាត់បន្ថយឥទ្ធិពលនៃការខូចទ្រង់ទ្រាយ silicon wafer ដែលបណ្តាលមកពីទម្ងន់ងាប់នៃ silicon wafer លើគុណភាពកិន ហើយវាងាយស្រួលក្នុងការធានាថាលក្ខខណ្ឌដំណើរការកិនទាំងសងខាងនៃ crystal silicon wafer តែមួយគឺដូចគ្នា ហើយភាគល្អិតសំណឹក និងបន្ទះស៊ីលីកុនកិនមិនងាយនឹងស្ថិតនៅលើផ្ទៃគ្រីស្តាល់ស៊ីលីកុនតែមួយទេ។ វាជាវិធីសាស្ត្រកិនល្អគួរសម។
រូបភាពទី 4 "ការចម្លងកំហុស" និងការពាក់ស្លាកស្នាមនៅក្នុងការកិនបង្វិលស៊ីលីកុន wafer
រូបភាពទី 5 ដ្យាក្រាមគ្រោងការណ៍នៃគោលការណ៍កិនទ្វេ
តារាងទី 1 បង្ហាញពីការប្រៀបធៀបរវាងការកិន និងការកិនពីរផ្នែកនៃប្រភេទ wafers ស៊ីលីកុនគ្រីស្តាល់ទាំងបីខាងលើ។ ការកិនទ្វេរដងត្រូវបានប្រើជាចម្បងសម្រាប់ដំណើរការស៊ីលីកុន wafer ក្រោម 200mm និងមានទិន្នផល wafer ខ្ពស់។ ដោយសារតែការប្រើប្រាស់កង់កិនដែលមានសំណឹកថេរ ការកិននៃបន្ទះស៊ីលីកុនគ្រីស្តាល់តែមួយអាចទទួលបានគុណភាពផ្ទៃខ្ពស់ជាងការកិនពីរផ្នែក។ ដូច្នេះទាំងការកិនស៊ីលីកុន wafer rotary និងការកិនពីរដងអាចបំពេញតាមតម្រូវការគុណភាពនៃដំណើរការនៃ wafers ស៊ីលីកុន 300mm ហើយបច្ចុប្បន្នជាវិធីសាស្ត្រកែច្នៃសំប៉ែតដ៏សំខាន់បំផុត។ នៅពេលជ្រើសរើសវិធីសាស្រ្តកែច្នៃ wafer ស៊ីលីកុន វាចាំបាច់ដើម្បីពិចារណាឱ្យបានទូលំទូលាយអំពីតម្រូវការនៃទំហំអង្កត់ផ្ចិត គុណភាពផ្ទៃ និងបច្ចេកវិទ្យាកែច្នៃ wafer ប៉ូលានៃ wafer ស៊ីលីកូនគ្រីស្តាល់តែមួយ។ ការស្តើងផ្នែកខាងក្រោយនៃ wafer អាចជ្រើសរើសបានតែវិធីសាស្ត្រកែច្នៃតែមួយមុខប៉ុណ្ណោះ ដូចជាវិធីសាស្ត្រកិនរ៉ូតារីស៊ីលីកុន wafer ជាដើម។
បន្ថែមពីលើការជ្រើសរើសវិធីសាស្ត្រកិនក្នុងការកិនស៊ីលីកុន វាក៏ចាំបាច់ផងដែរក្នុងការកំណត់ការជ្រើសរើសប៉ារ៉ាម៉ែត្រដំណើរការសមហេតុផលដូចជា សម្ពាធវិជ្ជមាន ទំហំគ្រាប់ធញ្ញជាតិកិន ម៉ាស៊ីនកិនកង់ ល្បឿនកង់កិន ល្បឿនស៊ីលីកុន wafer កិន viscosity សារធាតុរាវ និងអត្រាលំហូរ។ល។ និងកំណត់ផ្លូវដំណើរការសមហេតុផល។ ជាធម្មតា ដំណើរការកិនជាផ្នែកៗ រួមមានការកិនរដុប ការកិនពាក់កណ្តាលបញ្ចប់ ការកិនបញ្ចប់ ការកិនដោយគ្មានផ្កាភ្លើង និងការថយក្រោយយឺត ត្រូវបានប្រើដើម្បីទទួលបានគ្រីស្តាល់ស៊ីលីកុន wafers តែមួយជាមួយនឹងប្រសិទ្ធភាពដំណើរការខ្ពស់ ផ្ទៃរាបស្មើខ្ពស់ និងការខូចខាតផ្ទៃទាប។
បច្ចេកវិទ្យាកិនថ្មីអាចយោងទៅលើអក្សរសិល្ប៍៖

រូបភាពទី 5 ដ្យាក្រាមគ្រោងការណ៍នៃគោលការណ៍កិន TAIKO
រូបភាពទី 6 ដ្យាក្រាមគ្រោងការណ៍នៃគោលការណ៍កិនថាសភព
បច្ចេកវិទ្យាកាត់ wafer ស្តើងបំផុត៖
មានបច្ចេកវិទ្យាកិនស្តើង និងបច្ចេកវិទ្យាកិនគែម (រូបភាពទី 5) ។
ពេលវេលាផ្សាយ៖ សីហា-០៨-២០២៤