I backend-prosessfasen,kjeks (silisiumskivemed kretser på forsiden) må tynnes ut på baksiden før påfølgende dicing, sveising og pakking for å redusere monteringshøyden på pakken, redusere brikkepakkens volum, forbedre brikkens termiske diffusjonseffektivitet, elektriske ytelse, mekaniske egenskaper og redusere mengden dicing. Baksliping har fordelene med høy effektivitet og lave kostnader. Den har erstattet de tradisjonelle våtetsings- og ionetsingsprosessene og blitt den viktigste baktynningsteknologien.
Den tynnede waferen
Hvordan tynne ut?

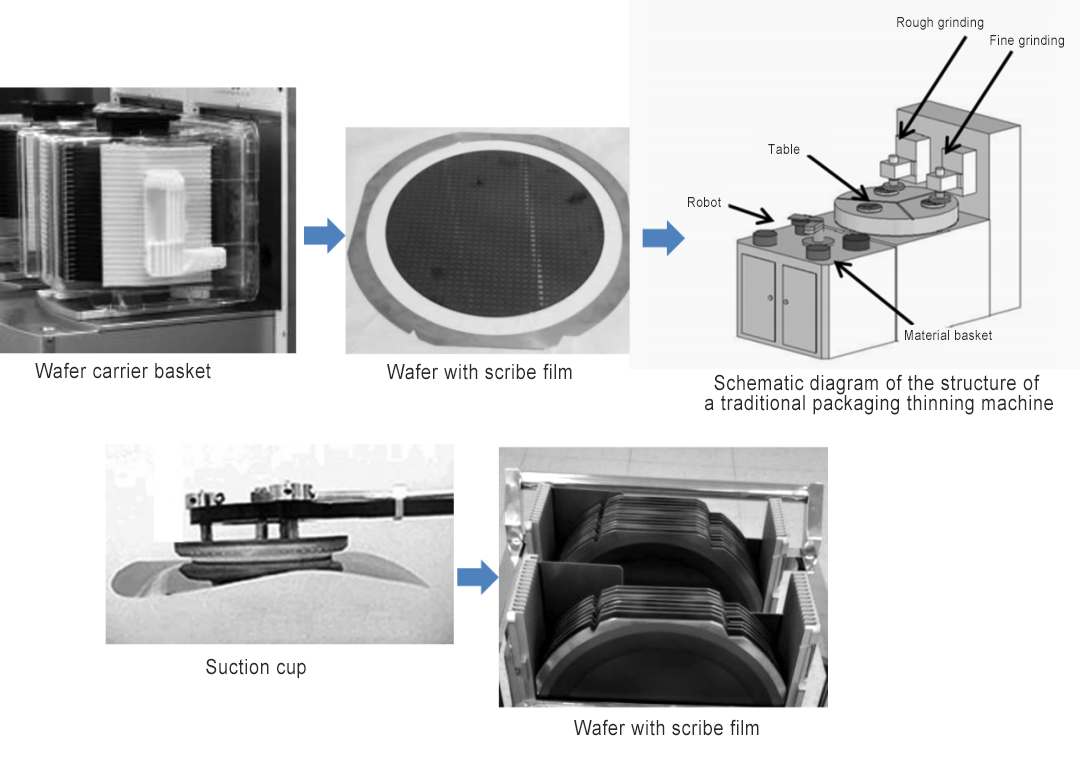 Hovedprosess for tynning av wafere i tradisjonell pakkeprosess
Hovedprosess for tynning av wafere i tradisjonell pakkeprosess
De spesifikke trinnene ikjeksTynning er å binde waferen som skal bearbeides til den tynne filmen, og deretter bruke vakuum til å adsorbere den tynne filmen og brikken på den til det porøse keramiske waferbordet, justere de indre og ytre sirkulære båtens senterlinjer på arbeidsflaten til den koppformede diamantslipeskiven til midten av silisiumwaferen, og silisiumwaferen og slipeskiven roterer rundt sine respektive akser for innsliping. Sliping inkluderer tre trinn: grovsliping, finsliping og polering.
Waferen som kommer ut av waferfabrikken blir bakslipt for å tynne ut waferen til den tykkelsen som kreves for emballasje. Ved sliping av waferen må det påføres tape på forsiden (aktivt område) for å beskytte kretsområdet, og baksiden slipes samtidig. Etter sliping, fjern tapen og mål tykkelsen.
Slipeprosessene som har blitt brukt med hell til fremstilling av silisiumskiver inkluderer rotasjonsbordsliping,silisiumskiverotasjonssliping, dobbeltsidig sliping, osv. Med ytterligere forbedring av overflatekvalitetskravene til enkrystallsilisiumskiver, foreslås det stadig nye slipeteknologier, som TAIKO-sliping, kjemisk-mekanisk sliping, poleringssliping og planetarisk skivesliping.
Sliping av roterende bord:
Sliping av rotasjonsbord (rotasjonsbordsliping) er en tidlig slipeprosess som ble brukt i fremstilling og uttynning av silisiumskiver. Prinsippet er vist i figur 1. Silisiumskivene er festet på sugekoppene på det roterende bordet og roterer synkront drevet av det roterende bordet. Silisiumskivene roterer ikke rundt sin akse; slipeskiven mates aksialt mens den roterer med høy hastighet, og diameteren på slipeskiven er større enn diameteren på silisiumskiven. Det finnes to typer rotasjonsbordsliping: plansliping og plantangensiell sliping. Ved plansliping er slipeskivens bredde større enn silisiumskivens diameter, og slipeskivens spindel mates kontinuerlig langs sin aksiale retning til overskuddet er behandlet, og deretter roteres silisiumskiven under driften av det roterende bordet; ved plantangensiell sliping mates slipeskiven langs sin aksiale retning, og silisiumskiven roteres kontinuerlig under driften av den roterende skiven, og slipingen fullføres ved frem- og tilbakegående mating (frem- og tilbakegående) eller krypmating (krypmating).
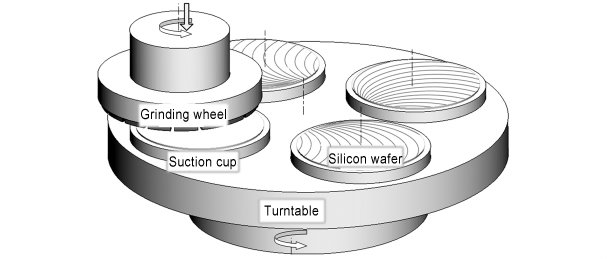
Figur 1, skjematisk diagram av prinsippet for sliping av roterende bord (tangential overflate)
Sammenlignet med slipemetoden har rotasjonsbordsliping fordelene med høy fjerningshastighet, liten overflateskade og enkel automatisering. Imidlertid endres det faktiske slipeområdet (aktiv sliping) B og innskjæringsvinkelen θ (vinkelen mellom slipeskivens ytre sirkel og silisiumskivens ytre sirkel) i slipeprosessen med endringen av slipeskivens skjæreposisjon, noe som resulterer i en ustabil slipekraft, noe som gjør det vanskelig å oppnå den ideelle overflatenøyaktigheten (høy TTV-verdi), og forårsaker lett defekter som kantkollaps og kantkollaps. Rotasjonsbordslipeteknologien brukes hovedsakelig til behandling av enkrystallsilisiumskiver under 200 mm. Økningen i størrelsen på enkrystallsilisiumskiver har stilt høyere krav til overflatenøyaktighet og bevegelsesnøyaktighet på arbeidsbenken, så rotasjonsbordsliping er ikke egnet for sliping av enkrystallsilisiumskiver over 300 mm.
For å forbedre slipeeffektiviteten bruker kommersielt plan tangentialslipeutstyr vanligvis en flerslipeskivestruktur. For eksempel er et sett med grovslipeskiver og et sett med finslipeskiver utstyrt på utstyret, og rotasjonsbordet roterer én sirkel for å fullføre grovslipingen og finslipingen etter tur. Denne typen utstyr inkluderer G-500DS fra det amerikanske GTI-selskapet (figur 2).
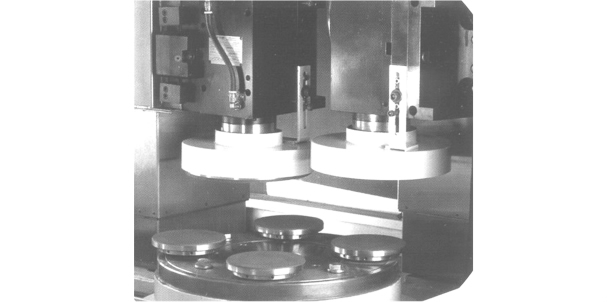
Figur 2, G-500DS rotasjonsbordslipeutstyr fra GTI Company i USA
Rotasjonssliping av silisiumskive:
For å møte behovene for fremstilling og tynning av silisiumskiver i store størrelser, og oppnå overflatenøyaktighet med god TTV-verdi, foreslo den japanske forskeren Matsui i 1988 en metode for rotasjonssliping av silisiumskiver (in-feed grinding). Prinsippet er vist i figur 3. Enkrystallsilisiumskiven og den koppformede diamantslipeskiven som er adsorbert på arbeidsbenken, roterer rundt sine respektive akser, og slipeskiven mates kontinuerlig langs aksialretningen samtidig. Blant disse er diameteren på slipeskiven større enn diameteren på den bearbeidede silisiumskiven, og omkretsen går gjennom midten av silisiumskiven. For å redusere slipekraften og slipevarmen trimmes vakuumsugekoppen vanligvis til en konveks eller konkav form, eller vinkelen mellom slipeskivens spindel og sugekoppens spindelakse justeres for å sikre semikontaktsliping mellom slipeskiven og silisiumskiven.

Figur 3, Skjematisk diagram av prinsippet om rotasjonssliping av silisiumskiver
Sammenlignet med rotasjonssliping av silisiumskiver har rotasjonssliping av silisiumskiver følgende fordeler: ① Engangssliping av enkeltskiver kan behandle store silisiumskiver over 300 mm; ② Det faktiske slipeområdet B og skjærevinkelen θ er konstante, og slipekraften er relativt stabil; ③ Ved å justere hellingsvinkelen mellom slipehjulets akse og silisiumskivens akse, kan overflateformen til enkeltkrystallsilisiumskiven aktivt kontrolleres for å oppnå bedre nøyaktighet i overflateformen. I tillegg har slipeområdet og skjærevinkelen θ ved rotasjonssliping av silisiumskiver også fordelene med sliping med stor margin, enkel online tykkelses- og overflatekvalitetsdeteksjon og -kontroll, kompakt utstyrsstruktur, enkel integrert sliping med flere stasjoner og høy slipeeffektivitet.
For å forbedre produksjonseffektiviteten og møte behovene til halvlederproduksjonslinjer, bruker kommersielt slipeutstyr basert på prinsippet om rotasjonssliping av silisiumskiver en flerspindels flerstasjonsstruktur, som kan fullføre grovsliping og finsliping i én lasting og lossing. Kombinert med andre tilleggsfasiliteter kan det realisere helautomatisk sliping av enkrystall silisiumskiver "tørk-inn/tørk-ut" og "kassett-til-kassett".
Dobbeltsidig sliping:
Når rotasjonssliping av silisiumskiver bearbeider de øvre og nedre overflatene av silisiumskiven, må arbeidsstykket vendes og utføres trinnvis, noe som begrenser effektiviteten. Samtidig har rotasjonssliping av silisiumskiver overflatefeil som kopiering (kopiering) og slipemerker (slipemerker), og det er umulig å effektivt fjerne defekter som bølger og koniskhet på overflaten av enkrystallsilisiumskiven etter trådkutting (flersag), som vist i figur 4. For å overvinne de ovennevnte defektene dukket dobbeltsidig slipeteknologi (dobbeltsidesliping) opp på 1990-tallet, og prinsippet er vist i figur 5. Klemmene som er symmetrisk fordelt på begge sider, klemmer enkrystallsilisiumskiven fast i låseringen og roterer sakte drevet av rullen. Et par koppformede diamantslipeskiver er plassert relativt på begge sider av enkrystallsilisiumskiven. Drevet av den elektriske luftlagrede spindelen, roterer de i motsatte retninger og mates aksialt for å oppnå dobbeltsidig sliping av enkrystallsilisiumskiven. Som det fremgår av figuren, kan dobbeltsidig sliping effektivt fjerne bølger og avsmalninger på overflaten av enkrystallsilisiumskiven etter trådkutting. I henhold til slipeskivens akseretning kan dobbeltsidig sliping være horisontal og vertikal. Horisontal dobbeltsidig sliping kan effektivt redusere påvirkningen av silisiumskivens deformasjon forårsaket av silisiumskivens egenvekt på slipekvaliteten, og det er enkelt å sikre at slipeprosessforholdene på begge sider av enkrystallsilisiumskiven er de samme, og at slipepartiklene og slipeflisene ikke lett blir værende på overflaten av enkrystallsilisiumskiven. Det er en relativt ideell slipemetode.
Figur 4, «Feilkopiering» og slitasjedefekter ved rotasjonssliping av silisiumskiver
Figur 5, skjematisk diagram av dobbeltsidig slipeprinsipp
Tabell 1 viser sammenligningen mellom sliping og dobbeltsidig sliping av de tre ovennevnte typene enkrystall silisiumskiver. Dobbeltsidig sliping brukes hovedsakelig til prosessering av silisiumskiver under 200 mm, og har et høyt skiveutbytte. På grunn av bruken av faste slipeskiver kan sliping av enkrystall silisiumskiver oppnå en mye høyere overflatekvalitet enn dobbeltsidig sliping. Derfor kan både rotasjonssliping og dobbeltsidig sliping av silisiumskiver oppfylle kravene til prosesseringskvalitet for vanlige 300 mm silisiumskiver, og er for tiden de viktigste utflatingsmetodene. Når man velger en metode for utflating av silisiumskiver, er det nødvendig å vurdere kravene til diameterstørrelse, overflatekvalitet og poleringsteknologi for enkrystall silisiumskiveren grundig. Baktynning av skiven kan bare velges med ensidig prosesseringsmetode, for eksempel rotasjonssliping av silisiumskiver.
I tillegg til å velge slipemetode ved sliping av silisiumskiver, er det også nødvendig å bestemme valget av rimelige prosessparametere som positivt trykk, kornstørrelse på slipeskive, bindemiddel på slipeskive, hastighet på slipeskive, hastighet på silisiumskiver, viskositet og strømningshastighet på slipevæsken, etc., og bestemme en rimelig prosessrute. Vanligvis brukes en segmentert slipeprosess, inkludert grovsliping, halvfinishsliping, finsliping, gnistfri sliping og langsom baksliping, for å oppnå silisiumskiver med enkrystall med høy prosesseringseffektivitet, høy overflateflathet og lav overflateskade.
Ny slipeteknologi kan referere til litteraturen:

Figur 5, skjematisk diagram av TAIKO-slipeprinsippet
Figur 6, skjematisk diagram av slipeprinsippet for planetskive
Ultratynn wafersliping fortynningsteknologi:
Det finnes tynningsteknologi for sliping av waferbærere og kantslipingsteknologi (figur 5).
Publisert: 08.08.2024