უკანა პროცესის ეტაპზე,ვაფლი (სილიკონის ვაფლიწინა მხარეს სქემებით) საჭიროა უკანა მხრიდან გათხელება შემდგომი დაჭრამდე, შედუღებამდე და შეფუთვამდე, რათა შემცირდეს პაკეტის დამონტაჟების სიმაღლე, შემცირდეს ჩიპის პაკეტის მოცულობა, გაუმჯობესდეს ჩიპის თერმული დიფუზიის ეფექტურობა, ელექტრული მახასიათებლები, მექანიკური თვისებები და შემცირდეს დაჭრა. უკუღმა დაფქვას აქვს მაღალი ეფექტურობისა და დაბალი ღირებულების უპირატესობები. მან ჩაანაცვლა ტრადიციული სველი გრავირების და იონური გრავირების პროცესები და გახდა უკუღმა გათხელების ყველაზე მნიშვნელოვანი ტექნოლოგია.
გათხელებული ვაფლი
როგორ გავხდეთ გამხდარი?

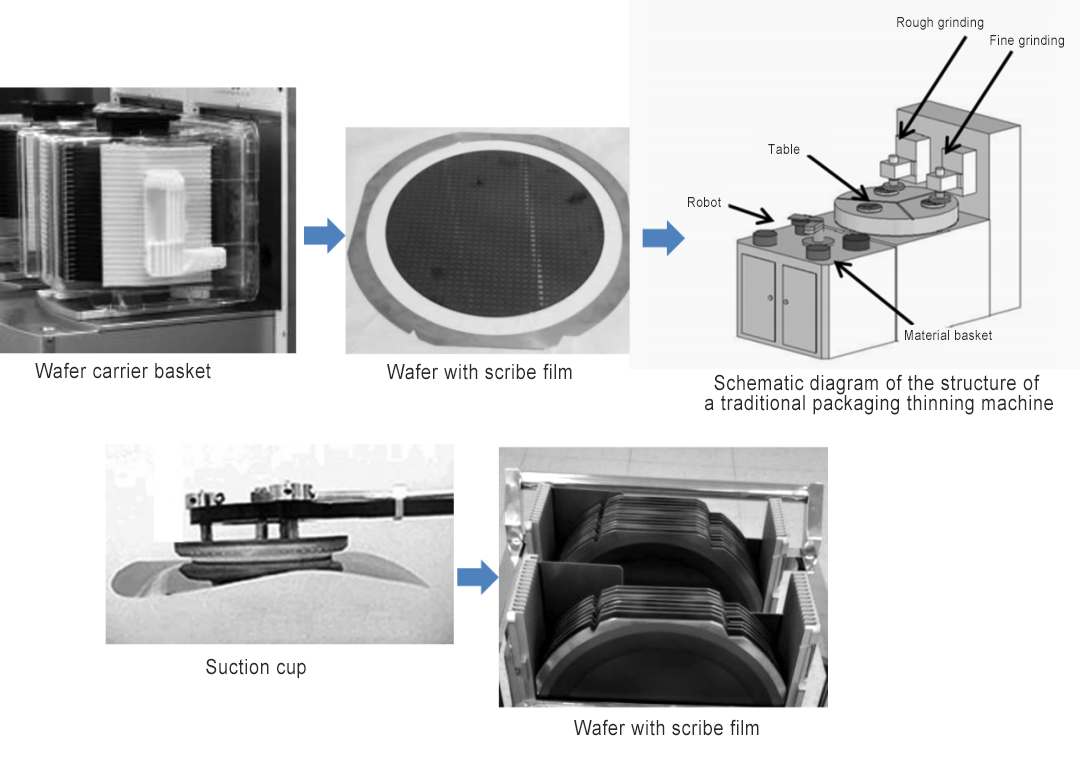 ვაფლის გათხელების ძირითადი პროცესი ტრადიციული შეფუთვის პროცესში
ვაფლის გათხელების ძირითადი პროცესი ტრადიციული შეფუთვის პროცესში
კონკრეტული ნაბიჯები,ვაფლიგათხელება გულისხმობს დასამუშავებელი ვაფლის გამთხელებელ ფენაზე მიმაგრებას, შემდეგ ვაკუუმის გამოყენებით გამთხელებელი ფენა და მასზე არსებული ნატეხი ფოროვან კერამიკულ ვაფლის მაგიდაზე ადსორბციას, ჭიქის ფორმის ალმასის სახეხი ბორბლის სამუშაო ზედაპირის შიდა და გარე წრიული ნავის ცენტრალური ხაზების სილიკონის ვაფლის ცენტრთან მორგებას, ხოლო სილიკონის ვაფლი და სახეხი ბორბალი ბრუნავენ თავიანთი შესაბამისი ღერძების გარშემო ჭრისა და დაფქვისთვის. დაფქვა მოიცავს სამ ეტაპს: უხეში დაფქვა, წვრილი დაფქვა და გაპრიალება.
ვაფლის ქარხნიდან გამომავალი ვაფლი იფქვება შეფუთვისთვის საჭირო სისქემდე, რათა გათხელდეს. ვაფლის დაფქვისას, წრედის დასაცავად, წინა მხარეს (აქტიური არე) უნდა დააკრათ ლენტი და ამავდროულად, უკანა მხარეც დაფქული იყოს. დაფქვის შემდეგ, მოხსენით ლენტი და გაზომეთ სისქე.
სილიკონის ვაფლის მოსამზადებლად წარმატებით გამოყენებული დაფქვის პროცესები მოიცავს როტაციულ მაგიდაზე დაფქვას,სილიკონის ვაფლიბრუნვითი დაფქვა, ორმხრივი დაფქვა და ა.შ. ერთკრისტალური სილიციუმის ვაფლების ზედაპირის ხარისხის მოთხოვნების შემდგომ გაუმჯობესებასთან ერთად, მუდმივად შემოთავაზებულია დაფქვის ახალი ტექნოლოგიები, როგორიცაა TAIKO დაფქვა, ქიმიური მექანიკური დაფქვა, გაპრიალების დაფქვა და პლანეტარული დისკის დაფქვა.
მბრუნავი მაგიდის სახეხი:
მბრუნავი მაგიდის დაფქვა (მბრუნავი მაგიდის დაფქვა) არის ადრეული დაფქვის პროცესი, რომელიც გამოიყენება სილიკონის ვაფლის მომზადებისა და უკუგათხელების დროს. მისი პრინციპი ნაჩვენებია ნახაზ 1-ში. სილიკონის ვაფლები ფიქსირდება მბრუნავი მაგიდის შემწოვ ჭიქებზე და ბრუნავს სინქრონულად მბრუნავი მაგიდის მამოძრავებელი ძალის ქვეშ. თავად სილიკონის ვაფლები არ ბრუნავს თავისი ღერძის გარშემო; სახეხი ბორბალი მაღალი სიჩქარით ბრუნვისას ღერძულად იკვებება და სახეხი ბორბლის დიამეტრი აღემატება სილიკონის ვაფლის დიამეტრს. მბრუნავი მაგიდის დაფქვის ორი ტიპი არსებობს: წინა ჩაძირვითი დაფქვა და წინა ტანგენციალური დაფქვა. წინა ჩაძირვითი დაფქვის დროს, სახეხი ბორბლის სიგანე აღემატება სილიკონის ვაფლის დიამეტრს და სახეხი ბორბლის ღერძი განუწყვეტლივ იკვებება მისი ღერძული მიმართულებით, სანამ ზედმეტი არ დამუშავდება, შემდეგ კი სილიკონის ვაფლი ბრუნავს მბრუნავი მაგიდის ამძრავის ქვეშ; წინა ტანგენციალური დაფქვის დროს, სახეხი ბორბალი იკვებება მისი ღერძული მიმართულებით და სილიკონის ვაფლი განუწყვეტლივ ბრუნავს მბრუნავი დისკის ამძრავის ქვეშ და დაფქვა სრულდება ორმხრივი მიწოდებით (ორმხრივი მიწოდებით) ან ცოცხით მიწოდებით (ცოცხით მიწოდებით).
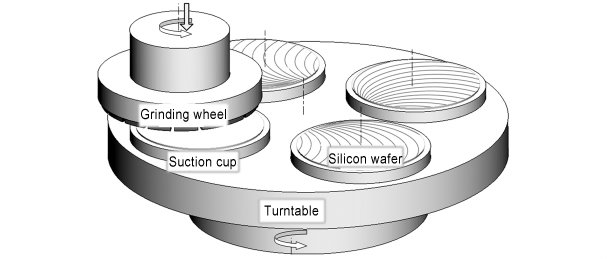
სურათი 1, მბრუნავი მაგიდის დაფქვის (წინა მხარის ტანგენციალური) პრინციპის სქემატური დიაგრამა
დაფქვის მეთოდთან შედარებით, მბრუნავი მაგიდის დაფქვის უპირატესობებს შორისაა მაღალი მოცილების სიჩქარე, ზედაპირის მცირე დაზიანება და მარტივი ავტომატიზაცია. თუმცა, დაფქვის პროცესში ფაქტობრივი დაფქვის არე (აქტიური დაფქვა) B და ჭრის კუთხე θ (სახეხი ბორბლის გარე წრესა და სილიკონის ვაფლის გარე წრეს შორის კუთხე) იცვლება სახეხი ბორბლის ჭრის პოზიციის ცვლილებასთან ერთად, რაც იწვევს არასტაბილურ დაფქვის ძალას, რაც ართულებს იდეალური ზედაპირის სიზუსტის მიღწევას (მაღალი TTV მნიშვნელობა) და ადვილად იწვევს დეფექტებს, როგორიცაა კიდის ჩამოშლა და კიდის ჩამოშლა. მბრუნავი მაგიდის დაფქვის ტექნოლოგია ძირითადად გამოიყენება 200 მმ-ზე ნაკლები ზომის ერთკრისტალური სილიკონის ვაფლების დასამუშავებლად. ერთკრისტალური სილიკონის ვაფლების ზომის ზრდამ წამოჭრა უფრო მაღალი მოთხოვნები აღჭურვილობის სამუშაო მაგიდის ზედაპირის სიზუსტისა და მოძრაობის სიზუსტის მიმართ, ამიტომ მბრუნავი მაგიდის დაფქვა არ არის შესაფერისი 300 მმ-ზე მეტი ზომის ერთკრისტალური სილიკონის ვაფლების დასაფქვად.
დაფქვის ეფექტურობის გასაუმჯობესებლად, კომერციული სიბრტყის ტანგენციალური დაფქვის მოწყობილობა, როგორც წესი, იყენებს მრავალსახეხი ბორბლის სტრუქტურას. მაგალითად, მოწყობილობაზე დამონტაჟებულია უხეში და წვრილი სახეხი ბორბლების ნაკრები, ხოლო მბრუნავი მაგიდა ბრუნავს ერთ წრეზე, რათა მონაცვლეობით დაასრულოს უხეში და წვრილი დაფქვა. ამ ტიპის მოწყობილობას მიეკუთვნება ამერიკული GTI კომპანიის G-500DS (სურათი 2).
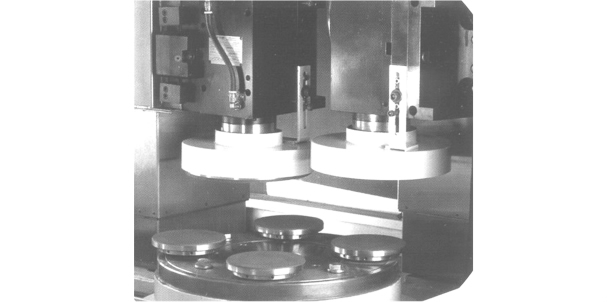
სურათი 2, GTI კომპანიის G-500DS მბრუნავი მაგიდის სახეხი მოწყობილობა ამერიკის შეერთებულ შტატებში
სილიკონის ვაფლის როტაციული დაფქვა:
დიდი ზომის სილიციუმის ვაფლის მომზადებისა და უკუგათხელების დამუშავების საჭიროებების დასაკმაყოფილებლად და კარგი TTV მნიშვნელობით ზედაპირის სიზუსტის მისაღწევად, 1988 წელს იაპონელმა მეცნიერმა მაცუიმ შემოგვთავაზა სილიციუმის ვაფლის ბრუნვითი დაფქვის (შეყვანის დაფქვის) მეთოდი. მისი პრინციპი ნაჩვენებია ნახაზ 3-ში. სამუშაო მაგიდაზე ადსორბირებული ერთკრისტალური სილიციუმის ვაფლი და ჭიქის ფორმის ალმასის სახეხი ბორბალი ბრუნავს თავიანთი შესაბამისი ღერძების გარშემო და სახეხი ბორბალი უწყვეტად მიეწოდება ღერძულ მიმართულებას ერთდროულად. მათ შორის, სახეხი ბორბლის დიამეტრი აღემატება დამუშავებული სილიციუმის ვაფლის დიამეტრს და მისი გარშემოწერილობა გადის სილიციუმის ვაფლის ცენტრში. დაფქვის ძალისა და დაფქვის სითბოს შესამცირებლად, ვაკუუმის შემწოვი ჭიქა ჩვეულებრივ იჭრება ამოზნექილ ან ჩაზნექილ ფორმაში ან სახეხი ბორბლის ღერძსა და შემწოვი თასის ღერძის ღერძს შორის კუთხე რეგულირდება, რათა უზრუნველყოფილი იყოს ნახევრადკონტაქტური დაფქვა სახეხ ბორბალსა და სილიციუმის ვაფლს შორის.

სურათი 3, სილიკონის ვაფლის მბრუნავი დაფქვის პრინციპის სქემატური დიაგრამა
მბრუნავ მაგიდისებრ დაფქვასთან შედარებით, სილიკონის ვაფლის მბრუნავ დაფქვას შემდეგი უპირატესობები აქვს: 1. ერთჯერადი ერთვაფლის დაფქვით შესაძლებელია 300 მმ-ზე მეტი ზომის სილიკონის ვაფლების დამუშავება; 2. ფაქტობრივი დაფქვის არე B და ჭრის კუთხე θ მუდმივია, ხოლო დაფქვის ძალა შედარებით სტაბილურია; 3. დაფქვის ბორბლის ღერძსა და სილიკონის ვაფლის ღერძს შორის დახრილობის კუთხის რეგულირებით, შესაძლებელია ერთკრისტალური სილიკონის ვაფლის ზედაპირის ფორმის აქტიურად კონტროლი ზედაპირის ფორმის უკეთესი სიზუსტის მისაღწევად. გარდა ამისა, სილიკონის ვაფლის მბრუნავი დაფქვის დაფქვის არე და ჭრის კუთხე θ ასევე გამოირჩევა დიდი ზღვრის დაფქვის, სისქისა და ზედაპირის ხარისხის მარტივი აღმოჩენისა და კონტროლის, კომპაქტური აღჭურვილობის სტრუქტურის, მარტივი მრავალსადგურიანი ინტეგრირებული დაფქვის და დაფქვის მაღალი ეფექტურობის უპირატესობებით.
წარმოების ეფექტურობის გასაუმჯობესებლად და ნახევარგამტარული წარმოების ხაზების საჭიროებების დასაკმაყოფილებლად, სილიციუმის ვაფლის როტაციული დაფქვის პრინციპზე დაფუძნებული კომერციული დაფქვის მოწყობილობა იყენებს მრავალშპინდლიან მრავალსადგურიან სტრუქტურას, რომელსაც შეუძლია უხეში და წვრილი დაფქვის დასრულება ერთი ჩატვირთვა-გადმოტვირთვისას. სხვა დამხმარე მოწყობილობებთან ერთად, მას შეუძლია განახორციელოს ერთკრისტალური სილიციუმის ვაფლის სრულად ავტომატური დაფქვა „გაშრობა/გაშრობა“ და „კასეტიდან კასეტამდე“.
ორმხრივი დაფქვა:
როდესაც სილიკონის ვაფლის როტაციული დაფქვა ამუშავებს სილიკონის ვაფლის ზედა და ქვედა ზედაპირებს, საჭიროა სამუშაო ნაწილის გადაბრუნება და ეტაპობრივად შესრულება, რაც ზღუდავს ეფექტურობას. ამავდროულად, სილიკონის ვაფლის როტაციულ დაფქვას აქვს ზედაპირული შეცდომები კოპირების (კოპირებული) და დაფქვის ნიშნები (grindingmark) და შეუძლებელია ეფექტურად აღმოფხვრას დეფექტები, როგორიცაა ტალღოვანება და კონუსურობა ერთკრისტალური სილიკონის ვაფლის ზედაპირზე მავთულის ჭრის (მრავალხერხიანი) შემდეგ, როგორც ეს ნაჩვენებია ნახაზ 4-ში. ზემოთ აღნიშნული დეფექტების აღმოსაფხვრელად, 1990-იან წლებში გამოჩნდა ორმხრივი დაფქვის ტექნოლოგია (doublesidegrinding), რომლის პრინციპი ნაჩვენებია ნახაზ 5-ში. ორივე მხარეს სიმეტრიულად განლაგებული დამჭერები ამაგრებენ ერთკრისტალურ სილიკონის ვაფლს შემაკავებელ რგოლში და ნელა ბრუნავენ ლილვაკის ამოძრავებით. თასის ფორმის ალმასის სახეხი ბორბლების წყვილი შედარებით განლაგებულია ერთკრისტალური სილიკონის ვაფლის ორივე მხარეს. ჰაერის საკისრის ელექტრო შპინდელის ამოძრავებით, ისინი ბრუნავენ საპირისპირო მიმართულებით და იკვებებიან ღერძულად, რათა მიაღწიონ ერთკრისტალურ სილიკონის ვაფლის ორმხრივ დაფქვას. როგორც ფიგურიდან ჩანს, ორმხრივი დაფქვით შესაძლებელია ეფექტურად მოხსნას ტალღები და კონუსურობა ერთკრისტალური სილიციუმის ვაფლის ზედაპირზე მავთულის ჭრის შემდეგ. სახეხი ბორბლის ღერძის განლაგების მიმართულების მიხედვით, ორმხრივი დაფქვით შესაძლებელია ჰორიზონტალური და ვერტიკალური დაფქვით. მათ შორის, ჰორიზონტალური ორმხრივი დაფქვით შესაძლებელია ეფექტურად შემცირდეს სილიციუმის ვაფლის დეფორმაციის გავლენა დაფქვის ხარისხზე, და ადვილია იმის უზრუნველყოფა, რომ დაფქვის პროცესის პირობები ერთკრისტალური სილიციუმის ვაფლის ორივე მხარეს ერთნაირი იყოს და აბრაზიული ნაწილაკები და დაფქვის ნატეხები ადვილად არ დარჩეს ერთკრისტალური სილიციუმის ვაფლის ზედაპირზე. ეს შედარებით იდეალური დაფქვის მეთოდია.
სურათი 4, „შეცდომით კოპირება“ და ცვეთის ნიშნების დეფექტები სილიკონის ვაფლის ბრუნვისას.
სურათი 5, ორმხრივი დაფქვის პრინციპის სქემატური დიაგრამა
ცხრილი 1 გვიჩვენებს ზემოთ ჩამოთვლილი სამი ტიპის ერთკრისტალური სილიციუმის ვაფლის დაფქვისა და ორმხრივი დაფქვის შედარებას. ორმხრივი დაფქვა ძირითადად გამოიყენება 200 მმ-ზე ნაკლები დიამეტრის სილიციუმის ვაფლის დასამუშავებლად და აქვს მაღალი მოსავლიანობა. ფიქსირებული აბრაზიული სახეხი ბორბლების გამოყენების გამო, ერთკრისტალური სილიციუმის ვაფლის დაფქვით შესაძლებელია გაცილებით მაღალი ზედაპირის ხარისხის მიღება, ვიდრე ორმხრივი დაფქვით. ამიტომ, როგორც სილიციუმის ვაფლის მბრუნავი დაფქვა, ასევე ორმხრივი დაფქვა აკმაყოფილებს 300 მმ-იანი სილიციუმის ვაფლის ძირითადი დამუშავების ხარისხის მოთხოვნებს და ამჟამად წარმოადგენს გაბრტყელების დამუშავების ყველაზე მნიშვნელოვან მეთოდს. სილიციუმის ვაფლის გაბრტყელების დამუშავების მეთოდის არჩევისას აუცილებელია ყოვლისმომცველი გათვალისწინება ერთკრისტალური სილიციუმის ვაფლის დიამეტრის ზომის, ზედაპირის ხარისხისა და გაპრიალების ვაფლის დამუშავების ტექნოლოგიის მოთხოვნების შესახებ. ვაფლის უკანა გათხელებისთვის შესაძლებელია მხოლოდ ცალმხრივი დამუშავების მეთოდის შერჩევა, როგორიცაა სილიციუმის ვაფლის მბრუნავი დაფქვის მეთოდი.
სილიკონის ვაფლის დაფქვისას დაფქვის მეთოდის შერჩევის გარდა, ასევე აუცილებელია ისეთი გონივრული პროცესის პარამეტრების შერჩევა, როგორიცაა დადებითი წნევა, სახეხი დისკის მარცვლის ზომა, სახეხი დისკის შემკვრელი, სახეხი დისკის სიჩქარე, სილიკონის ვაფლის სიჩქარე, დაფქვის სითხის სიბლანტე და ნაკადის სიჩქარე და ა.შ., და გონივრული პროცესის მარშრუტის განსაზღვრა. როგორც წესი, სეგმენტირებული დაფქვის პროცესი, რომელიც მოიცავს უხეშ დაფქვას, ნახევრად დამუშავების დაფქვას, დამუშავების დაფქვას, ნაპერწკლების გარეშე დაფქვას და ნელ უკან დაბრუნებას, გამოიყენება მაღალი დამუშავების ეფექტურობის, მაღალი ზედაპირის სიბრტყისა და ზედაპირის დაბალი დაზიანების მქონე ერთკრისტალური სილიკონის ვაფლების მისაღებად.
ახალი დაფქვის ტექნოლოგია შეიძლება ეხებოდეს ლიტერატურას:

სურათი 5, TAIKO-ს დაფქვის პრინციპის სქემატური დიაგრამა
სურათი 6, პლანეტარული დისკის დაფქვის პრინციპის სქემატური დიაგრამა
ულტრა თხელი ვაფლის დაფქვის გათხელების ტექნოლოგია:
არსებობს ვაფლის მატარებლის დაფქვის გათხელების ტექნოლოგია და კიდის დაფქვის ტექნოლოგია (სურათი 5).
გამოქვეყნების დრო: 2024 წლის 8 აგვისტო