Im Backend-Prozessstadium wirdWafer (Siliziumwafer(mit Schaltkreisen auf der Vorderseite) muss vor dem anschließenden Zerteilen, Schweißen und Verpacken auf der Rückseite dünner gemacht werden, um die Gehäusehöhe zu reduzieren, das Chipgehäusevolumen zu verringern, die Wärmediffusionseffizienz, die elektrische Leistung und die mechanischen Eigenschaften des Chips zu verbessern und den Zerteilaufwand zu reduzieren. Das Rückseitenschleifen bietet die Vorteile hoher Effizienz und geringer Kosten. Es hat die traditionellen Nassätz- und Ionenätzverfahren abgelöst und ist zur wichtigsten Technologie für die Rückseitendünnung geworden.
Die verdünnte Waffel
Wie dünnen?

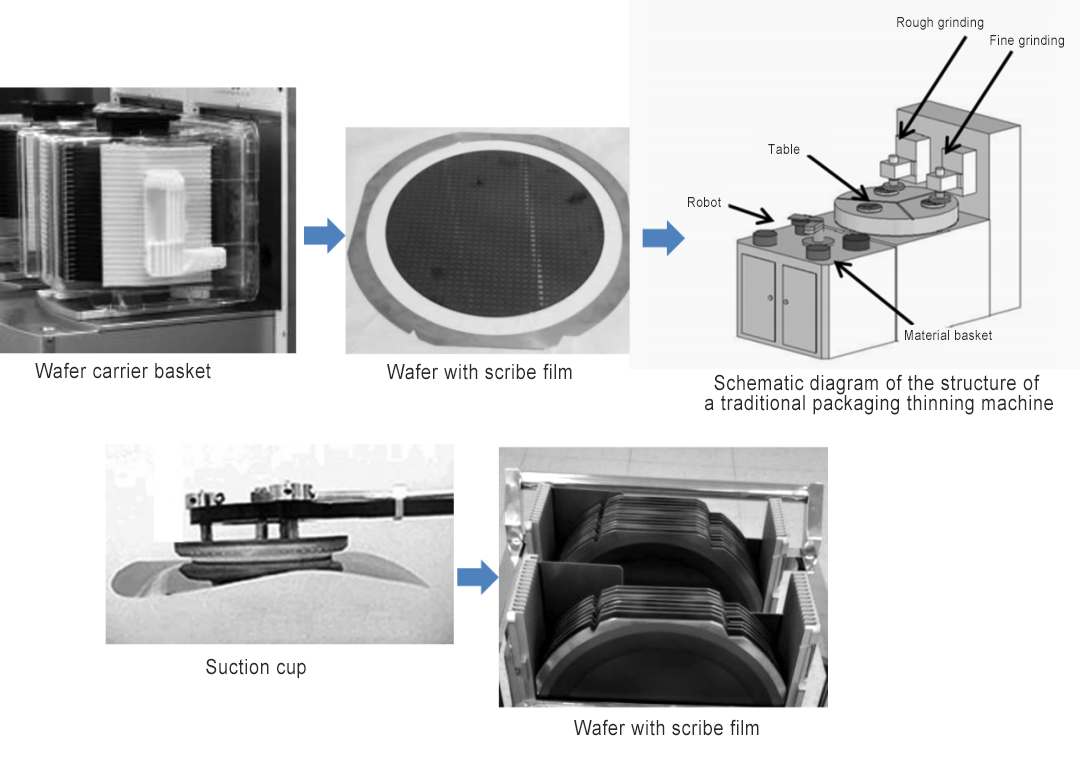 Hauptprozess der Waferverdünnung im traditionellen Verpackungsprozess
Hauptprozess der Waferverdünnung im traditionellen Verpackungsprozess
Die konkreten SchritteWaferBeim Dünnschleifen wird der zu bearbeitende Wafer mit der Dünnschicht verbunden. Anschließend werden die Dünnschicht und der darauf befindliche Chip mittels Vakuum auf dem porösen Keramik-Wafertisch fixiert. Die inneren und äußeren Kreismittellinien der Arbeitsfläche der becherförmigen Diamantschleifscheibe werden auf die Mitte des Siliziumwafers ausgerichtet. Siliziumwafer und Schleifscheibe rotieren zum Einschleifen um ihre jeweiligen Achsen. Das Schleifen umfasst drei Schritte: Grobschleifen, Feinschleifen und Polieren.
Der Wafer aus der Waferfabrik wird rückseitig geschliffen, um ihn auf die für die Verpackung erforderliche Dicke zu verdünnen. Beim Schleifen des Wafers muss auf der Vorderseite (aktiver Bereich) Klebeband angebracht werden, um den Schaltungsbereich zu schützen. Gleichzeitig wird die Rückseite geschliffen. Nach dem Schleifen wird das Klebeband entfernt und die Dicke gemessen.
Zu den Schleifprozessen, die erfolgreich bei der Herstellung von Siliziumwafern angewendet wurden, gehören Rundtischschleifen,SiliziumwaferRotationsschleifen, doppelseitiges Schleifen usw. Mit der weiteren Verbesserung der Anforderungen an die Oberflächenqualität von Einkristall-Silizium-Wafern werden ständig neue Schleiftechnologien vorgeschlagen, wie z. B. TAIKO-Schleifen, chemisch-mechanisches Schleifen, Polierschleifen und Planetenscheibenschleifen.
Rundtischschleifen:
Das Rundtischschleifen (Rundtischschleifen) ist ein frühes Schleifverfahren, das bei der Herstellung und Rückseitenverdünnung von Siliziumwafern verwendet wurde. Das Prinzip ist in Abbildung 1 dargestellt. Die Siliziumwafer werden auf den Saugnäpfen des Drehtisches befestigt und synchron vom Drehtisch angetrieben rotieren. Die Siliziumwafer selbst rotieren nicht um ihre Achse; die Schleifscheibe wird bei hoher Geschwindigkeit axial zugeführt, und ihr Durchmesser ist größer als der Durchmesser der Siliziumwafer. Es gibt zwei Arten des Rundtischschleifens: das Plan-Einstechschleifen und das Plan-Tangentialschleifen. Beim Plan-Einstechschleifen ist die Breite der Schleifscheibe größer als der Durchmesser der Siliziumwafer, und die Schleifscheibenspindel wird kontinuierlich axial zugeführt, bis der Überschuss abgearbeitet ist, und dann wird die Siliziumwafer durch den Antrieb des Drehtisches gedreht; beim Plan-Tangentialschleifen wird die Schleifscheibe axial zugeführt, und die Siliziumwafer wird durch den Antrieb der Drehscheibe kontinuierlich gedreht, und der Schleifvorgang wird durch Hin- und Herbewegung (Reziprokation) oder Kriechbewegung (Kriechvorschub) abgeschlossen.
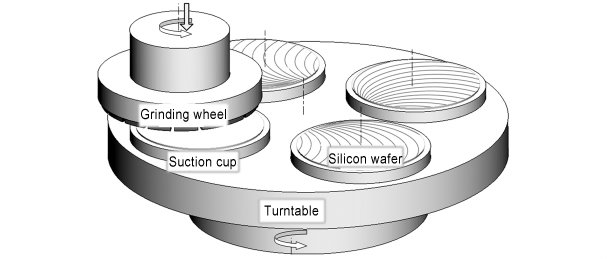
Abbildung 1, schematische Darstellung des Prinzips des Rundtischschleifens (Plantangentialschleifen)
Im Vergleich zum Schleifverfahren bietet das Rundtischschleifen die Vorteile einer hohen Abtragsrate, geringer Oberflächenschäden und einer einfachen Automatisierung. Allerdings ändern sich beim Schleifen die tatsächliche Schleiffläche (aktives Schleifen) B und der Einschnittwinkel θ (der Winkel zwischen dem äußeren Kreis der Schleifscheibe und dem äußeren Kreis des Siliziumwafers) mit der Änderung der Schneidposition der Schleifscheibe. Dies führt zu einer instabilen Schleifkraft, erschwert das Erreichen einer idealen Oberflächengenauigkeit (hoher TTV-Wert) und kann leicht zu Defekten wie Kanteneinbrüchen und Kantenkollaps führen. Die Rundtischschleiftechnologie wird hauptsächlich zur Bearbeitung von Einkristall-Siliziumwafern unter 200 mm verwendet. Mit der zunehmenden Größe von Einkristall-Siliziumwafern steigen die Anforderungen an die Oberflächengenauigkeit und die Bewegungsgenauigkeit der Gerätewerkbank, sodass das Rundtischschleifen zum Schleifen von Einkristall-Siliziumwafern über 300 mm nicht geeignet ist.
Um die Schleifleistung zu verbessern, verfügen kommerzielle Plan-Tangentialschleifmaschinen üblicherweise über eine Mehrscheibenkonstruktion. Sie sind beispielsweise mit einem Satz Schrupp- und einem Satz Feinschleifscheiben ausgestattet, und der Drehtisch dreht sich einmal um den Umfang, um abwechselnd Schrupp- und Feinschliff durchzuführen. Zu diesen Maschinen gehört beispielsweise die G-500DS der amerikanischen Firma GTI (Abbildung 2).
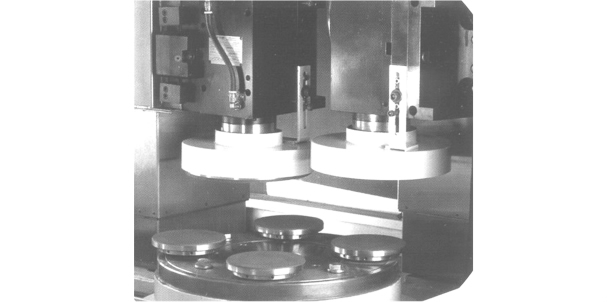
Abbildung 2: G-500DS-Rundtisch-Schleifanlage der GTI Company in den USA
Rotationsschleifen von Siliziumwafern:
Um den Anforderungen der Herstellung und Rückdünnung großer Siliziumwafer gerecht zu werden und eine Oberflächengenauigkeit mit gutem TTV-Wert zu erzielen, schlug der japanische Wissenschaftler Matsui 1988 ein Rotationsschleifverfahren (In-Feed-Grinding) für Siliziumwafer vor. Dessen Prinzip ist in Abbildung 3 dargestellt. Der einkristalline Siliziumwafer und eine becherförmige Diamantschleifscheibe, die auf einer Werkbank befestigt sind, rotieren um ihre jeweiligen Achsen, und die Schleifscheibe wird gleichzeitig kontinuierlich axial vorgeschoben. Der Durchmesser der Schleifscheibe ist größer als der Durchmesser des bearbeiteten Siliziumwafers und ihr Umfang verläuft durch die Mitte des Siliziumwafers. Um die Schleifkraft zu verringern und die Schleifwärme zu reduzieren, wird der Vakuumsaugnapf üblicherweise konvex oder konkav geformt, oder der Winkel zwischen der Schleifscheibenspindel und der Spindelachse des Saugnapfs wird so angepasst, dass ein Halbkontaktschleifen zwischen der Schleifscheibe und dem Siliziumwafer gewährleistet ist.

Abbildung 3: Schematische Darstellung des Rotationsschleifprinzips von Silizium-Wafern
Im Vergleich zum Rundtischschleifen bietet das Rundschleifen von Siliziumwafern folgende Vorteile: 1. Durch einmaliges Einzelwaferschleifen können große Siliziumwafer über 300 mm bearbeitet werden; 2. Die tatsächliche Schleiffläche B und der Schnittwinkel θ sind konstant und die Schleifkraft relativ stabil; 3. Durch Einstellen des Neigungswinkels zwischen der Schleifscheibenachse und der Siliziumwaferachse kann die Oberflächenform des Einkristall-Siliziumwafers aktiv gesteuert werden, um eine höhere Oberflächenpräzision zu erzielen. Darüber hinaus bieten die Schleiffläche und der Schnittwinkel θ des Rundschleifens von Siliziumwafern weitere Vorteile wie großes Schleifspiel, einfache Online-Erkennung und -Kontrolle von Dicke und Oberflächenqualität, kompakte Gerätestruktur, einfaches integriertes Schleifen mit mehreren Stationen und hohe Schleifeffizienz.
Um die Produktionseffizienz zu verbessern und den Anforderungen von Halbleiterproduktionslinien gerecht zu werden, verfügen kommerzielle Schleifanlagen, die auf dem Prinzip des Rotationsschleifens von Siliziumwafern basieren, über eine Mehrspindel-Mehrstationen-Struktur, die Grob- und Feinschliff in einem Be- und Entladevorgang ermöglicht. In Kombination mit weiteren Zusatzeinrichtungen ist das vollautomatische Schleifen von Einkristall-Siliziumwafern im „Dry-In/Dry-Out“- und „Kassette-zu-Kassette“-Verfahren möglich.
Doppelseitiges Schleifen:
Beim Rotationsschleifen von Siliziumwafern muss beim Bearbeiten der Ober- und Unterseite des Wafers das Werkstück gedreht und schrittweise bearbeitet werden, was die Effizienz einschränkt. Gleichzeitig entstehen beim Rotationsschleifen von Siliziumwafern Oberflächenfehler wie Kopierspuren und Schleifspuren. Defekte wie Welligkeit und Konizität auf der Oberfläche des Einkristall-Siliziumwafers lassen sich nach dem Drahtschneiden (Mehrsägen) nicht wirksam entfernen, wie in Abbildung 4 dargestellt. Zur Behebung dieser Mängel wurde in den 1990er Jahren die Technologie des doppelseitigen Schleifens entwickelt, deren Prinzip in Abbildung 5 dargestellt ist. Symmetrisch auf beiden Seiten verteilte Klemmen klemmen den Einkristall-Siliziumwafer in einem Haltering ein und drehen sich langsam, angetrieben von einer Rolle. Ein Paar becherförmiger Diamantschleifräder befindet sich relativ zueinander auf beiden Seiten des Einkristall-Siliziumwafers. Angetrieben von einer luftgelagerten elektrischen Spindel drehen sie sich in entgegengesetzte Richtungen und werden axial vorgeschoben, um das beidseitige Schleifen des Einkristall-Siliziumwafers zu erreichen. Wie aus der Abbildung ersichtlich, kann doppelseitiges Schleifen Welligkeit und Konizität auf der Oberfläche von Einkristall-Siliziumwafern nach dem Drahtschneiden effektiv beseitigen. Je nach Ausrichtung der Schleifscheibenachse kann das doppelseitige Schleifen horizontal oder vertikal erfolgen. Horizontales doppelseitiges Schleifen reduziert den Einfluss der durch das Eigengewicht des Wafers verursachten Verformung auf die Schleifqualität effektiv. Gleichzeitig werden auf beiden Seiten des Einkristall-Siliziumwafers gleiche Schleifbedingungen gewährleistet, sodass Schleifpartikel und Schleifspäne nicht so leicht auf der Oberfläche des Einkristall-Siliziumwafers haften bleiben. Es handelt sich um ein relativ ideales Schleifverfahren.
Abbildung 4, „Fehlerkopie“ und Verschleißspurdefekte beim Rotationsschleifen von Silizium-Wafern
Abbildung 5, schematische Darstellung des doppelseitigen Schleifprinzips
Tabelle 1 zeigt den Vergleich zwischen dem Schleifen und dem beidseitigen Schleifen der drei oben genannten Arten von Einkristall-Siliziumwafern. Das beidseitige Schleifen wird hauptsächlich zur Bearbeitung von Siliziumwafern unter 200 mm verwendet und hat eine hohe Waferausbeute. Durch die Verwendung von festen Schleifscheiben kann beim Schleifen von Einkristall-Siliziumwafern eine wesentlich höhere Oberflächenqualität erzielt werden als beim beidseitigen Schleifen. Daher können sowohl das Rotationsschleifen als auch das beidseitige Schleifen von Siliziumwafern die Anforderungen an die Bearbeitungsqualität gängiger 300-mm-Siliziumwafer erfüllen und sind derzeit die wichtigsten Glättungsverfahren. Bei der Auswahl eines Glättungsverfahrens für Siliziumwafer müssen die Anforderungen an Durchmesser, Oberflächenqualität und Poliertechnologie des Einkristall-Siliziumwafers umfassend berücksichtigt werden. Zum Rückdünnen des Wafers kann nur ein einseitiges Bearbeitungsverfahren wie das Rotationsschleifen von Siliziumwafern ausgewählt werden.
Neben der Auswahl des Schleifverfahrens beim Schleifen von Siliziumwafern müssen auch geeignete Prozessparameter wie Überdruck, Schleifscheibenkorngröße, Schleifscheibenbindemittel, Schleifscheibengeschwindigkeit, Siliziumwafergeschwindigkeit, Viskosität und Durchflussrate der Schleifflüssigkeit usw. ausgewählt und ein geeigneter Prozessablauf festgelegt werden. Normalerweise wird ein segmentierter Schleifprozess verwendet, der Grobschleifen, Vorschlichten, Feinschleifen, funkenfreies Schleifen und langsames Unterschleifen umfasst, um einkristalline Siliziumwafer mit hoher Verarbeitungseffizienz, hoher Oberflächenebenheit und geringer Oberflächenbeschädigung zu erhalten.
Neue Schleiftechnologie kann auf die Literatur verweisen:

Abbildung 5, schematische Darstellung des TAIKO-Mahlprinzips
Abbildung 6, schematische Darstellung des Prinzips des Planetenscheibenschleifens
Technologie zum Schleifen ultradünner Wafer:
Es gibt Waferträger-Schleifdünntechnologie und Kantenschleiftechnologie (Abbildung 5).
Beitragszeit: 08.08.2024