Trong giai đoạn xử lý hậu kỳ,bánh xốp (tấm siliconvới mạch ở mặt trước) cần được làm mỏng ở mặt sau trước khi cắt, hàn và đóng gói tiếp theo để giảm chiều cao lắp gói, giảm thể tích gói chip, cải thiện hiệu suất khuếch tán nhiệt của chip, hiệu suất điện, tính chất cơ học và giảm lượng cắt. Mài ngược có ưu điểm là hiệu quả cao và chi phí thấp. Nó đã thay thế các quy trình khắc ướt và khắc ion truyền thống để trở thành công nghệ làm mỏng mặt sau quan trọng nhất.
Bánh wafer mỏng
Làm thế nào để làm loãng?

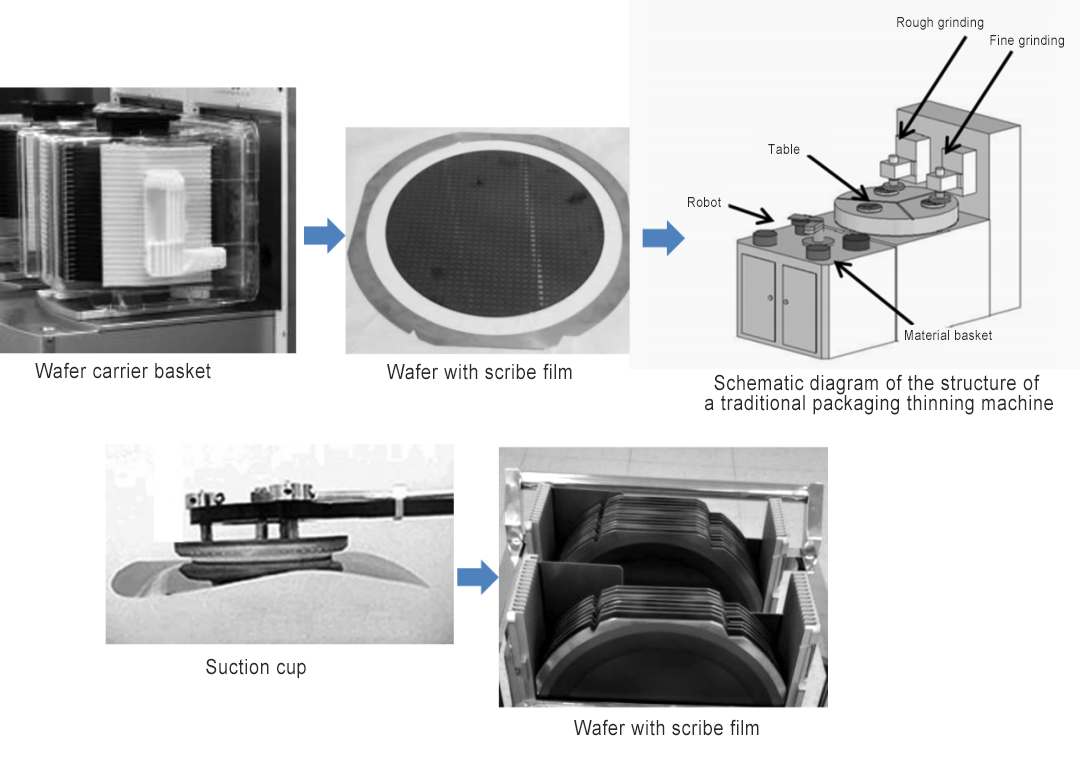 Quy trình chính của quá trình làm mỏng wafer trong quy trình đóng gói truyền thống
Quy trình chính của quá trình làm mỏng wafer trong quy trình đóng gói truyền thống
Các bước cụ thể củabánh xốpquá trình làm mỏng là liên kết wafer cần xử lý với màng mỏng, sau đó sử dụng chân không để hấp thụ màng mỏng và chip trên đó vào bàn wafer gốm xốp, điều chỉnh các đường tâm thuyền tròn bên trong và bên ngoài của bề mặt làm việc của bánh mài kim cương hình cốc đến tâm của wafer silicon, và wafer silicon và bánh mài quay quanh trục tương ứng của chúng để mài cắt. Mài bao gồm ba giai đoạn: mài thô, mài mịn và đánh bóng.
Tấm wafer ra khỏi nhà máy wafer được mài ngược để làm mỏng wafer đến độ dày cần thiết để đóng gói. Khi mài wafer, cần dán băng dính vào mặt trước (Khu vực hoạt động) để bảo vệ khu vực mạch và mặt sau được mài cùng lúc. Sau khi mài, tháo băng dính ra và đo độ dày.
Các quy trình nghiền đã được áp dụng thành công để chế tạo tấm silicon bao gồm nghiền bàn quay,tấm siliconmài quay, mài hai mặt, v.v. Với việc cải thiện hơn nữa các yêu cầu về chất lượng bề mặt của tấm silicon đơn tinh thể, các công nghệ mài mới liên tục được đề xuất, chẳng hạn như mài TAIKO, mài cơ học hóa học, mài đánh bóng và mài đĩa hành tinh.
Mài bàn quay:
Mài bàn quay (mài bàn quay) là một quá trình mài sớm được sử dụng trong chế tạo wafer silicon và làm mỏng mặt sau. Nguyên lý của nó được thể hiện trong Hình 1. Các wafer silicon được cố định trên các cốc hút của bàn quay và quay đồng bộ được điều khiển bởi bàn quay. Bản thân các wafer silicon không quay quanh trục của chúng; bánh mài được đưa vào theo trục trong khi quay với tốc độ cao và đường kính của bánh mài lớn hơn đường kính của wafer silicon. Có hai loại mài bàn quay: mài nhúng mặt và mài tiếp tuyến mặt. Trong quá trình mài nhúng mặt, chiều rộng của bánh mài lớn hơn đường kính wafer silicon và trục chính của bánh mài liên tục đưa vào theo hướng trục của nó cho đến khi phần thừa được xử lý, sau đó wafer silicon được quay dưới ổ đĩa của bàn quay; trong quá trình mài tiếp tuyến mặt, bánh mài đưa vào theo hướng trục của nó và wafer silicon được quay liên tục dưới ổ đĩa của đĩa quay và quá trình mài được hoàn thành bằng cách đưa vào qua lại (qua lại) hoặc đưa vào từ từ (creepfeed).
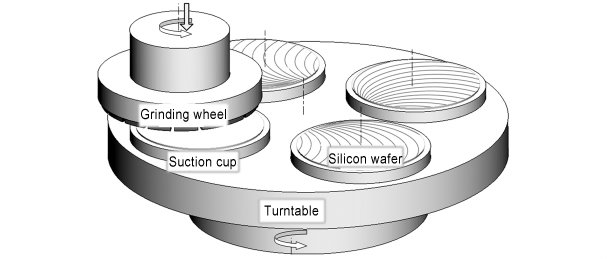
Hình 1, sơ đồ nguyên lý mài bàn quay (mặt tiếp tuyến)
So với phương pháp mài, mài bàn quay có ưu điểm là tốc độ loại bỏ cao, hư hỏng bề mặt nhỏ và dễ tự động hóa. Tuy nhiên, diện tích mài thực tế (mài chủ động) B và góc cắt θ (góc giữa vòng tròn ngoài của bánh mài và vòng tròn ngoài của wafer silicon) trong quá trình mài thay đổi theo sự thay đổi vị trí cắt của bánh mài, dẫn đến lực mài không ổn định, khiến khó đạt được độ chính xác bề mặt lý tưởng (giá trị TTV cao) và dễ gây ra các khuyết tật như sụp cạnh và sụp cạnh. Công nghệ mài bàn quay chủ yếu được sử dụng để gia công wafer silicon đơn tinh thể dưới 200mm. Sự gia tăng kích thước của wafer silicon đơn tinh thể đã đưa ra các yêu cầu cao hơn về độ chính xác bề mặt và độ chính xác chuyển động của bàn làm việc của thiết bị, do đó, mài bàn quay không phù hợp để mài wafer silicon đơn tinh thể trên 300mm.
Để nâng cao hiệu suất nghiền, thiết bị nghiền tiếp tuyến mặt phẳng thương mại thường sử dụng kết cấu bánh mài nhiều tầng. Ví dụ, thiết bị được trang bị một bộ bánh mài thô và một bộ bánh mài mịn, bàn quay quay một vòng để hoàn thành quá trình nghiền thô và nghiền mịn lần lượt. Loại thiết bị này bao gồm G-500DS của Công ty GTI Hoa Kỳ (Hình 2).
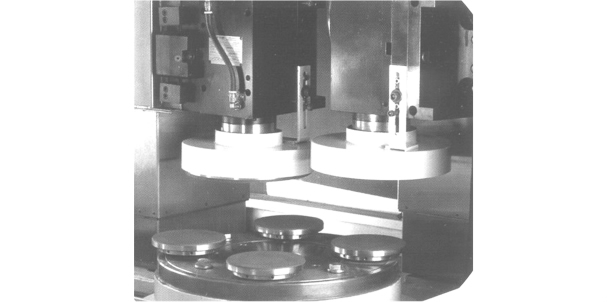
Hình 2, Thiết bị mài bàn quay G-500DS của Công ty GTI tại Hoa Kỳ
Mài xoay wafer silicon:
Để đáp ứng nhu cầu chế tạo wafer silicon kích thước lớn và gia công làm mỏng mặt sau, và đạt được độ chính xác bề mặt với giá trị TTV tốt. Năm 1988, học giả người Nhật Matsui đã đề xuất phương pháp mài xoay wafer silicon (in-feedgrinding). Nguyên lý của nó được thể hiện trong Hình 3. wafer silicon đơn tinh thể và bánh mài kim cương hình cốc được hấp phụ trên bàn làm việc quay quanh trục tương ứng của chúng và bánh mài liên tục được đưa vào theo hướng trục cùng một lúc. Trong số đó, đường kính của bánh mài lớn hơn đường kính của wafer silicon đã xử lý và chu vi của nó đi qua tâm của wafer silicon. Để giảm lực nghiền và giảm nhiệt nghiền, cốc hút chân không thường được cắt thành hình lồi hoặc lõm hoặc góc giữa trục bánh mài và trục trục cốc hút được điều chỉnh để đảm bảo mài bán tiếp xúc giữa bánh mài và wafer silicon.

Hình 3, Sơ đồ nguyên lý nghiền quay wafer silicon
So với mài bàn quay, mài quay wafer silicon có những ưu điểm sau: ① Mài wafer đơn một lần có thể xử lý wafer silicon kích thước lớn hơn 300mm; ② Diện tích mài thực tế B và góc cắt θ là hằng số, lực mài tương đối ổn định; ③ Bằng cách điều chỉnh góc nghiêng giữa trục bánh mài và trục wafer silicon, có thể kiểm soát chủ động hình dạng bề mặt của wafer silicon đơn tinh thể để có được độ chính xác hình dạng bề mặt tốt hơn. Ngoài ra, diện tích mài và góc cắt θ của mài wafer silicon quay cũng có những ưu điểm là mài biên độ lớn, dễ dàng phát hiện và kiểm soát độ dày trực tuyến và chất lượng bề mặt, cấu trúc thiết bị nhỏ gọn, dễ dàng mài tích hợp nhiều trạm và hiệu suất mài cao.
Để nâng cao hiệu quả sản xuất và đáp ứng nhu cầu của dây chuyền sản xuất chất bán dẫn, thiết bị nghiền thương mại dựa trên nguyên lý nghiền quay wafer silicon áp dụng cấu trúc nhiều trục chính nhiều trạm, có thể hoàn thành quá trình nghiền thô và nghiền mịn trong một lần nạp và dỡ. Kết hợp với các thiết bị phụ trợ khác, có thể thực hiện quá trình nghiền hoàn toàn tự động các wafer silicon đơn tinh thể "khô vào/khô ra" và "băng cassette sang băng cassette".
Mài hai mặt:
Khi quá trình mài quay wafer silicon xử lý bề mặt trên và dưới của wafer silicon, phôi cần được lật lại và thực hiện theo từng bước, điều này hạn chế hiệu quả. Đồng thời, quá trình mài quay wafer silicon có lỗi bề mặt sao chép (copied) và vết mài (grindingmark), và không thể loại bỏ hiệu quả các khuyết tật như độ gợn sóng và độ côn trên bề mặt của wafer silicon đơn tinh thể sau khi cắt dây (multi-saw), như thể hiện trong Hình 4. Để khắc phục các khuyết tật trên, công nghệ mài hai mặt (doublesidegrinding) đã xuất hiện vào những năm 1990 và nguyên lý của nó được thể hiện trong Hình 5. Các kẹp phân bố đối xứng ở cả hai bên kẹp wafer silicon đơn tinh thể vào vòng giữ và quay chậm được dẫn động bởi con lăn. Một cặp bánh mài kim cương hình cốc được đặt tương đối ở cả hai bên của wafer silicon đơn tinh thể. Được dẫn động bởi trục chính điện mang khí, chúng quay theo các hướng ngược nhau và đưa vào theo trục để đạt được quá trình mài hai mặt của wafer silicon đơn tinh thể. Như có thể thấy từ hình, mài hai mặt có thể loại bỏ hiệu quả độ gợn sóng và độ côn trên bề mặt của wafer silicon đơn tinh thể sau khi cắt dây. Theo hướng sắp xếp của trục bánh mài, mài hai mặt có thể là theo chiều ngang và chiều dọc. Trong số đó, mài hai mặt theo chiều ngang có thể làm giảm hiệu quả ảnh hưởng của biến dạng wafer silicon do trọng lượng chết của wafer silicon gây ra đối với chất lượng mài và dễ dàng đảm bảo rằng các điều kiện quy trình mài ở cả hai mặt của wafer silicon đơn tinh thể là như nhau và các hạt mài mòn và phoi mài không dễ bám trên bề mặt của wafer silicon đơn tinh thể. Đây là phương pháp mài tương đối lý tưởng.
Hình 4, "Lỗi sao chép" và các khuyết tật về dấu hiệu mài mòn trong quá trình mài xoay wafer silicon
Hình 5, sơ đồ nguyên lý mài hai mặt
Bảng 1 cho thấy sự so sánh giữa mài và mài hai mặt của ba loại wafer silicon đơn tinh thể trên. Mài hai mặt chủ yếu được sử dụng để gia công wafer silicon dưới 200mm và có năng suất wafer cao. Do sử dụng bánh mài mài mòn cố định, việc mài wafer silicon đơn tinh thể có thể đạt được chất lượng bề mặt cao hơn nhiều so với mài hai mặt. Do đó, cả mài quay wafer silicon và mài hai mặt đều có thể đáp ứng các yêu cầu về chất lượng gia công của wafer silicon 300mm chính thống và hiện là phương pháp gia công làm phẳng quan trọng nhất. Khi lựa chọn phương pháp gia công làm phẳng wafer silicon, cần phải xem xét toàn diện các yêu cầu về kích thước đường kính, chất lượng bề mặt và công nghệ gia công wafer đánh bóng của wafer silicon đơn tinh thể. Việc làm mỏng mặt sau của wafer chỉ có thể lựa chọn phương pháp gia công một mặt, chẳng hạn như phương pháp mài quay wafer silicon.
Ngoài việc lựa chọn phương pháp nghiền trong quá trình nghiền wafer silicon, cũng cần phải xác định lựa chọn các thông số quy trình hợp lý như áp suất dương, kích thước hạt bánh mài, chất kết dính bánh mài, tốc độ bánh mài, tốc độ wafer silicon, độ nhớt và lưu lượng chất lỏng nghiền, v.v. và xác định lộ trình quy trình hợp lý. Thông thường, một quy trình nghiền phân đoạn bao gồm nghiền thô, nghiền bán hoàn thiện, nghiền hoàn thiện, nghiền không có tia lửa và nghiền chậm được sử dụng để thu được wafer silicon đơn tinh thể có hiệu suất xử lý cao, độ phẳng bề mặt cao và hư hỏng bề mặt thấp.
Công nghệ mài mới có thể tham khảo tài liệu:

Hình 5, sơ đồ nguyên lý nghiền TAIKO
Hình 6, sơ đồ nguyên lý nghiền đĩa hành tinh
Công nghệ nghiền wafer siêu mỏng:
Có công nghệ mài mỏng giá đỡ wafer và công nghệ mài cạnh (Hình 5).
Thời gian đăng: 08-08-2024