An der Backend-Prozessphase,Wafer (Siliziumwafermat Schaltkreesser op der viischter Säit) muss op der Récksäit verdënnt ginn, ier et spéider zu Wierfelen, Schweessen a Verpackung geet, fir d'Héicht vun der Montage vum Pak ze reduzéieren, de Volume vum Chip-Pak ze reduzéieren, d'thermesch Diffusiounseffizienz vum Chip, d'elektresch Leeschtung, d'mechanesch Eegeschafte vum Chip ze verbesseren an d'Quantitéit vum Wierfelen ze reduzéieren. Récksleifen huet d'Virdeeler vun héijer Effizienz a niddrege Käschten. Et huet déi traditionell Naassätz- an Ionenätzprozesser ersat an ass déi wichtegst Réckverdënnungstechnologie ginn.
Déi verdënnte Wafer
Wéi dënn ze ginn?

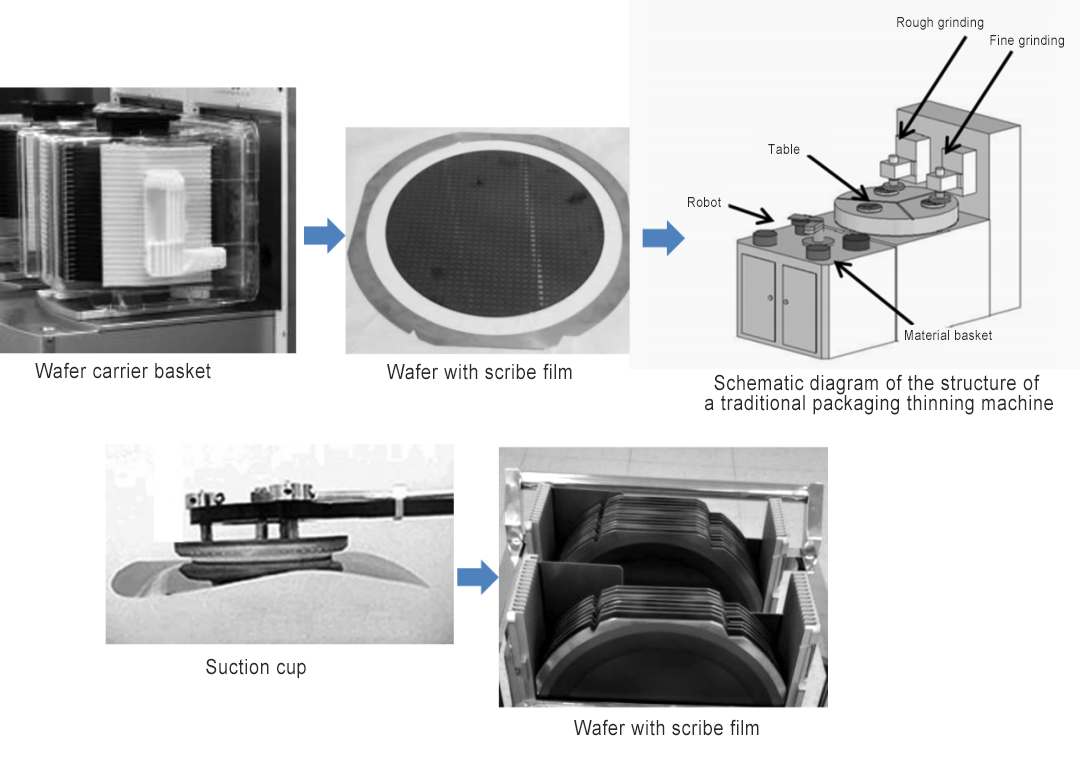 Haaptprozess vun der Waferverdënnung am traditionellen Verpackungsprozess
Haaptprozess vun der Waferverdënnung am traditionellen Verpackungsprozess
Déi spezifesch Schrëtt vunWaferD'Ausdënnung besteet doran, de ze veraarbechte Wafer un d'Ausdënnungsfilm ze bannen, an dann de Vakuum ze benotzen, fir d'Ausdënnungsfilm an de Chip drop un den porösen Keramikwafer-Dësch ze adsorbéieren, déi bannenzeg an baussenzeg kreesfërmeg Bootszentrumlinnen vun der Aarbechtsfläch vun der becherfërmeger Diamant-Schleifscheif op d'Mëtt vum Siliziumwafer unzepassen, an de Siliziumwafer an d'Schleifscheif dréine sech ëm hir jeeweileg Achsen fir d'Inschleifen. D'Schleifen ëmfaasst dräi Etappen: Grobschleifen, Feinschleifen a Poléieren.
De Wafer, deen aus der Waferfabréck kënnt, gëtt zréckgeschleeft, fir de Wafer op déi néideg Déckt ze verdënnen, déi fir d'Verpakung erfuerderlech ass. Beim Schleife vum Wafer muss Klebeband op der viischter Säit (aktiv Fläch) ugewannt ginn, fir de Circuitberäich ze schützen, an d'Récksäit gëtt gläichzäiteg geschleeft. Nom Schleifen, huelt de Klebeband ewech a moosst d'Déckt.
Zu de Schleifprozesser, déi erfollegräich fir d'Virbereedung vu Siliziumwafer ugewannt goufen, gehéieren d'Schleifen vun engem Rotatiounsdësch,SiliziumwaferRotatiounsschleifen, zweesäiteg Schleifen, etc. Mat der weiderer Verbesserung vun den Ufuerderunge un d'Uewerflächenqualitéit vun Eenkristall-Siliciumwaferen ginn stänneg nei Schleiftechnologien proposéiert, wéi TAIKO-Schleifen, chemesch-mechanescht Schleifen, Polierschleifen a Planéitescheiwenschleifen.
Rotatiounsdësch Schleifen:
D'Schleifen um Rotatiounsdësch (Rotatiounsdëschschleifen) ass en fréie Schleifprozess, deen an der Virbereedung a beim Réckverdënnen vu Siliziumwafer benotzt gouf. Säi Prinzip gëtt an der Figur 1 gewisen. D'Siliziumwafer sinn op de Saugnäppchen vum rotéierenden Dësch fixéiert a rotéiere synchron vum rotéierenden Dësch ugedriwwen. D'Siliziumwafer selwer rotéieren net ëm hir Achs; d'Schleifscheif gëtt axial gefiddert, während se mat héijer Geschwindegkeet rotéiert, an den Duerchmiesser vun der Schleifscheif ass méi grouss wéi den Duerchmiesser vun der Siliziumwafer. Et ginn zwou Zorte vu Rotatiounsdëschschleifen: Véierelschleifen a Véierel-Tangentialschleifen. Beim Véierelschleifen ass d'Breet vun der Schleifscheif méi grouss wéi den Duerchmiesser vum Siliziumwafer, an d'Spindel vun der Schleifscheif fiddert kontinuéierlech an hirer axialer Richtung bis den Iwwerfloss veraarbecht ass, an dann gëtt de Siliziumwafer ënner dem Undriff vun der rotéierender Scheif gedréit; beim Véierel-Tangentialschleifen fiddert d'Schleifscheif an hirer axialer Richtung, an de Siliziumwafer gëtt kontinuéierlech ënner dem Undriff vun der rotéierender Scheif gedréit, an d'Schleifen gëtt duerch eng hin- an hierféierend Fidderung (Hin- an hierféierend) oder eng Schleiffidderung (Schleiffidderung) ofgeschloss.
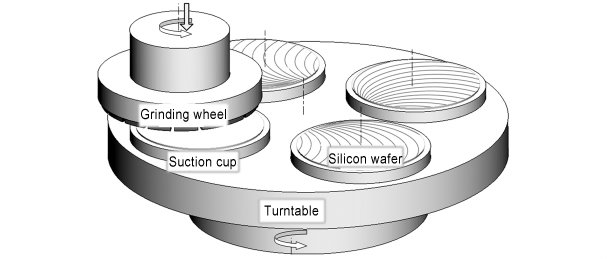
Figur 1, schematescht Diagramm vum Prinzip vun der Schleifung vun der Rotatiounsdësch (tangential Fläch)
Am Verglach mat der Schleifmethod huet d'Schleifen um Drehdësch d'Virdeeler vun enger héijer Ofholquote, klenge Uewerflächeschued an einfacher Automatiséierung. Wéi och ëmmer, änneren sech déi tatsächlech Schleiffläch (aktivt Schleifen) B an de Schnëttwénkel θ (de Wénkel tëscht dem äusseren Krees vun der Schleifscheif an dem äusseren Krees vun der Siliziumwafer) am Schleifprozess mat der Ännerung vun der Schnëttpositioun vun der Schleifscheif, wat zu enger onstabiler Schleifkraaft féiert, wat et schwéier mécht, déi ideal Uewerflächengenauegkeet (héijen TTV-Wäert) z'erreechen, a liicht Defekter wéi Kantenkollaps a Kantenkollaps verursaache kann. D'Schleiftechnologie um Drehdësch gëtt haaptsächlech fir d'Veraarbechtung vun Eenkristall-Siliziumwaferen ënner 200 mm benotzt. D'Erhéijung vun der Gréisst vun den Eenkristall-Siliziumwaferen huet méi héich Ufuerderungen un d'Uewerflächengenauegkeet an d'Beweegungsgenauegkeet vun der Ausrüstungsarbechtsbank gestallt, sou datt d'Schleifen um Drehdësch net gëeegent ass fir d'Schleifen vun Eenkristall-Siliziumwaferen iwwer 300 mm.
Fir d'Schleifeffizienz ze verbesseren, benotzen kommerziell flaach tangential Schleifanlagen normalerweis eng Struktur mat verschiddene Schleifrieder. Zum Beispill sinn e Set vu Grobschleifrieder an e Set vu Feinschleifrieder um Apparat ausgestatt, an den Dréidësch dréit sech ëm ee Krees fir d'Grobschleifen an d'Feinschleifen ofzeschléissen. Zu dëser Zort vun Apparat gehéiert d'G-500DS vun der amerikanescher GTI Company (Figur 2).
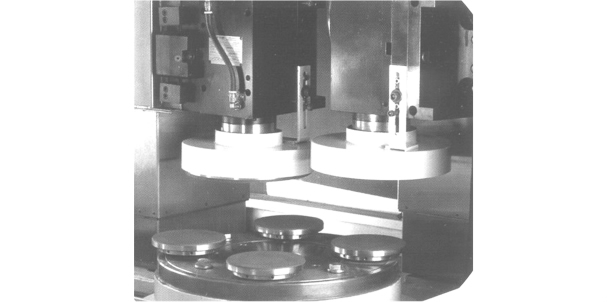
Figur 2, G-500DS Rotatiounsdëschschleifanlag vun der GTI Company an den USA
Rotatiounsschleifen vu Siliziumwafer:
Fir d'Bedierfnesser vun der Virbereedung a Verdënnung vu grousse Siliziumwaferen ze erfëllen an eng Uewerflächengenauegkeet mat engem gudden TTV-Wäert ze kréien, huet de japanesche Wëssenschaftler Matsui am Joer 1988 eng Rotatiounsschleifmethod (In-Feedgrinding) fir Siliziumwaferen virgeschloen. Säi Prinzip gëtt an der Figur 3 gewisen. De Siliziumwafer an d'becherfërmeg Diamantschleifscheif, déi op der Aarbechtsbank adsorbéiert sinn, dréie sech ëm hir jeeweileg Achsen, an d'Schleifscheif gëtt gläichzäiteg kontinuéierlech an der axialer Richtung gefiddert. Dorënner ass den Duerchmiesser vun der Schleifscheif méi grouss wéi den Duerchmiesser vum veraarbechte Siliziumwafer, an hiren Ëmfang geet duerch d'Mëtt vum Siliziumwafer. Fir d'Schleifkraaft an d'Schleifhëtzt ze reduzéieren, gëtt de Vakuumsaugnapp normalerweis an eng konkav oder konkav Form geschnidden oder de Wénkel tëscht der Spindel vun der Schleifscheif an der Spindelachs vun der Saugnapp ugepasst fir e Semi-Kontaktschleifen tëscht der Schleifscheif an dem Siliziumwafer ze garantéieren.

Figur 3, Schematesch Duerstellung vum Rotatiounsschleifprinzip vu Siliziumwaferen
Am Verglach mam Schleifen vun engem Rotatiounsdësch huet d'Rotatiounsschleife vu Siliziumwafer déi folgend Virdeeler: ① Eenzelwaferschleife kann grouss Siliziumwafere vun iwwer 300 mm veraarbechten; ② Déi tatsächlech Schleiffläch B an de Schnëttwénkel θ si konstant, an d'Schleifkraaft ass relativ stabil; ③ Duerch d'Upassung vum Neigungswénkel tëscht der Schleifradachs an der Siliziumwaferachs kann d'Uewerflächenform vum Eenkristall-Siliziumwafer aktiv kontrolléiert ginn, fir eng besser Genauegkeet vun der Uewerflächenform ze kréien. Zousätzlech hunn d'Schleiffläch an de Schnëttwénkel θ vum Rotatiounsschleife vu Siliziumwafer och d'Virdeeler vun engem groussen Schleifmarge, einfacher Online-Déckt- a Uewerflächenqualitéitsdetektioun a Kontroll, kompakter Ausrüstungsstruktur, einfachem integréierte Schleifen a verschiddene Statiounen an héijer Schleifeffizienz.
Fir d'Produktiounseffizienz ze verbesseren an den Ufuerderunge vun den Hallefleederproduktiounslinnen gerecht ze ginn, benotzt kommerziell Schleifanlagen, déi um Prinzip vum Rotatiounsschleife vu Siliziumwafer baséieren, eng Multi-Spindel-Multistatiounsstruktur, déi Grobschleifen a Feinschleifen an engem Belueden an Entlueden ofschléisse kann. A Kombinatioun mat aneren Hëllefsanlagen kann et dat vollautomatescht Schleife vun Eenkristall-Siliziumwaferen "Dry-in/Dry-out" a "Kassett zu Kassett" realiséieren.
Duebelsäiteg Schleifen:
Wann d'Rotatiounsschleife vu Siliziumwafer déi iewescht an ënnescht Uewerfläche vum Siliziumwafer veraarbecht, muss d'Wierkstéck ëmgedréit a schrëttweis duerchgefouert ginn, wat d'Effizienz limitéiert. Gläichzäiteg huet d'Rotatiounsschleife vu Siliziumwafer Uewerflächefeeler beim Kopéieren (Kopie) a Schleifmarken (Schleifmarken), an et ass onméiglech, d'Defekter wéi Wellenheet a Konischheet op der Uewerfläch vum Eenkristall-Siliziumwafer no Drotschneiden (Multi-See) effektiv ze läschen, wéi an der Figur 4 gewisen. Fir déi uewe genannten Defekter ze iwwerwannen, ass an den 1990er Joren d'duebelsäiteg Schleiftechnologie (Doublesidegrinding) opgetrueden, an hire Prinzip gëtt an der Figur 5 gewisen. D'Klammeren, déi symmetresch op béide Säiten verdeelt sinn, klemmen den Eenkristall-Siliziumwafer am Halterring a rotéieren lues vun der Roll ugedriwwen. E puer becherfërmeg Diamantschleifrieder sinn relativ op béide Säite vum Eenkristall-Siliziumwafer placéiert. Ugedriwwe vun der elektrescher Spindel mat Loftlager, rotéieren se a géigeniwwerléisend Richtungen a fidderen axial fir eng duebelsäiteg Schleife vum Eenkristall-Siliziumwafer z'erreechen. Wéi op der Figur ze gesinn ass, kann duebelsäiteg Schleifen effektiv d'Wellen an d'Kegel op der Uewerfläch vum Eenkristall-Silizium-Wafer nom Drotschneiden ewechhuelen. Jee no der Arrangementrichtung vun der Schleifscheiwenachs kann duebelsäiteg Schleifen horizontal a vertikal sinn. Dorënner kann horizontal duebelsäiteg Schleifen effektiv den Afloss vun der Deformatioun vum Silizium-Wafer reduzéieren, déi duerch dat eege Gewiicht vum Silizium-Wafer op d'Schleifqualitéit verursaacht gëtt, an et ass einfach sécherzestellen, datt d'Schleifprozessbedingungen op béide Säite vum Eenkristall-Silizium-Wafer déiselwecht sinn, an datt d'Schleifpartikelen an d'Schleifchips net einfach op der Uewerfläch vum Eenkristall-Silizium-Wafer bleiwen. Et ass eng relativ ideal Schleifmethod.
Figur 4, "Feelerkopie" a Verschleissdefekter beim Rotatiounsschleifen vu Siliziumwaferen
Figur 5, schematescht Diagramm vum Prinzip vum zweisäitege Schleifen
Tabelle 1 weist de Verglach tëscht dem Schleifen an dem duebelsäitege Schleifen vun den uewe genannten dräi Zorte vun Eenkristall-Siliciumwaferen. Duebelsäiteg Schleifen gëtt haaptsächlech fir d'Veraarbechtung vu Siliziumwaferen ënner 200 mm benotzt a weist eng héich Waferausbezuelung op. Duerch d'Benotzung vu fixe Schleifrieder kann d'Schleife vun Eenkristall-Siliciumwaferen eng vill méi héich Uewerflächenqualitéit erreechen wéi déi vum duebelsäitege Schleifen. Dofir kënnen souwuel d'Rotatiounsschleifen wéi och d'Duebelsäiteg Schleifen vun Siliziumwaferen d'Ufuerderunge fir d'Veraarbechtungsqualitéit vun de Mainstream-300 mm Siliziumwaferen erfëllen a sinn de Moment déi wichtegst Ofplattungsmethoden. Bei der Auswiel vun enger Ofplattungsmethod fir Siliziumwaferen ass et néideg, d'Ufuerderunge vun der Duerchmiessergréisst, der Uewerflächenqualitéit an der Polierwaferveraarbechtungstechnologie vum Eenkristall-Siliciumwafer grëndlech ze berücksichtegen. Fir d'Réckverdënnung vum Wafer kann nëmmen eng eenzegsäiteg Veraarbechtungsmethod ausgewielt ginn, wéi zum Beispill d'Rotatiounsschleifmethod fir Siliziumwaferen.
Nieft der Auswiel vun der Schleifmethod beim Schleife vu Siliziumwafer ass et och néideg, d'Auswiel vu vernünftege Prozessparameter wéi Positivendrock, Schleifscheiwenkärgréisst, Schleifscheiwenbindemëttel, Schleifscheiwengeschwindegkeet, Siliziumwafergeschwindegkeet, Schleifflëssegkeetsviskositéit a Flossrate, etc. ze bestëmmen, an e vernünftege Prozesswee ze bestëmmen. Normalerweis gëtt e segmentéierte Schleifprozess mat Grobschleifen, Hallefschleifen, Finishschleifen, Funkenfräi Schleifen a luesem Réckschleifen benotzt, fir Eenkristall-Siliziumwafer mat héijer Veraarbechtungseffizienz, héijer Uewerflächenflaachheet a gerénger Uewerflächeschued ze kréien.
Déi nei Schleiftechnologie kann op d'Literatur bezéien:

Figur 5, schematescht Diagramm vum TAIKO Schleifprinzip
Figur 6, schematescht Diagramm vum Prinzip vun der Planéitscheiwenschleifung
Technologie fir d'Verdënnung vun ultradënne Waferschleifen:
Et gëtt Waferträger-Schleiftechnologie fir d'Ausdënnung an d'Kantenschleiftechnologie (Figur 5).
Zäitpunkt vun der Verëffentlechung: 08.08.2024