I backend-procesfasen, denvaffel (siliciumwafermed kredsløb på forsiden) skal tyndes ud på bagsiden før efterfølgende udskæring, svejsning og pakning for at reducere pakkens monteringshøjde, reducere chippakkens volumen, forbedre chippens termiske diffusionseffektivitet, elektriske ydeevne, mekaniske egenskaber og reducere mængden af udskæring. Bagslibning har fordelene ved høj effektivitet og lave omkostninger. Det har erstattet de traditionelle vådætsnings- og ionætsningsprocesser og er blevet den vigtigste bagudtyndingsteknologi.
Den fortyndede vaffel
Hvordan tyndes man ud?

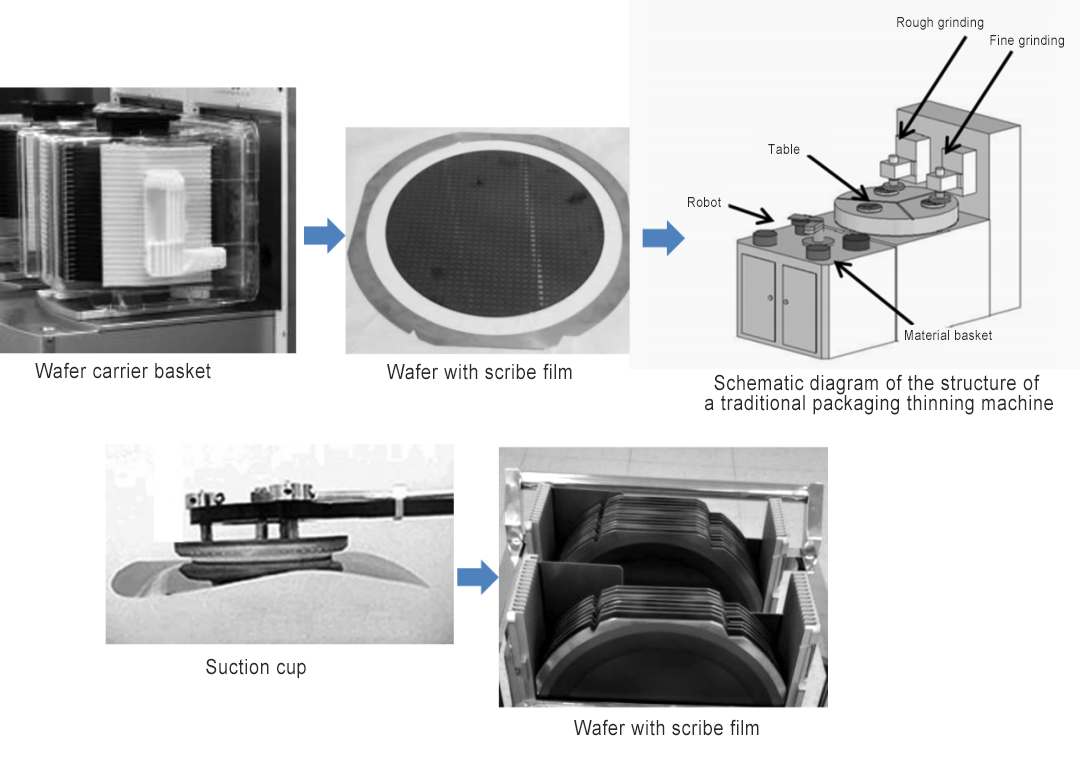 Hovedprocessen for waferudtynding i traditionel emballeringsproces
Hovedprocessen for waferudtynding i traditionel emballeringsproces
De specifikke trin ivaffelUdtynding er at binde den wafer, der skal bearbejdes, til den udtyndende film, og derefter bruge vakuum til at adsorbere den udtyndende film og chippen på den til det porøse keramiske waferbord, justere de indre og ydre cirkulære bådcenterlinjer på arbejdsfladen på den kopformede diamantslibeskive til midten af siliciumwaferen, og siliciumwaferen og slibeskive roterer omkring deres respektive akser for at skære ind i slibningen. Slibningen omfatter tre faser: grovslibning, finslibning og polering.
Waferen, der kommer ud af waferfabrikken, bagslibes for at udtynde waferen til den tykkelse, der kræves til pakning. Ved slibning af waferen skal der påføres tape på forsiden (aktivt område) for at beskytte kredsløbsområdet, og bagsiden slibes samtidig. Efter slibning fjernes tapen, og tykkelsen måles.
De slibeprocesser, der med succes er anvendt til fremstilling af siliciumskiver, omfatter rotationsbordslibning,siliciumwaferrotationsslibning, dobbeltsidet slibning osv. Med den yderligere forbedring af overfladekvalitetskravene til enkeltkrystalsiliciumskiver foreslås der konstant nye slibeteknologier, såsom TAIKO-slibning, kemisk-mekanisk slibning, poleringsslibning og planetarisk skiveslibning.
Slibning af roterende bord:
Rotationsbordslibning (rotationsbordslibning) er en tidlig slibeproces, der blev brugt til fremstilling og udtynding af siliciumskiver. Princippet er vist i figur 1. Siliciumskiverne er fastgjort på sugekopperne på det roterende bord og roterer synkront drevet af det roterende bord. Siliciumskiverne roterer ikke selv omkring deres akse; slibeskiven fremføres aksialt, mens den roterer med høj hastighed, og slibeskivens diameter er større end siliciumskivens diameter. Der er to typer rotationsbordslibning: planslibning og plantangentialslibning. Ved planslibning er slibeskivens bredde større end siliciumskivens diameter, og slibeskivens spindel fremføres kontinuerligt langs sin aksiale retning, indtil overskuddet er bearbejdet, hvorefter siliciumskiven roteres under rotationsbordets drev; ved plantangentialslibning fremføres slibeskiven langs sin aksiale retning, og siliciumskiven roteres kontinuerligt under den roterende skives drev, og slibningen fuldføres ved frem- og tilbagegående fremføring (reciprocation) eller krybefremføring (creepfeed).
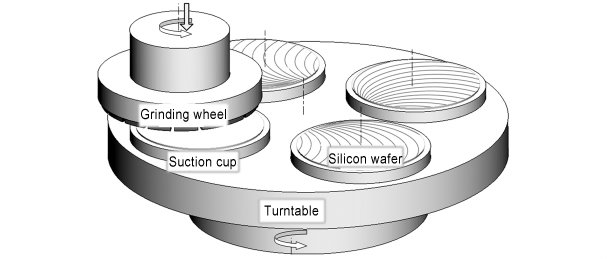
Figur 1, skematisk diagram over princippet for roterende bordslibning (fladetangentiel)
Sammenlignet med slibemetoden har rotationsbordslibning fordelene ved høj fjernelse, lille overfladeskade og nem automatisering. Imidlertid ændrer det faktiske slibeområde (aktiv slibning) B og indskæringsvinklen θ (vinklen mellem slibeskivens ydre cirkel og siliciumwaferens ydre cirkel) i slibeprocessen sig med ændringen af slibeskivens skæreposition, hvilket resulterer i en ustabil slibekraft, hvilket gør det vanskeligt at opnå den ideelle overfladenøjagtighed (høj TTV-værdi) og let forårsager defekter såsom kantkollaps og kantkollaps. Rotationsbordslibningsteknologien bruges hovedsageligt til bearbejdning af enkeltkrystalsiliciumwafere under 200 mm. Stigningen i størrelsen af enkeltkrystalsiliciumwafere har stillet højere krav til overfladenøjagtighed og bevægelsesnøjagtighed på arbejdsbordet, så rotationsbordslibning er ikke egnet til slibning af enkeltkrystalsiliciumwafere over 300 mm.
For at forbedre slibeeffektiviteten anvender kommercielt plan tangentialt slibeudstyr normalt en struktur med flere slibeskiver. For eksempel er der monteret et sæt grovslibeskiver og et sæt finslibeskiver på udstyret, og det roterende bord roterer en cirkel for at udføre både grovslibning og finslibning på skift. Denne type udstyr omfatter G-500DS fra det amerikanske GTI-firma (figur 2).
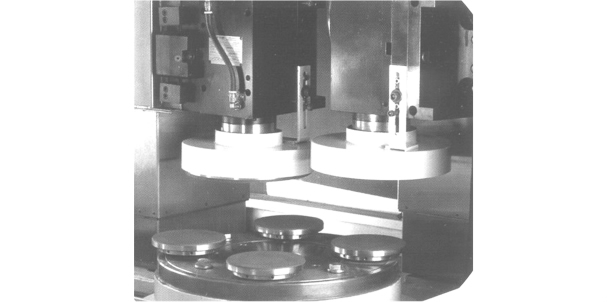
Figur 2, G-500DS roterende bordslibeudstyr fra GTI Company i USA
Rotationsslibning af siliciumwafer:
For at imødekomme behovene for fremstilling af store siliciumwafere og udtynding af bagsiden, og opnå overfladenøjagtighed med god TTV-værdi, foreslog den japanske forsker Matsui i 1988 en rotationsslibningsmetode (in-feedgrinding) til siliciumwafere. Princippet er vist i figur 3. Den enkeltkrystal-siliciumwafer og den kopformede diamantslibeskive, der er adsorberet på arbejdsbænken, roterer omkring deres respektive akser, og slibeskiven fremføres kontinuerligt langs den aksiale retning på samme tid. Blandt disse er slibeskivens diameter større end diameteren af den bearbejdede siliciumwafer, og dens omkreds passerer gennem midten af siliciumwaferen. For at reducere slibekraften og reducere slibevarmen trimmes vakuumsugekoppen normalt til en konveks eller konkav form, eller vinklen mellem slibeskivens spindel og sugekoppens spindelakse justeres for at sikre semikontaktslibning mellem slibeskiven og siliciumwaferen.

Figur 3, Skematisk diagram over princippet om rotationsslibning af siliciumwafere
Sammenlignet med rotationsslibning af siliciumskiver har rotationsslibning af siliciumskiver følgende fordele: ① Enkeltgangsslibning af enkeltskiver kan bearbejde store siliciumskiver over 300 mm; ② Det faktiske slibeområde B og skærevinklen θ er konstante, og slibekraften er relativt stabil; ③ Ved at justere hældningsvinklen mellem slibehjulets akse og siliciumskiverens akse kan overfladeformen på enkeltkrystal-siliciumskiven aktivt styres for at opnå bedre nøjagtighed af overfladeformen. Derudover har slibeområdet og skærevinklen θ ved rotationsslibning af siliciumskiver også fordelene ved slibning med stor margin, nem online detektion og kontrol af tykkelse og overfladekvalitet, kompakt udstyrsstruktur, nem integreret slibning med flere stationer og høj slibeeffektivitet.
For at forbedre produktionseffektiviteten og imødekomme behovene i halvlederproduktionslinjer anvender kommercielt slibeudstyr, der er baseret på princippet om rotationsslibning af siliciumskiver, en flerspindels multistationsstruktur, som kan udføre grovslibning og finslibning i én på- og aflæsning. Kombineret med andre hjælpefaciliteter kan det realisere fuldautomatisk slibning af enkeltkrystalsiliciumskiver "dry-in/dry-out" og "kassette til kassette".
Dobbeltsidet slibning:
Når rotationsslibning af siliciumwaferen bearbejder siliciumwaferens øvre og nedre overflader, skal emnet vendes og udføres trinvis, hvilket begrænser effektiviteten. Samtidig har rotationsslibning af siliciumwaferen kopierings- (kopierings-) og slibemærker (slibemærker) på overfladen, og det er umuligt effektivt at fjerne defekter som bølger og tilspidsning på overfladen af enkeltkrystalsiliciumwaferen efter trådskæring (multisav), som vist i figur 4. For at overvinde ovenstående defekter opstod dobbeltsidet slibningsteknologi (dobbeltsideslibning) i 1990'erne, og dens princip er vist i figur 5. Klemmerne, der er symmetrisk fordelt på begge sider, klemmer enkeltkrystalsiliciumwaferen fast i holderingen og roterer langsomt drevet af rullen. Et par kopformede diamantslibeskiver er placeret relativt på begge sider af enkeltkrystalsiliciumwaferen. Drevet af den luftlejede elektriske spindel roterer de i modsatte retninger og fremføres aksialt for at opnå dobbeltsidet slibning af enkeltkrystalsiliciumwaferen. Som det fremgår af figuren, kan dobbeltsidet slibning effektivt fjerne bølger og tilspidsninger på overfladen af enkeltkrystal-siliciumwaferen efter trådskæring. I henhold til slibeskivens akseretning kan dobbeltsidet slibning være vandret og lodret. Blandt disse kan vandret dobbeltsidet slibning effektivt reducere indflydelsen af siliciumwaferdeformation forårsaget af siliciumwaferens egenvægt på slibekvaliteten, og det er nemt at sikre, at slibeprocesforholdene på begge sider af enkeltkrystal-siliciumwaferen er de samme, og at slibepartikler og slibespåner ikke let forbliver på overfladen af enkeltkrystal-siliciumwaferen. Det er en relativt ideel slibemetode.
Figur 4, "Fejlkopiering" og slidmærkedefekter ved rotationsslibning af siliciumwafere
Figur 5, skematisk diagram over dobbeltsidet slibningsprincip
Tabel 1 viser sammenligningen mellem slibning og dobbeltsidet slibning af de ovennævnte tre typer enkeltkrystal-siliciumwafere. Dobbeltsidet slibning bruges hovedsageligt til bearbejdning af siliciumwafere under 200 mm og har et højt waferudbytte. På grund af brugen af faste slibeskiver kan slibning af enkeltkrystal-siliciumwafere opnå en meget højere overfladekvalitet end dobbeltsidet slibning. Derfor kan både rotationsslibning og dobbeltsidet slibning af siliciumwafere opfylde kravene til bearbejdningskvalitet for almindelige 300 mm siliciumwafere og er i øjeblikket de vigtigste udfladningsmetoder. Når man vælger en siliciumwafer-udfladningsmetode, er det nødvendigt at overveje kravene til diameterstørrelse, overfladekvalitet og poleringsteknologi for waferbearbejdning af enkeltkrystal-siliciumwaferen grundigt. Bagudtynding af waferen kan kun vælge en enkeltsidet bearbejdningsmetode, såsom rotationsslibning af siliciumwafere.
Ud over at vælge slibemetoden ved slibning af siliciumskiver er det også nødvendigt at bestemme valget af rimelige procesparametre såsom positivt tryk, slibeskivekornstørrelse, slibeskivebindemiddel, slibeskivehastighed, siliciumskivehastighed, slibevæskens viskositet og strømningshastighed osv., og bestemme en rimelig procesrute. Normalt anvendes en segmenteret slibeproces, herunder grovslibning, halvslibning, finslibning, gnistfri slibning og langsom bagsideslibning, for at opnå enkeltkrystal-siliciumskiver med høj bearbejdningseffektivitet, høj overfladeplanhed og lav overfladeskade.
Ny slibeteknologi kan henvise til litteraturen:

Figur 5, skematisk diagram over TAIKO-slibeprincippet
Figur 6, skematisk diagram over planetskive-slibningsprincippet
Teknologi til udtynding af ultratynde wafers:
Der findes teknologi til slibning af waferbærere med udtynding og kantslibning (figur 5).
Opslagstidspunkt: 8. august 2024