Nella fase del processo back-end, ilwafer (wafer di silicio(con circuiti sul lato anteriore) deve essere assottigliato sul retro prima delle successive operazioni di taglio, saldatura e confezionamento per ridurre l'altezza di montaggio del package, ridurre il volume del package del chip, migliorare l'efficienza di diffusione termica, le prestazioni elettriche, le proprietà meccaniche del chip e ridurre la quantità di taglio. La rettifica del retro offre i vantaggi di un'elevata efficienza e di un basso costo. Ha sostituito i tradizionali processi di incisione a umido e di incisione ionica, diventando la tecnologia di assottigliamento del retro più importante.
La cialda assottigliata
Come dimagrire?

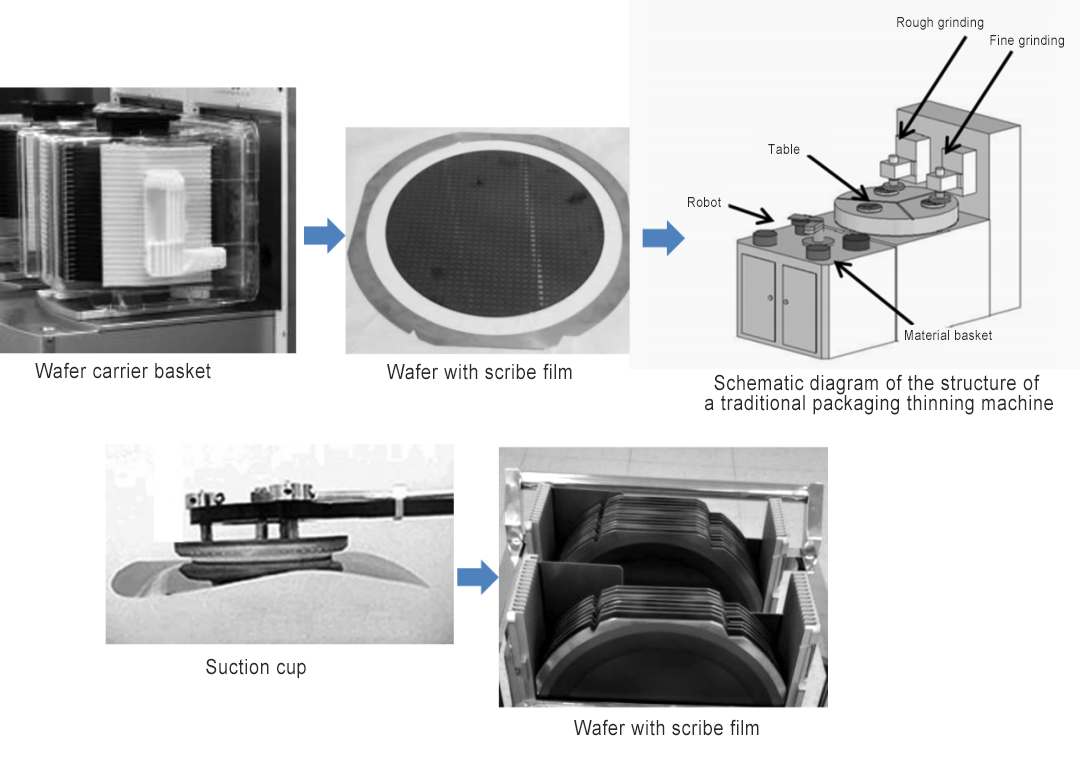 Processo principale di assottigliamento dei wafer nel processo di confezionamento tradizionale
Processo principale di assottigliamento dei wafer nel processo di confezionamento tradizionale
I passaggi specifici diwaferL'assottigliamento consiste nell'incollare il wafer da lavorare al film di assottigliamento, quindi utilizzare il vuoto per assorbire il film di assottigliamento e il truciolo su di esso sul tavolo ceramico poroso del wafer, regolare le linee centrali circolari interne ed esterne della superficie di lavoro della mola diamantata a tazza rispetto al centro del wafer di silicio, quindi il wafer di silicio e la mola ruotano attorno ai rispettivi assi per la rettifica di taglio. La rettifica comprende tre fasi: sgrossatura, rettifica fine e lucidatura.
Il wafer in uscita dalla fabbrica viene rettificato per ottenere lo spessore richiesto per il confezionamento. Durante la rettifica, è necessario applicare del nastro adesivo sulla parte anteriore (area attiva) per proteggere l'area del circuito, e contemporaneamente viene rettificato anche il lato posteriore. Dopo la rettifica, rimuovere il nastro adesivo e misurarne lo spessore.
I processi di macinazione che sono stati applicati con successo alla preparazione dei wafer di silicio includono la macinazione a tavola rotante,wafer di siliciorettifica rotativa, rettifica bilaterale, ecc. Con l'ulteriore miglioramento dei requisiti di qualità superficiale dei wafer di silicio monocristallino, vengono costantemente proposte nuove tecnologie di rettifica, come la rettifica TAIKO, la rettifica chimico-meccanica, la rettifica per lucidatura e la rettifica a disco planetario.
Rettifica con tavola rotante:
La rettifica a tavola rotante (rettifica a tavola rotante) è un processo di rettifica di tipo tradizionale utilizzato nella preparazione e nello spessore del wafer di silicio. Il suo principio è illustrato in Figura 1. I wafer di silicio sono fissati sulle ventose della tavola rotante e ruotano sincronizzati sotto l'azione della tavola stessa. I wafer di silicio stessi non ruotano attorno al proprio asse; la mola viene alimentata assialmente mentre ruota ad alta velocità e il suo diametro è maggiore del diametro del wafer di silicio. Esistono due tipi di rettifica a tavola rotante: la rettifica a tuffo frontale e la rettifica tangenziale frontale. Nella rettifica a tuffo frontale, la larghezza della mola è maggiore del diametro del wafer di silicio e il mandrino della mola avanza in modo continuo lungo la sua direzione assiale fino a quando l'eccesso non viene lavorato, dopodiché il wafer di silicio viene ruotato sotto l'azione della tavola rotante; nella rettifica tangenziale frontale, la mola avanza in modo continuo lungo la sua direzione assiale e il wafer di silicio viene ruotato in modo continuo sotto l'azione del disco rotante e la rettifica viene completata mediante avanzamento alternato (reciprocation) o scorrimento (creepfeed).
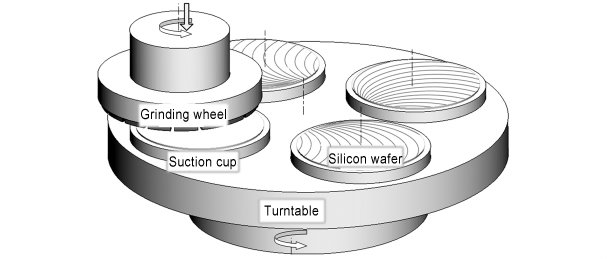
Figura 1, diagramma schematico del principio di rettifica della tavola rotante (tangenziale della faccia)
Rispetto al metodo di rettifica, la rettifica a tavola rotante offre i vantaggi di un'elevata velocità di asportazione, di un ridotto danneggiamento superficiale e di una facile automazione. Tuttavia, l'area di rettifica effettiva (rettifica attiva) B e l'angolo di taglio θ (l'angolo tra il cerchio esterno della mola e il cerchio esterno del wafer di silicio) nel processo di rettifica cambiano con il variare della posizione di taglio della mola, con conseguente instabilità della forza di rettifica, che rende difficile ottenere la precisione superficiale ideale (elevato valore TTV) e causa facilmente difetti come il collasso dei bordi. La tecnologia di rettifica a tavola rotante viene utilizzata principalmente per la lavorazione di wafer di silicio monocristallino di dimensioni inferiori a 200 mm. L'aumento delle dimensioni dei wafer di silicio monocristallino ha imposto requisiti più elevati per la precisione superficiale e la precisione di movimento del banco di lavoro, pertanto la rettifica a tavola rotante non è adatta alla rettifica di wafer di silicio monocristallino di dimensioni superiori a 300 mm.
Per migliorare l'efficienza di rettifica, le rettificatrici tangenziali per uso commerciale adottano solitamente una struttura a più mole. Ad esempio, l'attrezzatura è dotata di un set di mole per la sgrossatura e un set di mole per la finitura, e la tavola rotante ruota di un giro per completare a turno la sgrossatura e la finitura. Questo tipo di attrezzatura include il modello G-500DS dell'americana GTI Company (Figura 2).
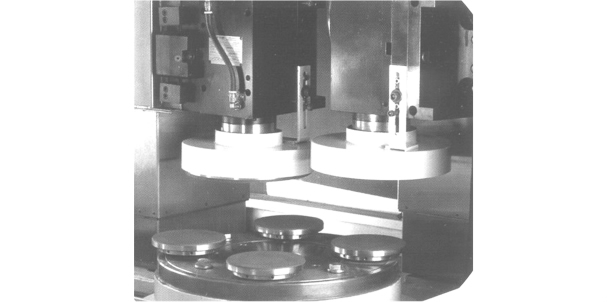
Figura 2, Attrezzatura per rettifica a tavola rotante G-500DS della GTI Company negli Stati Uniti
Macinazione rotativa del wafer di silicio:
Per soddisfare le esigenze di preparazione di wafer di silicio di grandi dimensioni e di assottigliamento del retro, ottenendo una precisione superficiale con un buon valore di TTV, nel 1988 lo studioso giapponese Matsui propose un metodo di rettifica rotazionale per wafer di silicio (rettifica in-feed). Il suo principio è illustrato in Figura 3. Il wafer di silicio monocristallino e la mola diamantata a tazza, adsorbita sul banco di lavoro, ruotano attorno ai rispettivi assi e la mola viene continuamente alimentata lungo la direzione assiale contemporaneamente. Tra questi, il diametro della mola è maggiore del diametro del wafer di silicio lavorato e la sua circonferenza passa attraverso il centro del wafer di silicio. Per ridurre la forza di rettifica e il calore generato, la ventosa a vuoto viene solitamente rifilata in una forma convessa o concava oppure l'angolo tra il mandrino della mola e l'asse del mandrino della ventosa viene regolato per garantire una rettifica a semicontatto tra la mola e il wafer di silicio.

Figura 3, Diagramma schematico del principio di macinazione rotativa del wafer di silicio
Rispetto alla rettifica a tavola rotante, la rettifica rotativa di wafer di silicio presenta i seguenti vantaggi: 1. La rettifica monostadio di wafer singolo può processare wafer di silicio di grandi dimensioni, superiori a 300 mm; 2. L'area di rettifica effettiva B e l'angolo di taglio θ sono costanti e la forza di rettifica è relativamente stabile; 3. Regolando l'angolo di inclinazione tra l'asse della mola e l'asse del wafer di silicio, è possibile controllare attivamente la forma superficiale del wafer di silicio monocristallino per ottenere una migliore precisione della forma superficiale. Inoltre, l'area di rettifica e l'angolo di taglio θ della rettifica rotativa di wafer di silicio presentano anche i vantaggi di una rettifica con ampi margini, di un facile rilevamento e controllo online dello spessore e della qualità della superficie, di una struttura compatta dell'apparecchiatura, di una rettifica integrata multi-stazione e di un'elevata efficienza di rettifica.
Al fine di migliorare l'efficienza produttiva e soddisfare le esigenze delle linee di produzione di semiconduttori, le apparecchiature di rettifica commerciali basate sul principio della rettifica rotativa per wafer di silicio adottano una struttura multi-mandrino e multi-stazione, in grado di completare la rettifica grezza e la rettifica fine in un unico carico e scarico. In combinazione con altre strutture ausiliarie, è in grado di realizzare la rettifica completamente automatica di wafer di silicio monocristallino "dry-in/dry-out" e "cassetta-cassetta".
Rettifica bilaterale:
Quando la rettifica rotativa di wafer di silicio lavora le superfici superiore e inferiore del wafer di silicio, il pezzo deve essere girato e lavorato a fasi, il che ne limita l'efficienza. Allo stesso tempo, la rettifica rotativa di wafer di silicio presenta errori di copiatura superficiale (copiato) e segni di rettifica (gridingmark), ed è impossibile rimuovere efficacemente difetti come ondulazioni e conicità sulla superficie del wafer di silicio monocristallino dopo il taglio a filo (multi-saw), come mostrato in Figura 4. Per superare i difetti sopra descritti, negli anni '90 è comparsa la tecnologia di rettifica bilaterale (doublesidegrinding), il cui principio è illustrato in Figura 5. I morsetti, distribuiti simmetricamente su entrambi i lati, bloccano il wafer di silicio monocristallino nell'anello di ritegno e ruotano lentamente, azionati dal rullo. Una coppia di mole diamantate a tazza è posizionata in modo relativo su entrambi i lati del wafer di silicio monocristallino. Azionate dal mandrino elettrico con cuscinetto ad aria, ruotano in direzioni opposte e avanzano assialmente per ottenere la rettifica bilaterale del wafer di silicio monocristallino. Come si può vedere dalla figura, la rettifica bilaterale può rimuovere efficacemente l'ondulazione e la rastremazione sulla superficie del wafer di silicio monocristallino dopo il taglio a filo. A seconda della direzione di disposizione dell'asse della mola, la rettifica bilaterale può essere orizzontale o verticale. Tra queste, la rettifica bilaterale orizzontale può ridurre efficacemente l'influenza della deformazione del wafer di silicio causata dal peso morto sulla qualità della rettifica, ed è facile garantire che le condizioni del processo di rettifica su entrambi i lati del wafer di silicio monocristallino siano le stesse, e che le particelle abrasive e i trucioli di rettifica non rimangano facilmente sulla superficie del wafer di silicio monocristallino. Si tratta di un metodo di rettifica relativamente ideale.
Figura 4, Difetti di "copia di errore" e segni di usura nella rettifica della rotazione del wafer di silicio
Figura 5, diagramma schematico del principio di macinazione bilaterale
La Tabella 1 mostra il confronto tra la rettifica e la rettifica bilaterale dei tre tipi di wafer di silicio monocristallino sopra menzionati. La rettifica bilaterale viene utilizzata principalmente per la lavorazione di wafer di silicio di dimensioni inferiori a 200 mm e offre un'elevata resa. Grazie all'utilizzo di mole abrasive fisse, la rettifica di wafer di silicio monocristallini può ottenere una qualità superficiale molto superiore rispetto alla rettifica bilaterale. Pertanto, sia la rettifica rotativa per wafer di silicio che quella bilaterale possono soddisfare i requisiti di qualità di lavorazione dei principali wafer di silicio da 300 mm e rappresentano attualmente i metodi di appiattimento più importanti. Nella scelta di un metodo di appiattimento per wafer di silicio, è necessario considerare attentamente i requisiti relativi al diametro, alla qualità superficiale e alla tecnologia di lucidatura del wafer di silicio monocristallino. Per l'assottigliamento posteriore del wafer, è possibile selezionare solo un metodo di lavorazione monolaterale, come la rettifica rotativa per wafer di silicio.
Oltre alla selezione del metodo di macinazione per la macinazione dei wafer di silicio, è anche necessario determinare la selezione di parametri di processo ragionevoli come pressione positiva, granulometria della mola, legante della mola, velocità della mola, velocità del wafer di silicio, viscosità e portata del fluido di macinazione, ecc., e determinare un percorso di processo ragionevole. Solitamente, per ottenere wafer di silicio monocristallino con elevata efficienza di lavorazione, elevata planarità superficiale e basso danneggiamento superficiale, si utilizza un processo di macinazione segmentato che include sgrossatura, rettifica di semifinitura, rettifica di finitura, rettifica antiscintilla e sgrossatura lenta.
La nuova tecnologia di macinazione può fare riferimento alla letteratura:

Figura 5, diagramma schematico del principio di macinazione TAIKO
Figura 6, diagramma schematico del principio di rettifica del disco planetario
Tecnologia di assottigliamento e macinazione di wafer ultrasottili:
Esistono tecnologie di assottigliamento della rettifica del supporto del wafer e tecnologie di rettifica dei bordi (Figura 5).
Data di pubblicazione: 08-08-2024