In de back-end-procesfase wordt dewafeltje (siliciumwafer(met circuits aan de voorkant) moet aan de achterkant worden verdund vóór het volgende snijden, lassen en verpakken om de montagehoogte van de verpakking te verminderen, het chipverpakkingsvolume te verkleinen, de thermische diffusie-efficiëntie, elektrische prestaties en mechanische eigenschappen van de chip te verbeteren en de hoeveelheid snijden te verminderen. Back grinding heeft de voordelen van een hoge efficiëntie en lage kosten. Het heeft de traditionele natte ets- en ionenetsprocessen vervangen en is de belangrijkste back thinning-technologie geworden.
De verdunde wafer
Hoe moet je afvallen?

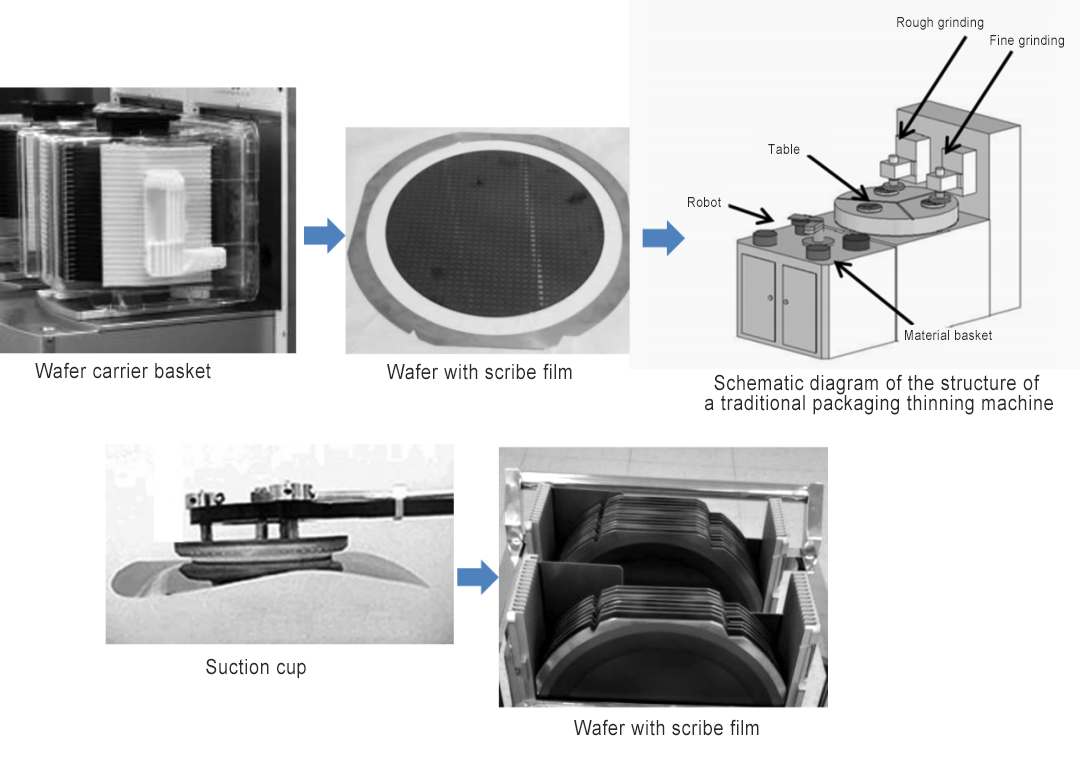 Hoofdproces van waferverdunning in traditioneel verpakkingsproces
Hoofdproces van waferverdunning in traditioneel verpakkingsproces
De specifieke stappen vanwafeltjeVerdunningen zijn het verbinden van de te bewerken wafer met de verdunningsfilm, en vervolgens het gebruik van vacuüm om de verdunningsfilm en de chip erop te adsorberen aan de poreuze keramische wafertafel. Vervolgens worden de binnenste en buitenste cirkelvormige boothartlijnen van het werkoppervlak van de komvormige diamantslijpschijf aangepast aan het midden van de siliciumwafer, en draaien de siliciumwafer en de slijpschijf om hun respectievelijke assen voor het inslijpen. Het slijpen bestaat uit drie fasen: grof slijpen, fijn slijpen en polijsten.
De wafer die uit de waferfabriek komt, wordt aan de achterkant geslepen om hem dunner te maken tot de dikte die nodig is voor verpakking. Bij het slijpen van de wafer wordt tape aangebracht op de voorkant (het actieve gebied) om het circuitgebied te beschermen, en tegelijkertijd wordt de achterkant geslepen. Verwijder na het slijpen de tape en meet de dikte.
De slijpprocessen die met succes zijn toegepast bij de voorbereiding van siliciumwafels omvatten onder meer slijpen met een draaitafel,siliciumwaferrotatieslijpen, dubbelzijdig slijpen, enz. Met de verdere verbetering van de oppervlaktekwaliteitseisen van monokristallijne siliciumwafers worden voortdurend nieuwe slijptechnologieën voorgesteld, zoals TAIKO-slijpen, chemisch-mechanisch slijpen, polijstslijpen en planetair schijfslijpen.
Draaitafel slijpen:
Draaitafelslijpen (rotatietafelslijpen) is een vroeg slijpproces dat wordt gebruikt bij de voorbereiding en het terugdunnen van siliciumwafers. Het principe ervan is weergegeven in figuur 1. De siliciumwafers zijn bevestigd op de zuignappen van de draaitafel en roteren synchroon aangedreven door de draaitafel. De siliciumwafers zelf roteren niet om hun as; de slijpschijf wordt axiaal aangevoerd terwijl deze met hoge snelheid draait, en de diameter van de slijpschijf is groter dan de diameter van de siliciumwafer. Er zijn twee soorten draaitafelslijpen: vlakplungeslijpen en vlaktangentieel slijpen. Bij vlakplungeslijpen is de breedte van de slijpschijf groter dan de diameter van de siliciumwafer, en beweegt de spindel van de slijpschijf continu in zijn axiale richting totdat de overmaat is verwerkt, waarna de siliciumwafer wordt gedraaid onder de aandrijving van de draaitafel; bij vlaktangentieel slijpen beweegt de slijpschijf in zijn axiale richting, waarbij de siliciumwafer continu wordt gedraaid onder de aandrijving van de draaitafel, en wordt het slijpen voltooid door heen en weer gaande toevoer (reciprocatie) of kruipvoeding (kruipvoeding).
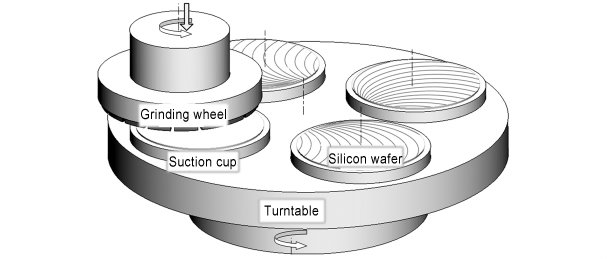
Figuur 1, schematisch diagram van het principe van het draaiende tafelslijpen (vlaktangentieel)
Vergeleken met de slijpmethode heeft slijpen met een draaitafel de voordelen van een hoge verwijderingssnelheid, minimale oppervlaktebeschadiging en eenvoudige automatisering. Het werkelijke slijpoppervlak (actief slijpen) B en de insnijhoek θ (de hoek tussen de buitencirkel van de slijpschijf en de buitencirkel van de siliciumwafer) tijdens het slijpproces veranderen echter met de verandering van de snijpositie van de slijpschijf, wat resulteert in een onstabiele slijpkracht, waardoor het moeilijk is om de ideale oppervlaktenauwkeurigheid (hoge TTV-waarde) te bereiken en gemakkelijk defecten zoals randinstorting en randinstorting kunnen veroorzaken. De technologie voor slijpen met een draaitafel wordt voornamelijk gebruikt voor de verwerking van monokristallijne siliciumwafers kleiner dan 200 mm. De toename van de afmetingen van monokristallijne siliciumwafers heeft hogere eisen gesteld aan de oppervlaktenauwkeurigheid en bewegingsnauwkeurigheid van de apparatuurwerkbank, waardoor slijpen met een draaitafel niet geschikt is voor het slijpen van monokristallijne siliciumwafers groter dan 300 mm.
Om de slijpefficiëntie te verbeteren, maakt commerciële tangentiële vlakslijpapparatuur doorgaans gebruik van een structuur met meerdere slijpschijven. Zo is de apparatuur uitgerust met een set voorslijpschijven en een set fijnslijpschijven, en draait de draaitafel één keer rond om het voorslijpen en fijnslijpen beurtelings uit te voeren. Dit type apparatuur omvat de G-500DS van het Amerikaanse bedrijf GTI (afbeelding 2).
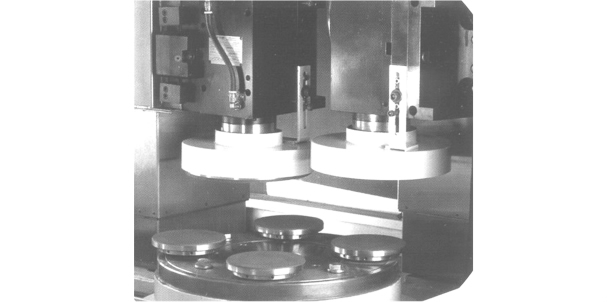
Figuur 2, G-500DS draaitafelslijpmachine van GTI Company in de Verenigde Staten
Rotatie slijpen van silicium wafers:
Om te voldoen aan de behoeften van de voorbereiding en het terugdunnen van siliciumwafers van groot formaat, en om een oppervlaktenauwkeurigheid met een goede TTV-waarde te verkrijgen, stelde de Japanse wetenschapper Matsui in 1988 een rotatieslijpmethode (in-feedgrinding) voor siliciumwafers voor. Het principe hiervan is weergegeven in figuur 3. De monokristallijne siliciumwafer en de komvormige diamantslijpschijf, geadsorbeerd op de werkbank, roteren om hun respectievelijke assen, en de slijpschijf wordt tegelijkertijd continu in de axiale richting bewogen. De diameter van de slijpschijf is groter dan de diameter van de bewerkte siliciumwafer, en de omtrek loopt door het midden van de siliciumwafer. Om de slijpkracht te verminderen en de slijpwarmte te verminderen, wordt de vacuümzuignap meestal convex of concaaf gemaakt, of wordt de hoek tussen de spindel van de slijpschijf en de spindelas van de zuignap aangepast om semi-contactslijpen tussen de slijpschijf en de siliciumwafer te garanderen.

Figuur 3, Schematisch diagram van het principe van het roterend slijpen van siliciumwafers
Vergeleken met roterende tafelslijpen heeft roterend slijpen van siliciumwafers de volgende voordelen: 1. Met het enkelvoudig slijpen van één wafer kunnen siliciumwafers van meer dan 300 mm worden bewerkt; 2. Het werkelijke slijpoppervlak B en de snijhoek θ zijn constant en de slijpkracht is relatief stabiel; 3. Door de hellingshoek tussen de as van de slijpschijf en de as van de siliciumwafer aan te passen, kan de oppervlaktevorm van de monokristallijne siliciumwafer actief worden gecontroleerd voor een betere nauwkeurigheid van de oppervlaktevorm. Bovendien bieden het slijpoppervlak en de snijhoek θ van roterend slijpen van siliciumwafers de voordelen van slijpen met grote marges, eenvoudige detectie en controle van de dikte en oppervlaktekwaliteit in het directe netwerk, een compacte apparatuurstructuur, eenvoudig geïntegreerd slijpen met meerdere stations en een hoge slijpefficiëntie.
Om de productie-efficiëntie te verbeteren en te voldoen aan de behoeften van halfgeleiderproductielijnen, maakt commerciële slijpapparatuur, gebaseerd op het principe van rotatieslijpen van siliciumwafers, gebruik van een meerspindel- en meerstationsstructuur, die ruw slijpen en fijn slijpen in één laad- en losbewerking mogelijk maakt. In combinatie met andere hulpmiddelen kan het volledig automatisch slijpen van monokristallijne siliciumwafers "droog in/droog uit" en "cassette naar cassette" realiseren.
Dubbelzijdig slijpen:
Bij het roterend slijpen van siliciumwafers aan de boven- en onderkant moet het werkstuk worden omgedraaid en in stappen worden bewerkt, wat de efficiëntie beperkt. Tegelijkertijd vertoont het roterend slijpen van siliciumwafers oppervlaktefouten (kopieerfouten) en slijpsporen (grindingmarks), en is het onmogelijk om defecten zoals golving en tapsheid op het oppervlak van de monokristallijne siliciumwafer effectief te verwijderen na draadsnijden (multi-saw), zoals weergegeven in figuur 4. Om bovenstaande defecten te verhelpen, verscheen in de jaren 90 de dubbelzijdige slijptechnologie (doublesidegrinding), waarvan het principe wordt weergegeven in figuur 5. De klemmen, symmetrisch verdeeld aan beide zijden, klemmen de monokristallijne siliciumwafer in de borgring en draaien langzaam, aangedreven door de rol. Een paar komvormige diamantslijpschijven bevinden zich relatief aan beide zijden van de monokristallijne siliciumwafer. Aangedreven door de elektrische spindel met luchtlagers, draaien ze in tegengestelde richting en bewegen ze axiaal om dubbelzijdig slijpen van de monokristallijne siliciumwafer te bereiken. Zoals te zien is in de afbeelding, kan dubbelzijdig slijpen effectief de golving en tapsheid van het oppervlak van de monokristallijne siliciumwafer verwijderen na het draadsnijden. Afhankelijk van de richting van de as van de slijpschijf kan dubbelzijdig slijpen horizontaal en verticaal zijn. Horizontaal dubbelzijdig slijpen kan de invloed van vervorming van de siliciumwafer, veroorzaakt door het eigen gewicht van de siliciumwafer, op de slijpkwaliteit effectief verminderen. Bovendien kan hiermee eenvoudig worden gewaarborgd dat de slijpomstandigheden aan beide zijden van de monokristallijne siliciumwafer gelijk zijn en dat de schurende deeltjes en slijpspanen niet gemakkelijk aan het oppervlak van de monokristallijne siliciumwafer blijven plakken. Het is een relatief ideale slijpmethode.
Figuur 4, "Foutkopie" en slijtagemerkdefecten bij het rotatieslijpen van siliciumwafers
Figuur 5, schematisch diagram van het principe van dubbelzijdig slijpen
Tabel 1 toont de vergelijking tussen het slijpen en dubbelzijdig slijpen van de bovengenoemde drie typen monokristallijn siliciumwafers. Dubbelzijdig slijpen wordt voornamelijk gebruikt voor de verwerking van siliciumwafers kleiner dan 200 mm en heeft een hoge waferopbrengst. Door het gebruik van vaste slijpschijven kan bij het slijpen van monokristallijn siliciumwafers een veel hogere oppervlaktekwaliteit worden bereikt dan bij dubbelzijdig slijpen. Daarom voldoen zowel roterend slijpen als dubbelzijdig slijpen aan de verwerkingskwaliteitseisen van gangbare 300 mm siliciumwafers en zijn dit momenteel de belangrijkste afvlakkingsmethoden. Bij het selecteren van een afvlakkingsmethode voor siliciumwafers is het noodzakelijk om uitgebreid rekening te houden met de eisen ten aanzien van de diameter, oppervlaktekwaliteit en de polijsttechnologie van de monokristallijn siliciumwafer. Voor het terugverdunnen van de wafer kan alleen een enkelzijdige verwerkingsmethode worden geselecteerd, zoals de roterende slijpmethode voor siliciumwafers.
Naast de keuze van de slijpmethode voor het slijpen van siliciumwafers, is het ook noodzakelijk om de selectie van geschikte procesparameters te bepalen, zoals positieve druk, korrelgrootte van de slijpschijf, bindmiddel van de slijpschijf, snelheid van de slijpschijf, snelheid van de siliciumwafer, viscositeit van de slijpvloeistof en debiet, enz., en een geschikte procesroute te bepalen. Doorgaans wordt een gesegmenteerd slijpproces, inclusief ruw slijpen, semi-finishing slijpen, finish slijpen, vonkvrij slijpen en langzaam backen, gebruikt om monokristallijn siliciumwafers te verkrijgen met een hoge verwerkingsefficiëntie, hoge oppervlaktevlakheid en minimale oppervlaktebeschadiging.
Nieuwe maaltechnologie kan worden geraadpleegd in de literatuur:

Figuur 5, schematisch diagram van het TAIKO-slijpprincipe
Figuur 6, schematisch diagram van het planetaire schijfslijpprincipe
Technologie voor het slijpen en verdunnen van ultradunne wafers:
Er bestaan technologieën voor het verdunnen van waferdragers en technologieën voor het slijpen van randen (figuur 5).
Plaatsingstijd: 08-08-2024